投影露光技術
ウシオの投影露光技術
光源から光学・搬送技術までトータルに

専用に開発した高出力ランプと、マスクダメージレスな投影露光を採用し、基板収縮対応、ビルドアップ、多層パターンの高精度な重ね合わせを実現するウシオの投影露光装置。
シリコンウェーハ、ガラス基板、セラミック基板、ロール基板、プリント基板など、さまざまな基板に対応するウシオの大面積投影露光の要素技術をご紹介します。
-
光源技術
-
照明光学技術
-
投影レンズ技術
-
アライメント技術
-
マスク搬送技術
-
ワーク搬送技術
光源技術
露光装置に最適化した専用設計
半導体・液晶ステッパをはじめとするさまざまな露光装置に、高エネルギーで高安定な紫外線光源(UVランプ)を提供している光源メーカー、ウシオ。
UXシリーズにおいても、露光装置の開発と同時に光源の開発をスタートさせ、すべての露光装置に、光学系の特性をフルに引き出す専用設計の光源を採用しています。

照明光学技術
理想的な「光」に変える
ランプから放射された光を効率よく集光し、高均一・高平行にマスクを照射する働きをするのが、照明光学系です。各ミラーに施された特殊コーティングにより、露光波長の選択や、熱線カットなども行なわれます。
ウシオの照明光学系技術は、1960年からはじまったスペースチャンバ用ソーラシミュレータ開発で培われた、高度な光学技術からスタートしています。その後、多くの半導体・液晶用露光装置に照明光学系を提供し、露光装置用光学系としての完成度を高めてきました。
「UXシリーズ」の照明光学系は、これまでのノウハウと実績を活かし、ランプ出力や露光波長の豊富なバリエーションを用意するなど、プロセスに応じた理想的な光を供給します。

投影レンズ技術
「深い焦点深度」「ダメージレス」を可能に
ウシオは、マスクとワークが非接触のためマスクダメージのない投影露光方式に着目し、従来では困難だった、大面積・低ディストーションの投影レンズを開発しました。
そのウシオ独自の投影レンズは、露光領域が最大φ355mmのものや、解像力2µm L/Sのスペックを持つ低歪レンズをラインナップしています。多様なニーズに最適化した光学設計で、深い焦点深度を維持しながら、さまざまな露光面積、解像度の投影レンズを開発し、シリーズ化しています。

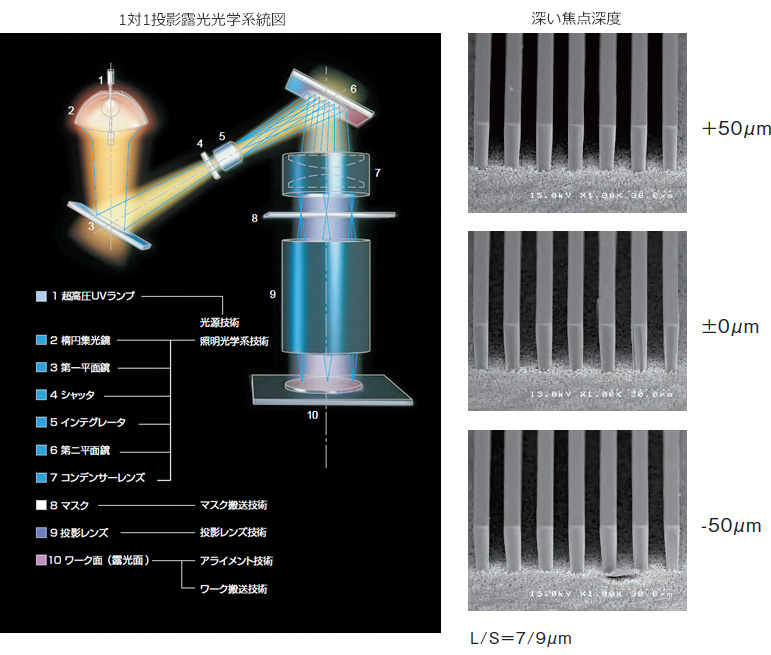
アライメント技術
高精度な位置合わせを実現
独自のTTL非露光波長アライメント方式を採用しています。これは、マスクとワークのアライメントマークを個別に検出し、各々を画像処理によってxy座標軸上に固定して位置合わせを行なう方式で、以下のような特徴を持っています。
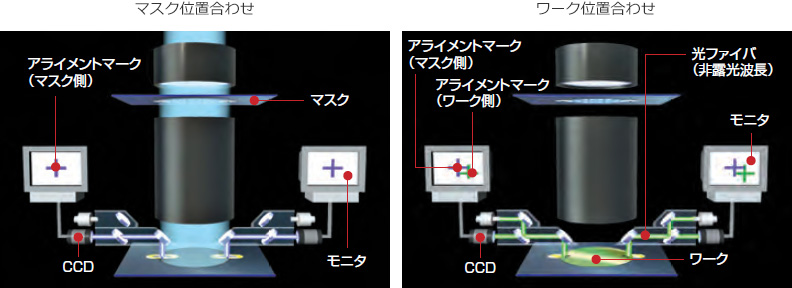
TTL非露光波長アライメント
全面クロムが塗られた開口部の小さなマスクでも、マスクとワークの個別観察により、ワークマークの発見が容易です。
また、マスク越しに観察することによるコントラストの低下がなく、鮮明なマークでアライメントが可能。
下地の影響でコントラストの低いマークでも、照明方法の選択(明視野/暗視野照明)と波長選択によって視認性を向上できます。
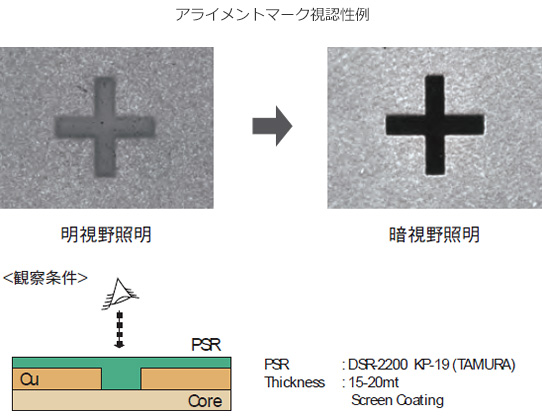
投影倍率の可変
基板伸縮に伴うパターンの伸縮を検知し、最大±0.1%まで、投影倍率を自動調整します。伸縮の大きいワークの重ね合わせ露光で問題になる、重ね合わせズレを防止し、パーフェクトなレジストレーションを実現します。

パターンマッチング方式
専用のアライメントマークがなくても、さまざまな配線パターンを画像認識にて登録しアライメントすることができます。また、アライメントマークに合わせて、さまざまなオートアライメントアルゴリズムの選択が可能です。
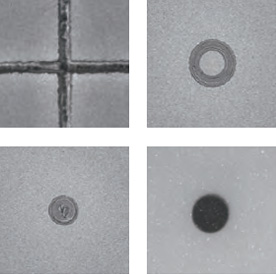
マスク搬送技術
オプションで自社設計のマスクローダー、マスクライブラリを追加することにより、タイムロスのない段取り換えが可能です。
またマスクの自動搬送機能により、マスク破損や作業の品種間違いなど、人為的ミスの削減につながるほか、マスクはマスクケースに入れた状態で移動・装着可能なため、パーティクルの付着防止になります。

ワーク搬送技術
Siウェーハ、フレキシブル基板、プリント基板などをはじめ、さまざまなワークに対応する高精度な搬送系を取り揃えています。
また、広い露光フィールドを活かした一括露光、さらに大面積ワークに対応するステップ&リピート露光の各々に対応するステージは、多様なニーズと効率的で安定した処理をサポートします。

