光技術情報誌「ライトエッジ」No.6(1996年5月発行)
1996(平成8年)春季 第43回 応用物理学会 関係連合講演会 講演予稿集No.2
29p-N-2
172nm誘電体バリア放電ランプによるSiO2膜の室温形成(IV)
Fabrication of SiO2 Films at Room Temperature by 172nm VUV Lamp (IV)
〔東海大学(工)、ウシオ電機(株)*〕
○鈴木剛臣、松崎智彦、工藤浩一、長谷川浩一、鎌田尚之、五十嵐龍志*、村原正隆
Tokai Univ., USHIO INC. ○T. Suzuki, T. Matsuzaki, K. Kudou, K. Hasegawa, N. Kamata, T. Igarashi★ and M. Murahara
<はじめに>
Si半導体製造プロセスにおいて欠かすことの出来ない絶縁膜形成は、現在熱酸化法が主流となっている。この方法は水蒸気もしくは乾燥空気雰囲気中で約1100°Cの温度を必要とする。また近年、低温プロセスと呼ばれているプラズマCVD法でも、基板温度を250°Cまで加熱する必要がある。しかしこの様な高温下では、不純物拡散による絶縁破壊なども無視できない。これに対し、我々はこれまで不純物拡散を防ぐ事に加え、同時にプロセスの省力化をも目的としてArFエキシマレーザーや、172nmVUVランプによるSiO2膜の室温形成を報告してきた。1)、2)。
今回は、ArFエキシマレーザーと172nmVUVランプという2種類の分解光源を用いて膜を作成し、光源の違いによる膜の特性の比較を行った。
<実験方法>
Si基板を配置したチャンバー内に、NF3とN2OもしくはO2の混合ガスを封入する。そこへArFエキシマレーザーまたは172nmVUVランプ光を照射するとガスが光分解され、中間生成物が出来る。この中間生成物の吸着と酸化が繰り返されることによりSiO2の多層膜を形成する。
今回の実験条件は172nmVUVランプを用いた場合、混合ガス圧比 NF3 : N2O=10 : 1、計330Torr封入後5分間ランプ照射し、その後5分間の放置時間を置き、自発的な膜成長を行わせた。この時の実験より得られた膜のC-V特性をFig.1に示す。
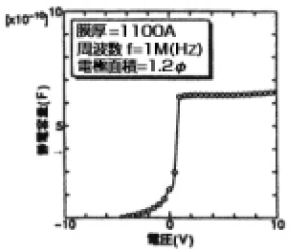
Fig.1 ランプによるSiO2膜のC-V特性



