光技術情報誌「ライトエッジ」No.8(1996年9月発行)
化学光学会「姫路大会講演要主旨集」
(1996年)
SD2-15 誘電体バリア放電エキシマランプを用いた光洗浄
(ウシオ電機)○菅原 寛・磯 慎一・松野博光・五十嵐龍志・平本立躬
1. 緒言
近年半導体や液晶などの分野で、半導体素子の更なる微細化・高集積化に伴い、低損傷・低汚染化に対するニーズが高まっている。
表面に存在する微量ではあるが液体では除去し難い有機物などの汚染は、酸化膜の耐圧劣化特性などに大きな影響を及ぼすことが知られている1)。そこでこれらの汚染物除去が極めて重要な課題となり、光を使ったドライ洗浄が改めて注目されるようになってきた。
短波長紫外線(UV)を使った光洗浄法は20年以上前より知られており、従来より光源として低圧水銀ランプが使用されてきた2)。一方、最近、誘電体バリア放電を利用しエキシマランプが開発され、その光特性を生かして、光洗浄や表面改質などの様々の分野に応用され始めてきた3)4)。
本研究では、石英ガラス基板表面の光洗浄において従来光源である低圧水銀ランプとこの新しいエキシマランプを使い、洗浄効果の違いを検討した。その結果低圧水銀ランプよりさらに短波長の真空紫外線(VUV)を放射するエキシマランプが、高速洗浄・低温プロセス処理等に効果があることを確認した。
2. 誘電体バリア放電エキシマランプ
図1に実験に用いた誘電体バリア放電シマランプの概要を示す。
本エキシマランプの放射スペクトルは、中心波長172nm、半値幅14nmの単色光である(低圧水銀ランプは184.9nm、253.7nm)。

図1 エキシマランプの構造
3. 実験
実験に用いた試料は、石英ガラス板をエチルアルコール中超音波洗浄後、大気中2~3日放置したものである。表面洗浄度の評価は純水の接触角、XPSにより行ったが、接触角とXPSによるC/Si比は良く対応していることから、洗浄度の評価は主に純水の接触角で行った。未洗浄の接触角は37°Cであった。
光源として用いたエキシマランプはウシオ電機製で、入力20W、ミラー反射ユニット内点灯均一照射型で、窓面照射は6.7mW/cm2、であった。一方、低圧水銀ランプはウシオ電機製450W高出力型で、発光管直近照度は184.9nmで約15mW/cm2、253.7nmで120mW/cm2 であった。
実験は試料温度、照射距離をパラメータとし、大気雰囲気中照射で照射時間と純水の接触角の関係を求めた。さらに、雰囲気圧力の影響を検討するために、減圧下でも照射実験を行った。
4. 結果と考察
図2に基板温度が約50°Cの時の照射時間と接触角の関係を調べた結果を示す。172nmエキシマランプの方が明らかに洗浄速度が早いことが判る。接触角が同一の約5°になる照射時間で比べると3倍の洗浄速度があるのが判る。
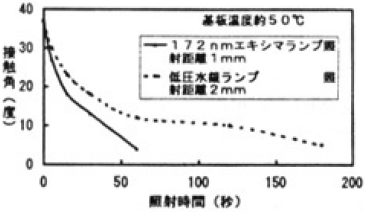
図2 光源の違いによる洗浄速度の差
次に図3に洗浄速度の基板温度依存性について調べた結果で、172nmエキシマランプの場合のものを示す。基板温度をあげていくと洗浄速度も上がっていくのが判る。
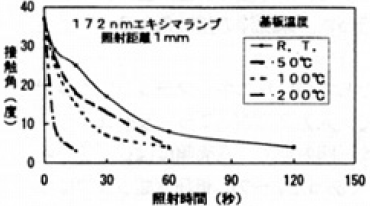
図3 洗浄速度の基板温度依存性
さらに図4に照射距離による洗浄速度の変化を2光源の比較で調べた結果を示す。172nmエキシマランプは低圧水銀ランプに比べ照射距離依存性が大きく、3mm以下で洗浄速度が低圧水銀ランプを上回っているのが判る。
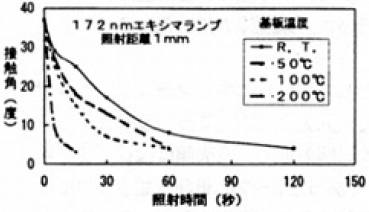
図4 洗浄速度の照射距離依存性
一方、図5に雰囲気圧力の影響を調べた結果を示す。減圧下にある条件で最適の洗浄速度が得られることが判る。
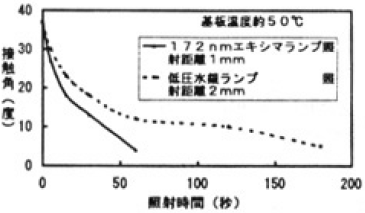
図5 洗浄速度の雰囲気圧力依存性
基板表面における付着有機物の洗浄メカニズムは、紫外光による結合の切断と、紫外光により生成される活性酸素種(オゾンや原子状酸素等)による酸化作用により、揮発性低分子の生成と基板表面より脱離として考えられている。そこで活性酸素種の生成種と生成量の違いが洗浄速度に大きく影響していることが考えられる。172nmエキシマランプの場合、172nmは酸素に強く吸収されることから、局所領域に高濃度の活性酸素種が生成されると考えられる。また、その光エネルギーから考えて活性度の高い酸素原子(O(1D))が直接生成できる(<175nm)ことから、酸化能力も高いと考えられる。これらの結果、低圧水銀ランプに比べ洗浄速度が上回っている結果が得られたものと考えられる。



