光技術情報誌「ライトエッジ」No.8(1996年9月発行)
月刊Semiconductor World
(1996年3月号)
Technical Report
エキシマランプによる化合物半導体の
低損傷・高選択比光エッチング
松本 智 ハビビ ソヘイル 田中淳
慶応義塾大学 理工学部電気工学科
AlGaAs/GaAsヘテロ接合に比べて、InPに格子整合するInGaAs/InAlAsは伝導帯不連続量が大きく、InGsAsの電子移動度が非常に高い。そのため、InP系HEMTは超高速高周波デバイスとして期待されているが、そのゲートに当たる金属/InAlAs界面のScottky障壁高が低い、リーク電流が大きいなど問題を抱えており、実用化の大きな妨げとなっている。
この原因の一つとして、ゲートリセスエッチングの際に生じるInAlAs表面への損傷が挙げられる。ゲートリセスエッチングについてはこれまでにも幾つか報告がある1)~4)が、よく使われているのがクエン酸のウェットエッチング1)である。しかし、これは選択比(InGaAsのエッチング速度とInAlAsのエッチング速度の比)が25と低い。また、S.AgarwalaらはHBrガスを用いた反応性イオンエッチング(RIE)で選択比160以上を報告した2)が、この方法はイオン衝撃による損傷の影響が懸念される。そこで、より損傷の少ないエッチングとしてHBrガスとエキシマランプを用いた光エッチングを試みた3)。HBrガスは、λ=170nm付近の紫外光で次のような光分解反応でBr*を生成する5)。

Br*は基板表面で臭化物を形成し、それが脱離することでエッチングが進行する6)。このような光励起を用いたエッチングは、微細化の一途をたどるプロセスの中でRIEに代わる低損傷エッチングをして期待されている。
InGaAs/InAlAsの光エッチング
1. 実験
図1に光エッチング装置のチャンバ概観図を示す。チ ャンバはターボ分子ポンプで1×10-5Torrまで排気できる。チャンバ上部にエキシマランプ(λ=172nm:ウシオ電機製)を取り付け、フランジの合成石英窓を通してチャンバ外から紫外光を照射する。試料表面での強度は約3mW/cm2である。ランプとフランジの間は常にN2ガスを流す。これは酸素による強度の減衰を妨ぐためである。また、試料台はハロゲンランプで140°Cまで加熱できる。
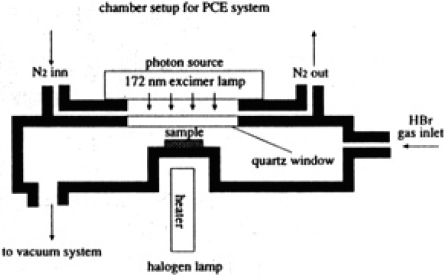
図1 光エッチング装置のチャンバ概観図
試料はIn0.53Ga0.47As(5859Å)/InPおよびIn0.53Ga0.47As(500Å) / In0.52Al0.48As (320Å)/InPを用いた。ポジ型レジストで幅200μmのストライプパターンを試料に転写した後、希HClで表面をクリーニングおよび純水洗浄後、N2ガスで乾燥させ、チャンバへ導入した。チャンバを一度2.5×10-5Torrまで排気した後、HBrガスを導入し、 チャンバ内圧力120mTorr、HBr流量10sccm、基板温度80°Cに設定し、エキシマランプを5~60分照射しエッチングを行った。なお、これらの条件はエッチング速度が大きく、表面の損傷が小さくなるように最適化されたものである。評価はエッチング深さの測定に段差DEKTAK、エッチング後のInGsAs表面モフォロジーの観察に走査型電子顕微鏡(SEM)、エッチング後のInAlAs表面分析にX線電子分光法(XPS)を用いた。
2. 結果および検討
InGaAsおよびInGaAs/InAlAsを光エッチングした時のエッチング深さとエッチング時間の関係を図2に示す。InGaAsおよびInAlAsのエッチング速度は、それぞれ62.33Å/minおよび0.61Å/minとなり、選択比は103となった。これは、これまで報告された中でもかなり高い値である。
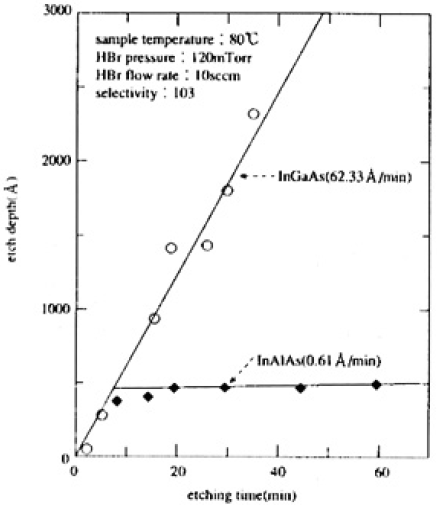
図2 InGaAsおよびInAlAsのエッチング速度
103という高い選択比が生じる原因を調べるため、光エッチング後の表面をXPSで調べた。その結果を図3に示す。図3より光エッチング後にAl2O3が形成されていることが分かる。Al2O3は高い融点を持つために、表面で形成されると脱離が進まなくなってしまう。このAl2O3はチャンバ内に残留した、あるいはHBrガス不純物の酸素によって形成されると考えられる。同様の説明がS.AgarwalaらのHBrを用いたRIE2)およびS.KurodaらのCH3Brを用いた光エッチング4)でも報告されている。
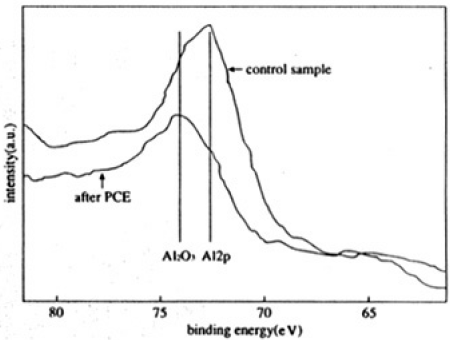
図3 光エッチング後の表面のXPSスペクトル
次に表面の荒れをHBrガスを用いた光エッチングとRIEとで比較した。RIEの条件はチャンバ内圧力120mTorr、HBr流量は10sccm、基板温度80°C、自己バイアス電圧-100Vとした。光エッチングおよびRIE後の表面SEM写真を図4に示す。RIE後の表面にはかなり大きな損傷が見られるが、光エッチングの方では大きな損傷は見られず、光エッチングの方がRIEよりも表面に与える損傷が小さいことが分かる。これは、光エッチングではRIEのようなイオンの衝撃がないことによると考えられる。また、今回は200μmという太いパターンを用いたが、数μmの細いパターンをエッチングできるかどうかは今後の課題として残される。
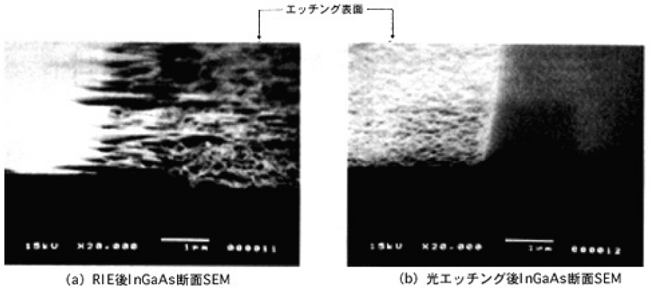
図4 RIEおよび光エッチング後のInGaAs表面の断面SEM写真
Schottkyダイオードの特性
Schottkyダイオードを作製して、InGaAs/InAlAsを選択エッチングした際のInAlAs表面に与える損傷を従来のウエットエッチングと比較した。試料は、undopedInGaAs/undoped-InAlAs/n-InAlAs/n-InPを用いた。まず、裏面にAuGeNiを蒸着してohomic電極を形成した。次に、光エッチングまたはウエットエッチングでundoped-InGaAs層をエッチングし、ダイオード電極パターンをネガレジストで転写した。EB蒸着でMo(2nm)/Ti(300nm)/Ptを、抵抗加熱式でAuを蒸着してSchottky電極を形成し、最後にリフトオフした。評価は電流-電圧(I-V)特性を測定した。
図5に光エッチングおよびウェットエッチングで作製したSchottkyダイオードのI-V特性を示す。ウエットエッチングで作製したダイオードに比較して、光エッチングで作製したダイオードはリーク電流が約1桁低減されているのが分かる。Schottky障壁高さおよびn値についても、ウェットエッチングダイオードの0.61eVおよ び1.68に比較して、光エッチングダイオードでは0.72eVおよび1.57と改善された。これは光エッチングの比較比が高く、光エッチングによってInAlAs表面に与える損傷がウェットエッチングと同等あるいはそれ以下であることを示している。また、この光エッチングと連続的に光パッシベーションを行うSchottkyダイ オードの特性はさらに改善された7)。

図5 SchottkyダイオードのI-V特性
まとめ
HBrガスとエキシマランプの組み合わせでInGaAsの光エッチングを行った。その結果、RIEに比べ高選択比で表面損傷が少ないことが確認できた。また、光エッチングでSchottkyダイオードを作製した結果、光エッチングはウェットエッチングと同等以上の低損傷性があることが分かった。
これらより、光エッチングは電子デバイスあるいは光デバイスの作製に用いることができると考えられる。



