光技術情報誌「ライトエッジ」No.13(1998年7月発行)
第25回アモルファス物質の物性と応用セミナー
(1998年6月11日~13日)
シリカガラスに生ずる真空紫外光誘起歪みの波長依存性
森本幸裕 安田幸夫 那須昭一*
ウシオ電機株式会社 技術研究所
*金沢工業大学 物質応用工学科
1. 緒言
シリカガラスがエネルギーを持った粒子に曝されるとダメージを受けることが良く知られており、それがたとえ紫外光であっても、SiSi ボンドの生成やSi-O-Si 結合角の減少を伴いながら、シリカガラス表面に歪みが発生する[1-3]。歪みの発生には波長依存性があるはずである。何故ならば、シリカガラスはユニークな光吸収特性を示し、特に吸収端付近の特性は温度に依存し、製法や原料、不純物に大きく影響される。シリカガラスは多くの放電ランプのバルブ材料として利用されるため、これらの特性の解明とバルブの改良は高性能、長寿命ランプを提供する上でkey になる要素技術である。
本研究では、シリカガラスの紫外線誘起歪み発生の波長依存性を調べた。試料としてGE214(typeI)、Suprasil P20(typeIII)シリカガラスを用意し、両試料を2KW のXe ランプに封じて光を照射した。照射される光のスペクトルを変化させるために、Xe プラズマ光を直接、または、数種フィルタをシリカガラス試料に被せて照射した。また、別の光源として高圧Hg ランプの光を窒素中で照射し、試料に入射する光のエネルギーを変化させた。
試料に生じるマクロな構造変化は歪みエネルギーで評価し、構造変化を与えた光として、試料が照射中に吸収した光エネルギーを見積もった。これらの結果を基に、シリカガラスに発生する歪みエネルギーと吸収したエネルギーの関係、そして両試料の歪み発生に対する光過敏性の比較とその原因を論議する。
2. 実駿
2.1 資料と照射条件
市販のシリカガラスであるGE214 とSuprasilP20(20*10*2mm3 それぞれtypeI,III)を試料とした。下に示す6 つの条件で真空紫外、紫外光を照射した。照射には2 種類の光源、即ちXe ランプ(UXL2003HKL-O,Ushio Inc., light1)と高圧Hg ランプ(UVL-800SP,Ushio Inc., light2)を使用した。
- A. GE214 をlight1 で720 時間、直接照射
- B. GE214 をlight1 で700 時間、フィルタI を通して照射
- C. GE214 をlight1 で385 時間、フィルタII を通して照射
- D. GE214 をlight1 で700 時間、フィルタIII を通して照射
- E. GE214 をlight2 で740 時間、直接照射
- F. Suprasil P20 をlight1 で385 時間、直接照射
Light1 によって照射する場合、試料をXe ランプの中へ封じ込んで、直接、またはフィルタを通して高圧Xe プラズマ光を照射した。用いたフィルタI,II, III はそれぞれ、サファイア、Suprasil P20,typeI シリカガラスにTi02 が100wt.ppm 含まれたものであり、試料に覆い被せた。Light2によって照射する場合、試料をランプに金属ワイヤでくくりつけ、照射を窒素中で行った。光源のプラズマから試料までの距離はどの照射条件でもほぼ等しく、20~30mm とした。照射中のランプのバルブ温度はXe ランプ、Hg ランプそれぞれ450~470°C、約400°Cであった。
2.2 解射光源のスペクトル測定と照射試料の評価
試料に照射される光のスペクトルを予想するためには、Xe プラズマのスペクトルと高圧Hgランプのスペクトル、それに照射温度でのフィルタの光透過スペクトルが必要である。GE214,typeIII シリカガラス,フィルタIII を材料にしてバルブを形成した450W のXe ランプを作製した。typeIII シリカガラスバルブは2 種類、厚さを2.35, 2.10mm にしたものを作製した。これらのXe ランプとLight2 のランプをバルブの温度が照射中とほぼ同等になるよう点灯し、放射スペクトルを4.1~8.0eVの範囲で測定した。シリカガラスバルブでは吸収端付近のXe プラズマのスペクトル形状が正確に得られない。これを補うため、7.4eV 以上ではサファイアを光放射窓としたXe ランプ(UXR200,Ushio Inc.)のスペクトルを測定した。
全ての照射した試料について照射前後で、真空紫外~紫外域(3.6~8.0eV)と赤外域(2000~4000cm-1)の吸収スペクトル測定と光弾性法による歪み測定を行った。真空紫外~紫外域では誘起された構造欠陥の検出、赤外域では水酸基の同定を行った。歪み測定では、試料の厚さ方向に分布する応力値を測定面内で2 次元の分布として求め、平均歪みエネルギーとして評価した[1]。
3. 結果
3.1 XeランプとHgランプのスペクトル
図1 にXe ランプとHg ランプの照射中のスペクトルが相対比較できるように、測定したスペクトルを測定中と照射中の電気入力比、照射距離、ランプ形状で補正した相対スペクトルとして示す。図1 中マークはそれぞれtypeIII シリカガラスの厚さが2.35mm(○)と2.10mm(□)、GE214(◇)、そしてfilterIII(△)である。Xe ランプについて、7eV 放射帯はXe2*に帰属され、それに連続スペクトル続いている[1]。2 種のtypeIII シリカガラスバルブのランプで7eV 付近の強度に差が出ているが、バルブ厚さが異なるためで、これより測定温度での吸収スペクトルを求めることが出来る。GE214 とフィルタIII バルブでは連続スペクトルのみ記録された。Hg ランプからは6.6eV 以下の光が放射され、多数の線スペクトルがこれに続く。
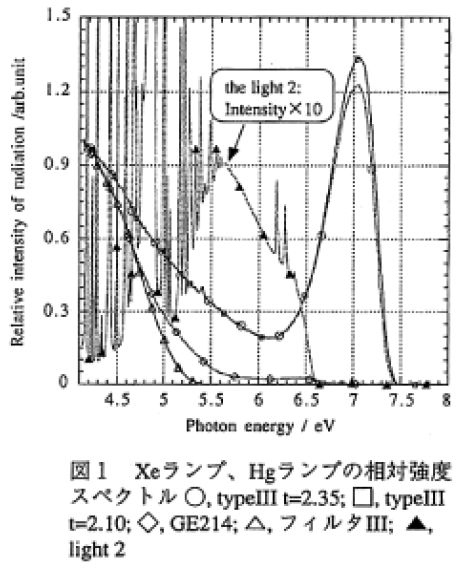
3.2 光誘起構造欠陥と歪みエネルギー
照射後に測定された各試料の吸収スペクトルには前報と同様、7.6,5.8,4.7eV 吸収帯が検出され[1](それぞれSiSi bond, E'center, NBOHC に帰属された)、フィルタの真空紫外域での透過率が高いほど吸収帯の強度は強かった。後述するが、歪みの誘起されなかった試料D、Hg ランプで照射したE にもこれらの吸収帯は検出された。試料中に濃度分布がないと仮定して、3670cm-1の吸収から求めた各照射試料の水酸基濃度を表1に示す。照射前、何れのGE214 にも試料E 程度しか水酸基は含まれていなかったが、表よりXeランプ中での照射後には増加していることが判る。試料D を除く全試料に歪み発生が認められた。表1 には水酸基濃度と併せて、求めた平均歪みエネルギーを示す。
4. 考察
4.1 試料に吸収された光のスペクトル
測定された放射スペクトルは、次式で表される。

ここで、EλはXeプラズマベクトル、Tλは反射を含んだバルブの透過率である。

と表される。式(2)中、Rλは分光反射率でフレネルの式によって屈折率の関数として求めることができ、α(λ temp)は温度の関数とした吸収係数、tはバルブの厚さである。Xeランプ点灯中の吸収係数は、2種の厚さの異なるバルブのランプの測定結果より、

なる関係式から計算出来る。ここで、 と
と  はそれぞれ、厚さが、ta、tbであったXeランプの相対分光放射強度である。
はそれぞれ、厚さが、ta、tbであったXeランプの相対分光放射強度である。
この方法で得たtypeIII シリカガラスの約450°Cでの吸収係数を○プロットで図2に示す。吸収係数が30cm-1 以上ではデータが得られなかったために8eV まで直線近似した。この領域は光吸収が不純物によるところからアーバックの裾による支配に変わる部分であり、この近似は妥当と考える。図2 には、Suprasil についての報芽例を基に計算した500°Cと600°Cでの吸収係数をそれぞれ▲と●プロットで示した[4]。バルブ外側では450°Cだったが、厚さ方向に温度分布があり、実効的な温度は500°Cと600°Cの間にあるようである。求めた吸収係数を式(2)に代入することで 7.6eV 以下の領域の Eλを得た。7.6eV以上の領域ではUXR200 のスペクトル形状を合成し、結果として、4.1eV から8eVの範囲でのEλを求めた。次に、GE214 バルブのXe ランプで測定したスペクトルについてEλを式(2)に代入し、バルブ外面温度470°Cでの吸収係数を求め、図2 に併せて□印でプロットした。比較としてE.C. Beder が報告した750°CにおけるGE105 の吸収係数[5]を載せた。4.5eV 以下では一致を見たが、高エネルギー側(例えば5.7eV 付近)では本研究で得た値の方が一桁以上大きかった。理由は試料が分光測定申に受けた光子密度の差であると推測する。
この様にしてXe ブラズマスペクトルと各フィルタを透過したXe スペクトル、即ち、照射された光のスペクトルを得たが、全ての照射された光がシリカガラスの構造変化に関与するわけではない。そこで、照射条件下で試料が吸収する光のスペクトルを求めた。照射光が試料表面で反射され、残りが入射する単純なモデルを考える場合、試料に吸収される光のエネルギーは次式で表すことが出来る。

ここで、 で、
で、 はそれぞれ表面で反射して入射する光の強度と裏面へ到達した光の強度である。各照射条件について、試料に吸収される光スペクトルを図3に示す。
はそれぞれ表面で反射して入射する光の強度と裏面へ到達した光の強度である。各照射条件について、試料に吸収される光スペクトルを図3に示す。
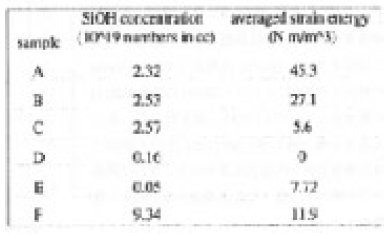
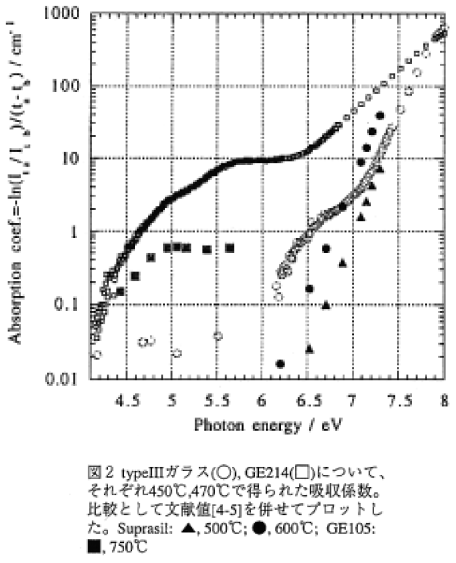

4.2 吸収された光エネルギーと生じた歪みエネルギーの関係
図3 に示す各試料が吸収した光スペクトルのエネルギー範囲、4.1eV 以上7.8eV 以下での積分値の関数として、上述した各試料の平均歪みエネルギーをプロットしたところ、両者の関係ははっきりしなかった。ところで、同じOH 濃度を含有するシリカガラスについて、歪みエネルギーは照射積算量に比例し、歪みエネルギー増加率, ,はOH 濃度, C,が増えるに従い減少することが判っている[1]。
この観点から、全試料の歪みエネルギーを照射時間を700 時間一定、OH 基濃度をSuprasil P20のそれに設定して補正し、得た結果をopensymbol で図4 に示す。プロット中、試料E は4.1eV 以上の光を吸収するものの歪まず、これ即ち、歪み発生には入射光閾エネルギーがあることを示唆している。閾エネルギーを4.1eV から徐々に上げていくと歪まない試料E のプロットは、吸収0、歪み0 で原点に位置するよう移動し、GE214 について、閾エネルギーを5.6eV にすると平均歪みエネルギーと試料が吸収したエネルギーの間に直線関係が得られた。図4 中、closed symbolによるプロットがGE214 について閾エネルギーを考慮した結果で、直線は最小二乗近似したものである。
図3 に見られるように、Suprasil P20 は吸収が6.2eV 以上で起こるため平均歪みエネルギーと試料の吸収エネルギーの関係におけるプロット(図4 中□と■)は、閾波長を4.1eV から5.6eV に変化させても移動しなかった。プロットの位置はGE214について得られた直線よりも上方にあり、歪み発生効率がGE214 よりも高いことを示唆している。
この考察ではOH 基による歪み緩和効果は考慮したが、光吸収量は考慮に入れていない。報告されているOH 基の吸収断面積[6]からSuprasilP20 中のOH 基による真空紫外光の吸収量を見積もると、全体の2/3 に昇り、大部分はOH 基による光吸収である。即ち、ある程度の濃度のOH 基の存在は歪みを緩和するが、一方、多量のOH 基は高効率で歪みを引き起こす。GE214とSuprasil P20 とでは歪みの形態が異なるのかもしれないが、本報による歪み観察法では明らかにすることは出来なかった。

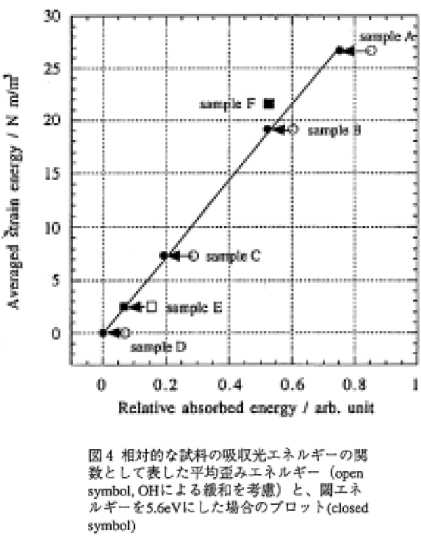
5. 結論
- (1)GE2・14 について、蓄積される歪みエネルギーと光吸収エネルギーの間に比例関係が成り立つ。
- (2)Xe ランプ、Hg ランプの点灯中のバルブ温度において、1.についての閾光子エネルギーは5.6eV であった。
- (3)Suprasil P20 の光吸収は、ランプ点灯中、6.5eV 以上で起こる。従って、真空紫外線誘起歪みは、シリカガラスの種類、その温度に依存し、温度は吸収係数を支配する。
- (4)OH 基はuv-vuv 誘起応力を緩和する効果がある一方、多量のOH 基を含むことで、イオン化による歪み生成より高効率で歪みは誘起される。
以上の結論を導く過程で、Xe アークスペクトルを暫定的に求めた。それにより、ランプ点灯中のシリカガラスの吸収係数を求めたが、通常の分光器で測定された結果に比べて6eV 付近で約10 倍の強度になることが判明した。




