光技術情報誌「ライトエッジ」No.13(1998年7月発行)
レーザー学会学術講演会第18回年次大会
(1998年1月)
レーザー学会学術講演会第18回年次大会
23a IV3
誘電体バリア放電エキシマランプを用いた薄膜形成
Thin Film Preparation with Dielectric-Barrier Discharge Driven Excimer lamps
○竹添法隆,横谷篤至,黒澤宏,佐々木亘,松野博光*,五十嵐龍志*
○N.Takezoe,A.Yokotani,K.Kurosawa,S.Sasaki,H.Mastuno and T.Igarashi(Faculty of Eng.,Miyazaki Univ.,USIO INC*)
1. はじめに
誘電体バリア放電によって励起された希ガスのエキシマ発光を利用した新しい真空紫外光源であるエキシマランプは、密度こそ低いがレーザー発振の難しい波長域で、高エネルギーフォトンを供給できる光源として、その応用研究が活発になってきている。我々はエキシマランプを用いた新しいデバイスプロセスの開発を目的とした研究として、エキシマランプを光源とした光CVD 法(室温でできるフォトンプロセス)による薄膜形量を行っている。1)今回は生成した薄膜の表面形状について、AFM を用いて詳しく検討した結果について報告する。
2. 実験
Fig.1 に実験装置の概略を示す。ヘッドオン型Xe2*エキシマランプ(ウシオ電機製:波長=172nm)を光源として用い、窓として用いたMgF2 に基板(水晶or サファイア)を張り付けている。基板下部の環状バイブの孔からバブラーで気化された原料であるTEOS(Si(OC2H5)4)を基板表面に吹き付けながら照射を行った。このときチャンバー内の全圧は1.5Torr に保った。
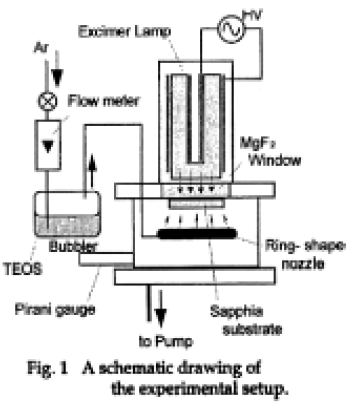
3. 結果
基板上に付着性のよい無色透明な薄膜状の物質が堆積し、そのFTIR スペクトルにはSi-O-Si 伸縮運動の強いピークが見られたことから、明らかに石英膜が生成されていることが確認できた。その際の反応は、次式にまとめられる。
Si-(O-C2H5)4 + hν→SiO2 + 2C2H5-OH + (C&H)
また、膜の成長速度は約0.8nm/min 程度であり、200 分のオペレーションで約160nm の膜が形成できた。Fig.2 にそのサンプル 表面のAFM 像を示す。Fig.3 には薄膜表面の自乗平均あらさ(Rms)の照射時間特性を示す。照射開始から200 分の間に表面らさは時間とともに減少する傾向にあり、200 分後には照射前の水晶基板の表面あらさの値0.134nm に近い値になっていることがわかる。さらにJIS 規格の光学面がRms≦0.5nm であることから、この薄膜が光学面として十分滑らかであることもわかった。
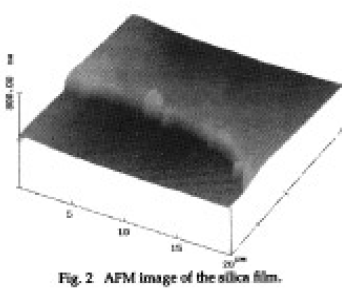

4. まとめ
高エネルギー低密度フォトンの光化学反応を利用したエキシマランプCVD で、高品質のSi02 膜を作ることができる。現在、活性ガス混合によるさらなる膜質の改善の検討も行っており、その他詳細は当日報告する予定である。



