光技術情報誌「ライトエッジ」No.17
照明学会誌(論文号)VOL.83’99/No.5[1999年4月25日]
論 文
(1999年7月)
Xe2*エキシマランプを用いたUV/O3洗浄の検討
正会員 磯 慎 一(ウシオ電機株式会社) 正会員 五十嵐龍志(株式会社ウシオ総合技術研究所)
専門会員 松野博光 (ウシオ電機株式会社)
Study on UV/O3Cleaning by Xe2* Excimer Lamp
Member Shinichi Iso (USHIO INC.),
Member Tatsushi Igarashi (USHIO Research Institute of Technology Inc.)
and Fellow Member Hiromitsu Matsuno (USHIO INC.)
ABSTRACT
UV/O3cleaning by an Xe2* excimer lamp was investigated under various experimentalconditions. We found that UV/O3cleaning was caused by excited atomic oxygen {O(1D)}and that the cleaning speed was about six times faster than that using a low-pressure Hglamp.
KEYWORDS : Xe2*excimer lamp, UV/O3cleaning, cleaning speed, 172nm, contact angle,excited atomic oxygen.
1. 緒言
低圧水銀ランプを使用した乾式紫外線/オゾン洗浄(UV/O3洗浄)はよく知られており1)、現在では様々な分野で実用化されている。このUV/O3洗浄の機構は以下のように考えられている。

水銀の共鳴線185nm光は(1)(2)式の反応で空気中の酸素からオゾンを生成し、254nm光はこのオゾンを分解して活性な原子状酸素O(1D)を生成する((3)式)。これと同時に185nm光および254nm光は汚染物質である有機物の化学結合を切断する。この化学結合を切断された有機物に、オゾンや活性原子状酸素が作用し、有機物が酸化分解されて低分子状の物質となり、揮発するといわれている2)。
近年、中心波長が172nmである誘電体バリア放電を利用したXe2*エキシマランプが開発、実用化された3)4)、172nm光は、185nm光に比較して酸素の吸収係数が約100倍も大きく、したがってオゾン、活性酸素原子種を高密度で生成でき、またフォトンのエネルギーが大きいので有機物の結合を切る能力が高い、すなわち、172nm光を発射するXe2*エキシマランプは、UV/O3洗浄の優れた光源になると考えられる。そこでXe2*エキシマランプを用いたUV/O3洗浄の検討を行った。
2. 実験方法
2.1 Xe2*エキシマ光照射装置
図1に実験装置の全体の概略図を示す。Xe2*エキシマ光照射装置は、合成石英ガラスの照射窓を有する窒素置換したランプハウス内に、円筒形のXe2*エキシマランプを4本並べた構造である5)6).光出力は、中心波長172nm、半値全幅14nmのXe2*エキシマ光だけで、可視光領域の発光はエキシマ光の千分の一程度である。照射窓の大きさは230x230mm で、窓面の放射発散度は最大11mW/cm2、窓面での放射発散度のバラツキは±10%以内である。
放射発散度の大きさは、ランプハウス内部にステンレス製のメッシュを入れて調整した7)。
なおUV/O3洗浄は、ほとんどの実験は大気中で行ったが、一部 窒素雰囲気中での実験も行った。
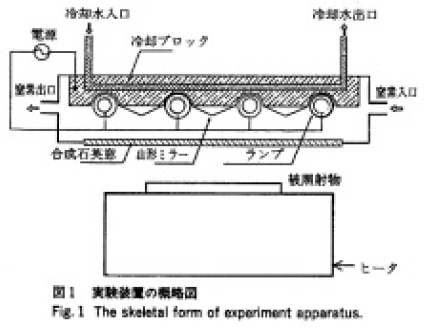
2.2 被洗浄試料および被洗浄面の評価方法
被洗浄試料としては、液晶ディスプレイ用無アルカリガラス(NH-テクノグラス社製NA-45)と鏡面研磨した石英ガラス(GE社製GE-214)を主に用い、応用としてシリコンウエーハの洗浄も試みた。無アルカリガラスはイソプロピルアルコールで湿式洗浄したものを用いた。
純水の接触角は、接触角計(エルマ社製360D)で測定した。洗浄処理を行った後、接触角を測定するまでの時間は、1分から5分までの間である。この間における接触角の経時変化はなかった。被洗浄面の表面分析は、ESCA(Electron Spectroscopy for ChemicalAnalysis, VG 社製ESCA、LAB200X)で行った。
3. 実験結果および検討
3.1 表面の有機物量と水の接触角
はじめに水の接触角による洗浄効果の評価方法について検討を行った。一般に物質表面の有機物の分析には、ESCA などを使用することが多いが、この分析方法は時間がかかること、大きな試料を分析できないことなどの欠点がある。そこで、被測定物の表面に水を一滴垂らして、被測定物と水との接触角を測定することによって表面の清浄度合いを評価する方法が、広く用いられている。
J. R. Vig らは、低圧水銀ランプを使用したUV/O3洗浄の被洗浄面を表面分析し、水の接触角が10°以下の場合においては、表面の有機物量が少ないと純水の接触角が小さいことを述べている8)。われわれは、まず、純水の接触角が比較的大きい場合において、表面の有機物量と純水の接触角の関係を調べた。
被洗浄試料として石英ガラス(GE 社製GE-214)を使用した。このガラスをエチルアルコール洗浄したのち、大気中に放置して有機物を付着させた。純水の接触角はエチルアルコール洗浄を行った場合は38°、低圧水銀ランプで2分間洗浄した場合は10°、エキシマ光照射で2分間洗浄した場合は5°になった。
図2にこれらの試料のESCA による測定結果を示す。285eV 付近のピークがC1Sに相当し、このピークが低いほど有機物量が少ないことを意味している。図2において、純水の接触角の測定の角度が小さいときほど、285eV 付近のピークが低くなった。すなわち、純水の接触角は表面の有機物の量と相関があると思われる。以後、被洗浄物の洗浄効果の評価に純水の接触角を用いることとした。

3.2 洗浄効果に対する各種要因の検討
3.2.1Xe2*エキシマランプを窒素雰囲気中で点灯した場合の洗浄効果
酸素が存在しない窒素雰囲気中での洗浄効果について調べた。被洗浄試料には石英ガラス、照射距離は5mm、照射時間は30秒間、窓面放射発散度は6.7mW/cm2、その他の評価方法などの実験条件は、純水の接触角で評価した。接触角の測定は5点行い、平均値と最大値と最小値を求めた。
窒素雰囲気中での洗浄効果と、酸素を20%混ぜた窒素の洗浄効果を比較した。結果を表1に示す。
窒素雰囲気中での洗浄効果はほとんど認められない。これは酸素がなく172nm光だけのときでは洗浄効果がほとんどないことを意味している。

3.2.2 照射距離と洗浄所要時間の関係
エキシマ光照射装置の窓面から被洗浄試料との距離と洗浄に要する時間の関係を調べた。
被洗浄試料は50x50mm の無アルカリガラスで、イソプロピルアルコールで湿式洗浄処理し、クリーンブース中で3週間放置し、純水の接触角が約60度になったものを用いた。エキシマ光照射装置の放射発散度は、10.0mW/cm2であった。
照射窓面から無アルカリガラスまでの距離を1.3、3.0、5.0、7.8mm に各々で固定して、照射時間10、20、30、45、60、120、180、240秒間でUV/O3洗浄を行い、純水の接触角で評価した。接触角の測定は5点行い、平均値と最大値と最小値を求めた。
図3に測定結果を示す。照射窓面から無アルカリガラスまでの距離が小さいほど、急速に洗浄された。照射距離5.0mm と7.8mm における洗浄効果は、接触角10°以下においては同一になったが、この理由は不明である。
純水の接触角が40°から10°になるまでの時間を図3から求め、この逆数を洗浄速度の目安とした。表2に照射距離1.3mm の値で規格化した洗浄速度を示す。洗浄速度は、照射距離が1.3mm に比較して、3.0mm の場合には0.52倍、5.0mm の場合には0.21倍に減少した。
172nmによる活性酸素種の生成は以下の用であると考えられる。

172nmはO2を活性酸素原子O(1D)とO(3P)に解離する((4)式)。この解離は波長が175nm以下である必要があるので、185nmではこの解離は発生しない。O(3P)はO2と反応してO3を生成し((5)式)、172nm光がこのO3からO(1D)を生成する((6)式)。すなわち、活性酸素原子 O(1D)は(4)式と(6)式から生成されるが、(6)式は二次反応であり、主たる生成は(4)式によると考えられる。したがって O(1D)は172nm光量に比例すると考えられる。
被洗浄試料直面における172nm光量I は、(7)式で表すことができる。



ここで、I 0は照射窓面における光量、Q は172nmにおける酸素分子の吸収断面積(6x10-17cm2)、N は酸素分子の密度である。
被洗浄試料直面における活性酸素原子の密度は、被洗浄試料直面における光量に比例すると仮定した。また、照射装置の窓面と被洗浄試料間の空間における平均活性酸素種の密度を、この空間で吸収された172nm光量を照射距離で除した値に比例すると仮定した。(7)式と上記の仮定を使用して算出した被洗浄試料直面における活性酸素原子の密度と、平均活性酸素種の密度の計算結果を表2に示す。
表2から、実験から求めた洗浄速度の照射距離依存特性は、被洗浄試料直面における活性酸素原子の密度{O(1D)}の照射距離依存性とよく一致していることが分かった。
3.2.3 窓面放射発散度と洗浄速度の関係
次に窓面放射発散度を3.0、4.0、5.0、6.0、7.0、8.0、9.0、10.0、11.0mW/cm2に変化させて、窓面放射発散度と洗浄の速度の関係について検討を行った。被洗浄試料、照射距離、評価方法などの実験条件や、洗浄速度の求め方は、3.2.2項と同一である。
図4に窓面放射発散度と洗浄速度の関係を示す。図中の直線と方程式は、洗浄速度(y)が窓面放射発散度(x)に比例すると仮定し、最小二乗法から求めたものである。各照射距離において、実験結果は直線と比較的よく一致して、洗浄速度は窓面照射発散度に比例している。
被洗浄試料直面における172nm光量は窓面放射発散度に比例するので、洗浄速度は窓面放射発散度に比例するという図4の結果は、3.2.2項における検討結果と同じく、洗浄速度は主に活性酸素原子に比例していることを示していると考えられる。

3.2.4 Xe2*エキシマランプを点点滅点灯した場合の洗浄効果
誘電体バリア放電を利用したXe2*エキシマランプは瞬時点灯が可能であるという特長を生かして、Xe2*エキシマランプを点滅点灯及び連続点灯し、洗浄の効果を調べた。点滅点灯は、繰り返し周波数は100Hz、500Hz、10Hz で、点灯と消灯の比を各々1:1、1:4、4:1に変化させて行った。被洗浄試料、照射距離、評価方法などの実験条件は、3.2.1と同一である。
図5に100Hz での測定結果を示す。横軸の照射時間は、点滅点灯においてはランプが点灯している時間の通算値である。洗浄効果は、各種の点滅点灯と連続点灯において同一であった。
点滅点灯の消灯時間に比較し、活性酸素の寿命は短いが、O3の寿命は十分に長いので、消灯時間にはO3だけが被洗浄試料に作用する。このことと点滅点灯と連続点灯の洗浄効果が同一であるという図5の結果は、O3単独では洗浄効果が無いことを示していると考えられる。
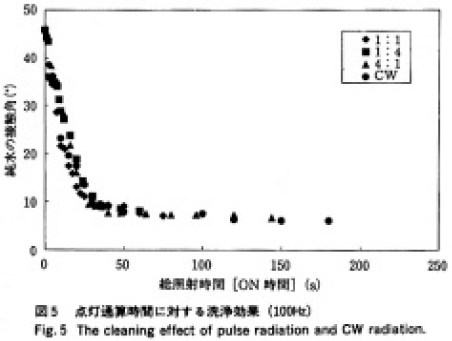
3.2.5 被洗洗浄物の温度と効果
被照射物の温度とUV/O3洗浄の効果について調べた。被洗浄試料は石英ガラス、照射距離は1.0mm、窓面放射発散度は6.7mW/cm2、その他の評価方法などの実験条件は、3.2.1項と同一である。石英ガラスをホットプレートで加熱して、洗浄面の温度を室温(加熱無し)、50°C、100°C、150°C、200°Cにして、処理時間を5、15、30、60、120秒間としてUV/O3洗浄を行った。
図6に測定結果を示す。図6から算出した洗浄速度は、室温時の洗浄速度に比較して、50°Cで1.3倍、100°Cで2.1倍、150°Cで4.0倍、200°Cで11倍となった。この温度によるXe2*エキシマランプでの洗浄の高速化は、UV/O3洗浄の産業利用において有為な方法と考えられる。
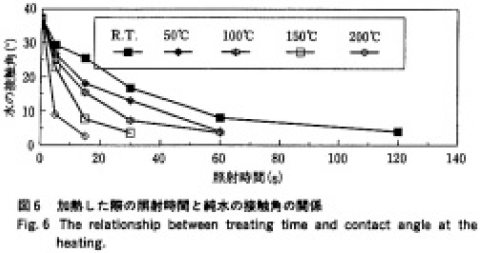
3.2.6 低圧水銀ランンプとの洗浄速度の比較
エキシマ光照射装置によるUV/O3洗浄と低圧水銀ランプ(ウシオ電気製UL 2-450U-O)によるUV/O3洗浄速度の比較を行った。使用した低圧水銀ランプは高出力型に分類されるランプで、合成石英ガラス製、入力電力450W、管壁負荷3.2W/cm である。
被洗浄試料は無アルカリガラスである。
エキシマ光照射装置によるUV/O3洗浄では、照射距離は1.0mm、窓面放射発散度は10.0mW/cm2である。低圧水銀ランプによるUV/O3洗浄では照射距離は7.7mm、被洗浄試料面における254nmの放射発散度は約112mW/cm2である。
評価方法などの実験条件や、洗浄速度の求め方は、3.2.2項と同一である。
低圧水銀ランプによる洗浄では83秒間、Xe2*エキシマ光照射装置を使用した場合は13秒間要した。Xe2*エキシマ光照射装置の洗浄速度は、低圧水銀ランプの6.3倍であった。
3.2.7 172nm光を用いたUV/O3洗浄の洗浄機構の検討
172nm光を用いたUV/O3洗浄の洗浄機構に関連して、3.2.1項から3.2.4項の実験結果および洗浄効果に対する各種要因の検討から、以下のことが分かっている。
- (1)3.2.1項の窒素雰囲気中における洗浄実験から、172nm光だけでの洗浄効果はごくわずかである。
- (2)3.2.2項の照射距離と洗浄速度の検討結果から、洗浄速度は被洗浄試料直面の(O(1D))密度に比例する。
- (3)3.2.3項の窓面放射発散度と洗浄速度の検討結果から、洗浄速度は被洗浄試料直面の(O(1D))密度に比例する。
- (4)3.2.4項の点滅点灯による洗浄実験から、O3だけでは洗浄効果が認められない。
(1)(2)(3)(4)より、172nm光を用いたUV/O3洗浄は、主に(O(1D))に寄っていると考えられる。
また、3.2.6項の低圧水銀ランプとの洗浄速度の検討結果からXe2*エキシマ光照射装置の洗浄速度が低圧水銀ランプの6.3倍になった。この機構は、低圧水銀ランプの185nmの強度が未測定であり明確ではないが、172nm光の酸素分子による吸収係数が大きいこと、および酸素分子から直接(O(1D))を生成できることが主因と考えられる。
3.2.8 シリコンウエーハの洗浄例
半導体デバイスの製造工程ではウエーハ表面の微量な有機物の影響が問題になってくる9)。この有機物はクリーンルーム雰囲気由来のものではなく、保管に用いられているポリプロピレンボックス由来であることが分かってきた。そこでプラスチックに含まれる可塑剤を吸着したシリコンウエーハに172nm光を照射してUV/O3洗浄を試みた。
シリコンウエーハの一般的洗浄法(半導体製造でよく行われているRCA 洗浄と呼ばれる洗浄法)で洗浄したシリコンウエーハを各々フタル酸ジ-n-ブチル(DBP)、アジピン酸ジオクチル(DOA)、フタル酸ジオクチル(DOP)を入れたデシケータ中に12日間放置して可塑剤を付着させた。これに172nm光を照射してUV/O3洗浄を試みた。残留していた有機物の評価は純水の接触角で評価した。
図7に結果を示す。純水の接触角は急激に下がる。30秒間から45秒間程度でプラスチックに含まれる可塑剤が洗浄できることが明らかになり、シリコンウエーハでもUV/O3洗浄の効果が確認できた。

4. 結言
Xe2*エキシマ光を使用したUV/O3洗浄について、以下のことが分かった。
- (1)窒素中の洗浄実験から、172nm光だけでの洗浄効果はごくわずかである。
- (2)洗浄速度の照射距離依存特性は、被洗浄試料直面の172nm光の照射距離依存特性と一致した。
- (3)洗浄速度は窓面放射発散度に比例した。したがって、被洗浄試料直面の(O(1D))密度は被洗浄試料直面の172nm光量に比例すると考えられるので、(2)(3)から、洗浄速度は被洗浄試料直面の(O(1D))密度に比例すると考えられた。
- (4)点滅点灯による洗浄実験から、O3だけでの洗浄効果は小さいことが分かった。
(1)(2)(3)(4)より、172nm光を用いたUV/O3洗浄は、主に(O(1D))に寄っていると考えられる。
また、Xe2*エキシマ光を使用したUV/O3洗浄の洗浄速度は、低圧水銀ランプを使用した場合に比較し、約6倍にもなった。
今後に残された課題は、汚染物質の種類と洗浄効果、被洗浄物による洗浄効果の差異、活性酸素と172nm光を同時に被洗浄物に作用させた場合の相乗効果などについての検討である。

いそ しんいち
磯 慎一(正会員)
ウシオ電機株式会社第一事業部技術部
〒671-0224兵庫県姫路市別所町佐土1194
昭和42年2月8日生まれ、平成5年3月東京水産大学大学院食品生産学前期博士課程修了、平成5年4月ウシオ電機株式会社入社、技術研究所勤務、エキシマランプの応用に従事。平成9年4月からウシオ電機株式会社第一事業部技術部勤務、放電ランプの設計等に従事。

いがらし たつし
五十嵐 龍志(正会員)
株式会社ウシオ総合技術研究所御殿場研究所
〒412-0038静岡県御殿場市駒門1-90
昭和29年7月11日生まれ、昭和52年室蘭工業大学化学科卒、昭和54年室蘭工業大学大学院修士課程修了。昭和54年カルフォルニア工科大学留学、昭和55年ウシオ電機(株)入社、ランプ材料の研究、ハロゲンランプ、放電ランプの開発、半導体露光用ArF エキシマレーザの開発に従事、現在、御殿場研究所所長、アメリカ物理学会、分析学会、日本セラミクス協会会員。

まつの ひろみつ
松野 博光(専門会員)
ウシオ電機株式会社ランプ技術本部技術研究所
〒671-0224兵庫県姫路市別所町佐土1194
昭和35年3月宮城県工業高等学校、同年(株)
日立製作所中央研究所入所、放電の応用研究に従事。平成4年4月ウシオ電機(株)技術研究所に移り現在に至る。現在、ランプ技術本部技術研究所所長。応用物理学会員。



![ライトエッジ No.17 [特集号]電子線の基礎](./content_file/file/lightedge_01_21.png?_size=1)