『光応用技術・材料総覧』2章1節9項「光洗浄」
光洗浄
ウシオ電機株式会社 ランプカンパニー
菅原 寛
1.はじめに
紫外線(UV)は比較的高いフォトンエネルギーを持つことから、有機化合物を分解することはかなり古くから知られていたが、30年ほど前にフォトレジスト高分子の分解に応用されたのがUV-オゾン(O3)による光洗浄の始まりと言われている1)。
光洗浄は有機物汚染に対しては有効なドライ洗浄法であるが、無機物汚染に対しては効果的でないため(注)、ウエット洗浄と組み合わせて使用されるのが一般的である。
2.UV/O3洗浄の原理
UV/O3洗浄の基本原理は、酸素を含む雰囲気ガス中にUV照射で生成された酸素ラジカル(O3や原子状酸素など)が、汚染物である有機化合物のUVで切断された分子結合の箇所に直ちに酸化反応して、単純な分子であるCO2、H2O、O2などが生成され、これらが表面から揮発して除去(洗浄)されるというものである2)。このことを概念的に示したのが図1である。この図では従来から光洗浄で主に用いられている低圧水銀ランプと最近広く利用されるようになったキセノンエキシマランプの比較が模式的に示されている。ここでは波長(フォトンエネルギー)の違いから酸化能力が高いと言われている原子状酸素ラジカルをダイレクトに生成できるかどうかと、酸素による光吸収度合い(吸収係数)の違いから生成される活性酸素量の多少の違いが比較で示されている。
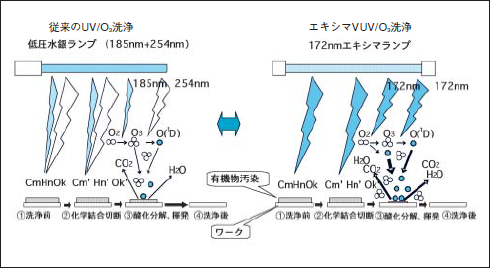
図1. UV/O3洗浄の原理
注)無機物汚染に対する光洗浄の事例として、金属汚染に対し、金属と反応するハロゲンガスを用いる方法も提案されているが、余り一般的ではない。
(1)UVとエネルギー
UVは電波や可視光と同じく電磁波の一種であり、そのフォトンエネルギーEは次式(1)で与えられる。
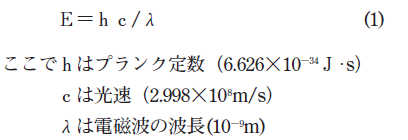
この式でフォトンエネルギーは波長に反比例することから波長が短いほどエネルギーが高いことが分かる。例えば波長172nmの真空紫外光(VUV)の場合、この式に当てはめるとフォトン1個当りのエネルギーは1.15x10-18J(7.22eV)で、モル(6.02x10+23個/mol;アボガドロ数)当りでは、167kcal/mol(698kJ/mol;1cal=4.19J)である。
(2)各種分子の結合エネルギー
有機物の主な分子結合のエネルギーを表1に、エネルギー換算波長との関係を示したものを図2に示す。現在広く用いられている低圧水銀ランプ(185nm;154kcal/mol)やキセノンエキシマランプ(172nm;167kcal/mol)では大半の結合を切断できることが分かる。
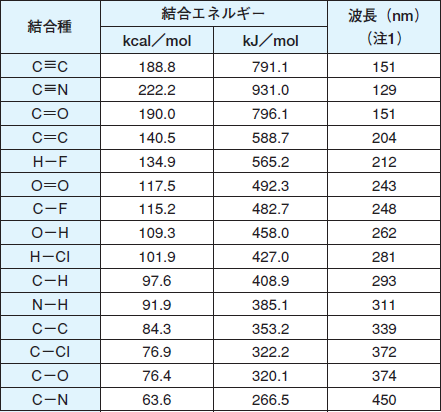
表1. 各種分子結合エネルギー
(注1)エネルギー換算式
1kcal/mol=4.19kJ/mol=4.34E-2eV
xeV=1240/x nm(y nm=1240/y eV)
x kcal/mol=4.19x kJ/mol(y kJ/mol=y/4.19 kcal/mol)
=2.864E+4/x nm
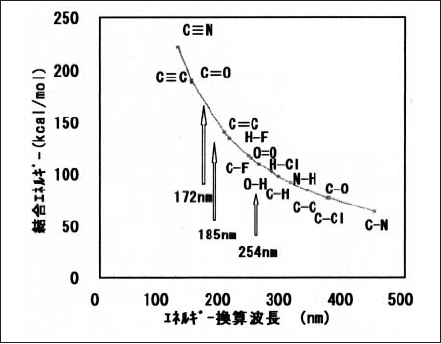
図2. 各種分子結合エネルギーと結合を切断できるUV波長の関係
(3)各種ラジカルと酸化能力
酸素を含んだ雰囲気ガスにUV照射することにより各種酸素ラジカルが生成されるが、ラジカルの生成効率や寿命の違いなどからそれぞれの生成量に違いが見られる。生成されるラジカルの主成分は酸素原子3個からなるオゾンであるが、これ以外にも更に反応性に富むと言われている原子状酸素(O(1D),O(3P))などのラジカルが生成される。これらは寿命が大変短い代わりに反応性が高いため、洗浄に大きな役割を果たしていると考えられている3)4)。
(4) 酸素の光吸収特性
UVは波長に応じて酸素に対する吸収断面積が異なるため図3に示されるような光吸収特性を示す5)。一般的にある吸収媒体を透過する光の強度Iは簡略的に次式で表すことができる6)。

この式を使って172nmと185nmのVUVの大気中における減衰を計算した結果を図4に示す。吸収係数の大きな172nmVUVは大気中を数mm透過しただけでも大きく減衰するのに対し、185nmVUVはさほど減衰しないことが分かる。これは大気中でVUV照射する時に波長によっては照射距離が重要なパラメータとなることを示している。

図3. 酸素の光吸収係数5)
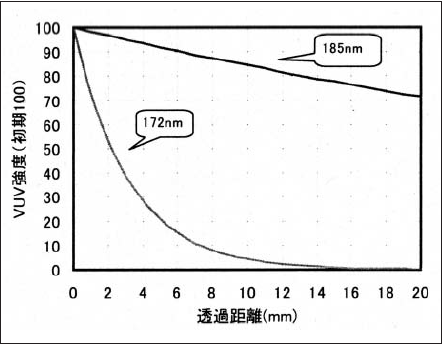
図4. 乾燥空気中の172nm及び185nmVUVの減衰曲線(計算)
3. 清浄度の評価方法
洗浄後の表面の清浄度を評価する手法としては、水滴を表面に滴下して水に対す濡れ性(接触角;θ)を測る方法が簡便である。これは固相、液相、気相の3つの界面で、表面張力のバランスから表面状態(汚れの度合い)に応じて水滴の濡れる角度(接触角)を測定するもので、接触角と清浄度に密接な相関関係があることを利用している7)。光洗浄が利用されている液晶ディスプレイ(LCD)製造ラインなどの現場では、その場で直ぐに評価できることから一般的に用いられている。この接触角法はあるポイントでの評価となるが、広い2次元的な領域の評価には、同じ原理で水蒸気の付着状態を目視観察するスチームテスト法も有効である7)。
一方、分析的手法として光電子分光法(XPS)や昇温脱離ガス分析法(TD-GCMS)などが利用されるが、これらは精密評価が可能な反面、装置が高価なことや分析に時間を要することなどから、余り一般的ではない。図5~7にこれら評価法の一例を示す。
図5はポリイミド(PI)膜表面の洗浄(改質)前後の水の接触角の変化を示したもの、図6は石英ガラス上の最表面をXPSにより分析したもので、有機物汚染の主成分としてカーボン(C)に注目し、洗浄前後で大きくCのピーク強度が変化する様子を示したものである。図7は有機物汚染されたシリコンウエハの洗浄前後のサンプルについて、加熱することにより表面から脱離してくる汚染成分をガスクロマトグラフィ質量分析法(GC-MS)により成分分析した事例である。
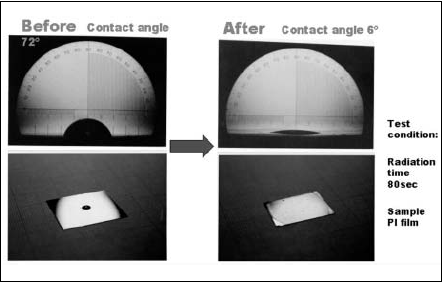
図5. 接触角法によるPI膜表面の水の濡れ性評価
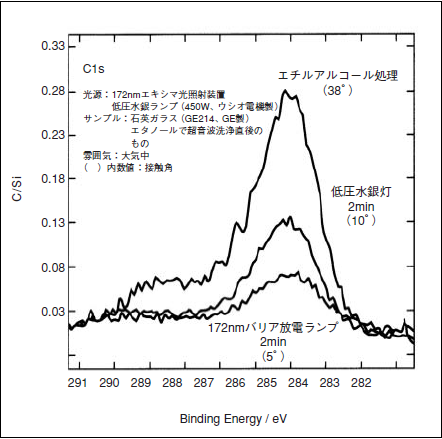
図6. XPSによるガラス表面の清浄度評価
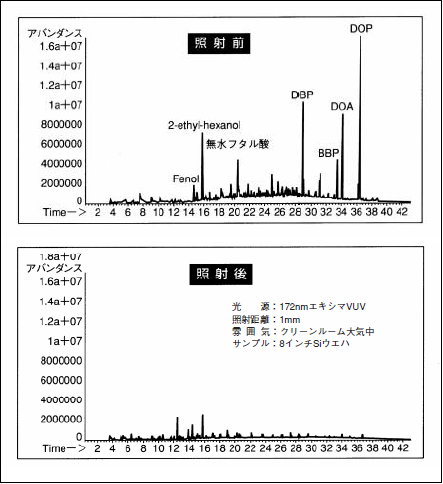
図7. TD-GCMSによるSiウエハの清浄度評価
4.UVランプと照射装置
光洗浄に用いられる紫外線ランプは、従来185nmと254nmに主な放射強度を持つ低圧水銀ランプが主なものであったが、最近はより短波長の172nmに発光中心波長を持つキセノンエキシマランプがLCD製造工程等の洗浄プロセスで広く利用されるようになった。ここではこの比較的新しいエキシマランプとそのUV照射装置について簡単に触れる。
エキシマランプは従来のランプと違って単一波長、瞬時点灯・点滅点灯が可能、低温処理が可能、ランプ形状・点灯方向の自由度が大きい、と言った様々な特長を持った光源である8)。このランプを搭載したUV照射装置の一例を図8に示す9)。この例ではキセノンエキシマ光(172nm)は酸素による吸収が大きいため、ランプを収納する容器(ランプハウス)内部は光を吸収しないガス(一般的には窒素)で置換され、合成石英ガラスからなる窓を通して放射される。ランプハウス内には照射面積に応じて複数本のランプが並べられ、光を効率よく取り出すためにミラーが配置されている。通常は雰囲気の安定している大気中で使用されるが、最近はより光の利用効率を高めるため、処理雰囲気を窒素パージすることにより酸素分圧を下げて使用することも行なわれている。また照射窓ガラスを無くしたタイプのUV照射装置も使用され始めている。
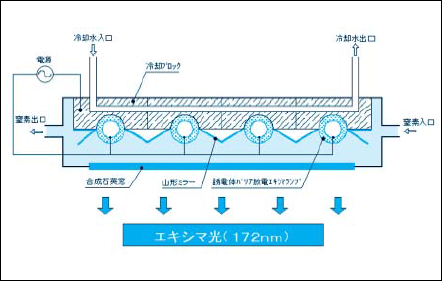
図8. キセノンエキシマランプ搭載のUV照射装置の一例
5.UV/O3 洗浄の応用例
現在光洗浄は各方面で広く用いられているが、その中でも特に洗浄プロセスの多いLCD製造工程では、近年の大型化に伴い高速洗浄性、装置の小型化、低温処理性が要求され、このニーズにマッチしたエキシマランプを搭載したUV照射装置が数多く稼動している。
アレイ/カラーフィルタ工程では基板投入前、成膜前、レジスト塗布前、エッチング・剥離前後の各洗浄プロセスで、セル工程では配向膜塗布前、COG(Chip on Glass)実装前の洗浄プロセスで導入されている。図9にはLCD基板の素ガラス(無アルカリガラス)を光洗浄した事例が示されている。この例では水の接触角により清浄度が評価され、低圧水銀ランプとキセノンエキシマランプの洗浄能力の比較が示されている。
キセノンエキシマランプは図1でも模式的に示される通り、低圧水銀ランプと比べて、①フォトンエネルギーが高いこと、②反応性に富む原子状酸素(O(1D))をダイレクトに生成できること、③洗浄に寄与する活性酸素を沢山生成できることから数倍の高速洗浄が可能である。
図10にはCOG実装において実装されたチップの密着性の向上とばらつき抑制の事例が示される。これは洗浄により接着界面の有機物汚染が除去されることにより、密着性が向上したことと共にばらつきの低減が図られたことを示している。
このように電子デバイスなどでは僅かの表面に付着した有機物汚染が成膜時の密着性の劣化や電気特性の劣化を招くことが多いため、光洗浄は精密ドライ洗浄として有効な洗浄法となっている。またウエット前洗浄として光洗浄を導入することにより、ウエット洗浄時の薬液の濡れ性向上、微細な表面凹凸の隅々まで薬液の浸透化が図れることから、薬液使用量の低減が図られ、ウエット洗浄をより効率的且つ効果的に行なうことが可能となる。
従来は僅かの有機物汚染除去に対象が限られていたが、最近ではエキシマランプにおいてより高出力化が図られたことにより、プラズマ処理に比べてダメージレス或いは低ダメージ化が図れるということから、レジスト除去などにも注目が集まるようになってきている。
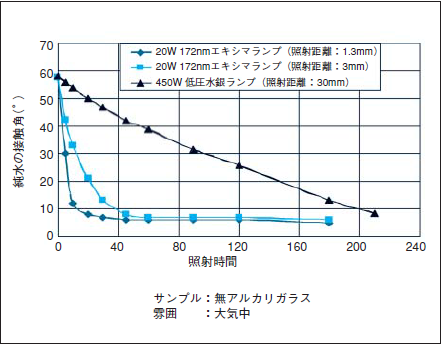
図9. LCD基板表面の洗浄例
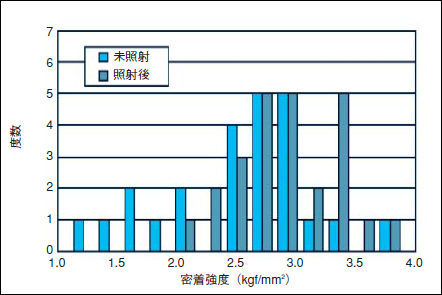
図10. COG実装の基板洗浄例



