光技術情報誌「ライトエッジ」No.31(2008年10月)
2007年秋季 第68回困応用物理学会学術講演会
(2007年9月)
塩素ビームSiエッチングの
表面反応における紫外光の影響
Surface Reaction Enhancement by UV Irradiation during Si Etching
with Chlorine Atom Beam
東北大流体研1,ウシオ電機R&Dセンタ-2
○陣内悌霧1,小田史彦2,森本幸裕2,寒川誠二1
Institute of Fluid Science, Tohoku University1 and R&D Center, Ushio Inc.2
○Butsurin Jinnai1, Fumihiko Oda2, Yukihiro Morimoto2, and Seiji Samukawa1
samukawa@ifs.tohoku.ac.jp
はじめに
ナノメータースケールの半導体デバイスを製造するためには、プラズマエッチング中の表面反応を詳細に理解し、微細に制御することが必要不可欠となる。プラズマからは、荷電粒子・ラジカル・紫外光が発生しているが、これまでのエッチングにおける表面反応の検討ではイオンおよびラジカルの相互作用に焦点がおかれ、プラズマからの紫外光照射の影響についてはほとんど議論がなされていなかった。本研究では、プラズマからの荷電粒子・ラジカルと紫外光の影響を切り分けるために、紫外光照射が抑制できる中性粒子ピーム装置[1]と紫外光ランプを用いて、塩素ビームによるSiエッチングの表面反応における紫外光照射の影響について検討を行った。
実験
パルス時間変調(TM)プラズマにより生成する高効率塩素中性粒子ピームによりSiをエッチングした。同時に,紫外光ランプによりサンプルに紫外光を照射した。ランプ照度は20mW/cm2,ランプ波長は主に200nmから380nmである。エッチング時間は加分である。
結果・考察
図に、バイアスパワー(塩素ピームエネルギー)を変化させた際のSiのエッチング深さを示す。紫外光が照射された場合は、塩素ピームだけでエッチングした場合に比べて、エッチング速度が大幅に増加していることがわかる。これは、紫外光照射によってSi表面に欠陥が生成され、その欠陥がプラズマからのイオンやラジカルなどの反応種と基板表面との化学反応を大幅に促進しているためだと考えられる。本研究により、プラズマからの紫外光照射がSiエッチングの表面反応に大きく寄与しており、無視できないことを初めて明らかにした。
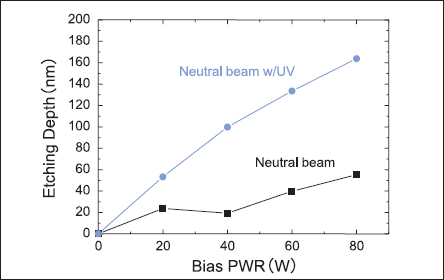
図. SIエッチング深さ(エッチング時間20分)


