光技術情報誌「ライトエッジ」No.33(2010年8月発行)
Semiconductor FPD World(プレスジャーナル)
(2009年8月)
エキシマ光を用いた
精密ドライ洗浄技術
森田 金市
要 約
短波長紫外線は高いフォトンエネルギーを持つことから、現在では、Xeエキシマ光(波長172nm)は精密ドライ洗浄、表面改質のツールとして、FPD製造のみならず半導体製造など様々な分野で利用されるようになってきた。Xeエキシマ光を用いた精密ドライ洗浄は、処理薬液の低減、装置の簡素化、低コスト化を可能にする。一方で、デバイスの微細化、高性能化をもたらすものとして期待が高まっている。
1. エキシマ光による精密ドライ洗浄技術
1.1 エキシマランプの特徴
従来、紫外線を用いた洗浄には低圧水銀ランプが使用されてきた。現在では、185nmと254nmに主なスペクトルのピークを持つ低圧水銀ランプよりも、より短波長のXeエキシマ光が広く使用されるようになってきた。エキシマ光を発光するエキシマランプの特徴を以下に記す。①従来のランプにはない短波長紫外線の発光が可能、②線スペクトルに近い単一波長を持ち、赤外線の発生が極めて少なく、低温処理が可能、③エネルギー変換効率が高く、低電力でも高い光エネルギーを発生、④瞬時点灯、点滅点灯が可能であり、必要な時だけ必要な光を取り出すことが可能、⑤ランプサイズ、形状、発光波長のバリエーションが豊富
1.2 精密ドライ洗浄の原理
酸素を含む雰囲気ガス中にXeエキシマ光が照射されると、活性酸素が発生する。同時に、Xeエキシマ光により基板表面の有機物の結合を切断する。切断された分子と活性酸素が直ちに反応し、基板表面から揮発する(図1)。
紫外線は電磁波の一種であり、波長が短いほどその光エネルギーは高い。Xeエキシマ光(172nm)の場合、166.7kcal/molのエネルギーを持つ。分子の結合エネルギー(表1)の大部分は、Xeエキシマ光で結合を切断できる。Xeエキシマ光での洗浄メカニズムは従来のUVランプと基本的には同じであるが、フォトンエネルギーが高いこと、かつ酸素から直接活性酸素(O(1D))を生成できるため、より洗浄能力は高い。
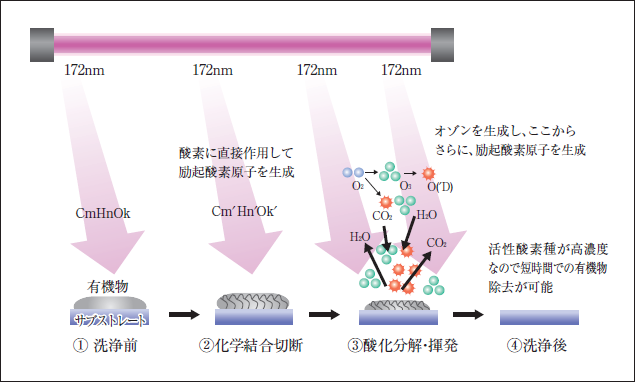
図1. Xeエキシマランプによる精密ドライ洗浄

表1. 172nmエキシマ光エネルギーと各種分子の結合エネルギー
2. 精密ドライ洗浄の事例
2.1 LCD製造での導入事例
現在、Xeエキシマ光を用いた精密ドライ洗浄は、いろいろなシーンで採用されている。中でもLCD製造においては、基板の大型化およびプロセスの高速化の要求から早くに採用されてきた。LCD製造プロセスを図2に示す。LCD製造では、TFT/カラーフィルタ製造プロセスの基板投入前から成膜、エッチング前後の各プロセスで導入されている。またはセル製造では配光膜塗布前、実装前の洗浄にも導入されている。
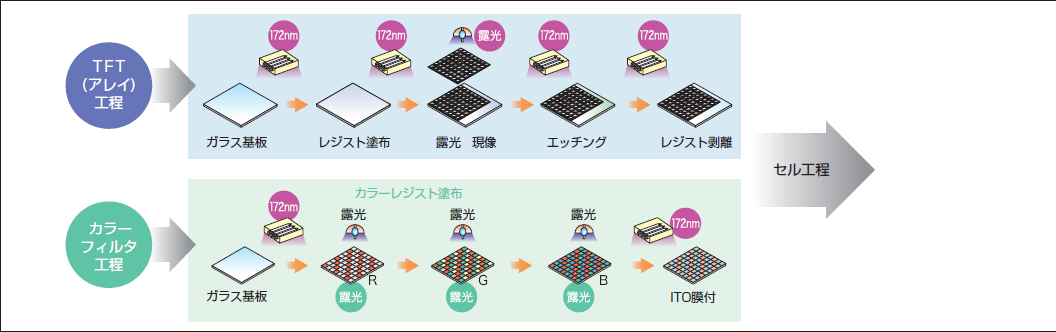
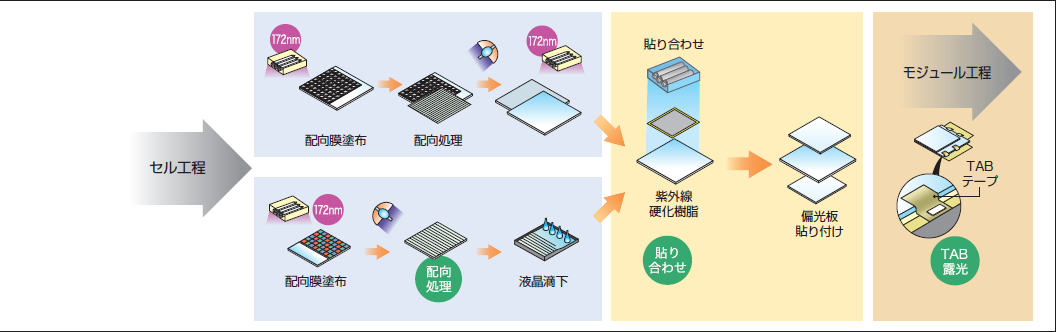
図2. LCD製造プロセスとXeエキシマ光の導入箇所
2.2 洗浄効果
洗浄効果の評価の簡易手法として、純水の接触角が用いられている。LCD製造に使用される基板(無アルカリガラス)の洗浄効果を表したグラフを示す(図3)。LCD製造では、基板洗浄の目標値として、純水接触角10°以下というのが一般的である。現在、標準的に採用されている高出力タイプのランプでは、照射時間5秒以下で純水接触角10°以下を実現できる。
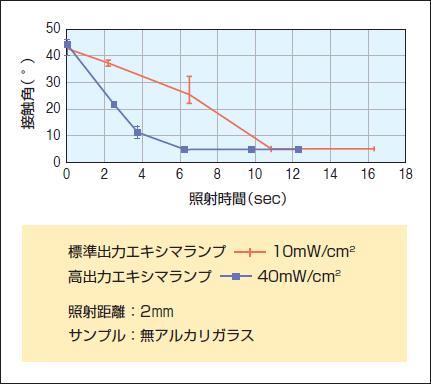
図3. LCD基板洗浄データ
2.3 半導体製造での導入事例
半導体製造(前工程)での導入事例を図4に示す。ウェーハ投入後、成膜・露光の前後に用いられている。また、デバイスの微細化、高性能化に伴い新たなプロセスが検討されており、線スペクトルに近い単一波長を待つエキシマ光は、Xeエキシマ光(172nm)だけでなく、XeClエキシマ光(308nm)、KrClエキシマ光(222nm)、ArFエキシマ光(193nm)などの用途も拡大している。
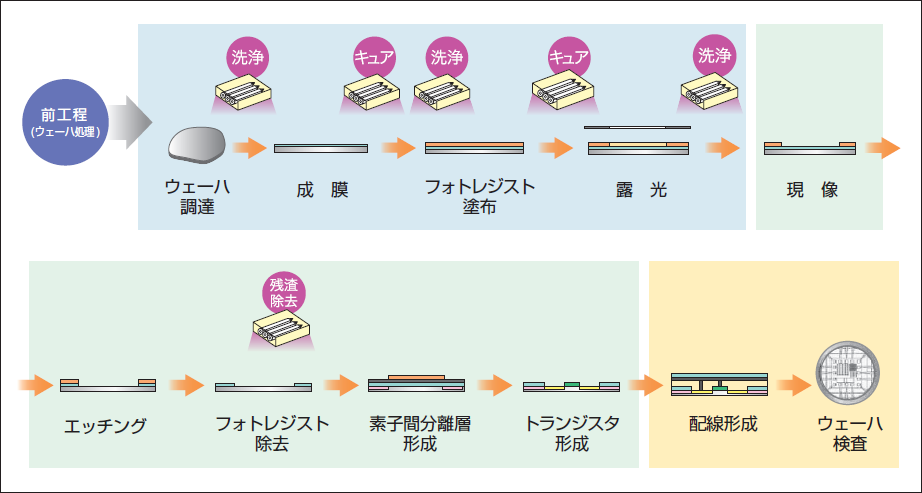
図4. 半導体製造(前工程)におけるXeエキシマ光の導入事例
3. 応用事例
3.1 各種プラスチックの親水化
Xeエキシマ光は、FPD、半導体製造のみならず、現在、様々なところで用いられるようになってきた。実装分野では、フレキシブルプリント板に用いられるポリイミド(PI)の親水化に用いられている。PIの親水化データを図5に示す。Xeエキシマ光は照射時間数秒で純水接触角5°以下を可能にする。これによって、レジスト・めっきの密着性向上、薬液処理の削減、低温処理など、その特徴が生かされている。PI以外の各種プラスチックへの親水化データを図6に示す。Xeエキシマ光は、現在使用されている各種工業用プラスチックに対しても洗浄および改質が可能である。これらの材料を用いた高機能プラスチックの開発など、その用途は拡大すると思われる。

図5. ポリイミドの接触角変化
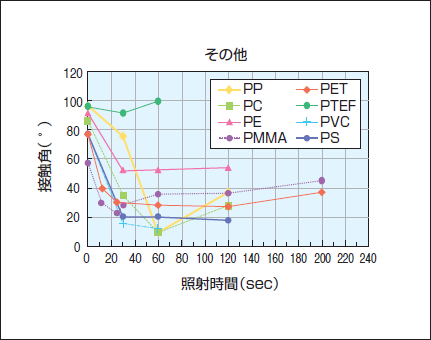
図6. 各種プラスチックの接触角変化
3.2 ダメージフリーアッシング
Xeエキシマ光のフォトンエネルギーは166.7kcal/molであり、ほとんどの分子結合を切断できる。この高い光エネルギーを用いて、基板表面から残渣を除去(アッシング)することが可能である。Xeエキシマ光を用いたアッシングは、光学的アッシングであるためダメージレスな処理が可能である。i線、DUV用それぞれのレジストについてのアッシングレートを図7に示す。
インプリント用モールドのアッシング事例を図8に示す。繰り返し使用されるモールドには、レジスト残渣が付着している(図8左左下部)。このレジスト残渣はウェット洗浄ではなかなか除去できない。また、プラズマによるアッシングでは、モールドが欠けダメージを与える結果となった。一方、Xeエキシマ光ではダメージレスでこの残渣を除去できる(図8右)。
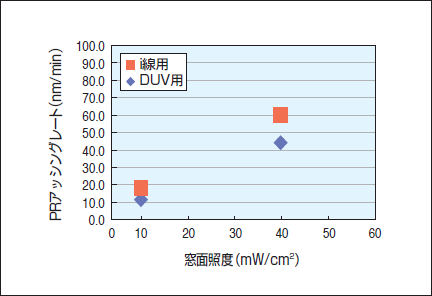
図7. レジストのアッシングレート
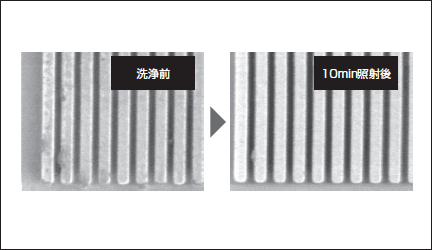
図8. ナノインプリントモールドの洗浄例
3.3 プラスチックの常温接合
Xeエキシマ光の表面改質を応用して、MEMS、特にµTAS分野では、生体適合性やコストの面から、プラスチックを用いたマイクロデバイスの製作が行われるようになってきた。微細な流路が形成されたプラスチック基板の貼り合わせには、Xeエキシマ光を用いた表面活性化が有効であり、他の手法に比べて、低温(20°)で強固な接合力が得られることが報告されている。
おわりに
Xeエキシマ光を用いた精密ドライ洗浄技術は、有機コンタミネーションを除去する有効な手段として、FPD製造における製造プロセスの大型化、高速化、低コスト化を背景に普及してきた。今後、その技術は、高機能化・多様化するデバイスにとって、新たな分野・プロセスで用途が拡大していくと思われる。



