光技術情報誌「ライトエッジ」No.34 (2011年3月発行)
電子情報通信学会 レーザー・量子エレクトロニクス研究会信学技報 2010年11月 copyright (c) 2011 IEICE
電子線励起したAlGaN/AlN 量子井戸からの100mW深紫外発光
大音隆男1, Ryan G. Banal1, 片岡研2, 船戸充1, 川上養一1
1. 京都大学大学院工学研究科 〒615-8510 京都府京都市西京区京都大学桂
2. ウシオ電機株式会社 固体光源開発室 〒671-0224 兵庫県姫路市別所町佐土1194
あらまし
AlGaNを用いた深紫外発光ダイオードの外部量子効率は5%以下と非常に低いのが現状である。その物理的原因として、p型のホール密度が原理的に低いことなどが指摘されている。そこで、解決が困難なp型に起因する問題を回避し、高出力かつ高効率な深紫外発光を得るために、高品質な高Al組成AlGaN/AlN多重量子井戸の電子線励起を提案し、実証実験を行った。電子銃の条件と量子井戸構造を最適化することにより、波長約240nmにおいて、最大100mWの深紫外光出力と最大40%のパワー効率の達成に成功した。
キーワード
電子線励起、深紫外光源、AlGaN/AlN量子井戸
100mW Deep Ultraviolet Emission from AlGaN/AlN Quantum Wells by Electron Beam Pumping
Takao OTO1, Ryan G. BANAL1, Ken KATAOKA1, Mitsuru FUNATO1 and Yoichi KAWAKAMI1
1 Dept. of Electronic Sci. and Eng., Kyoto University Katsura Campus, Nishikyo-ku, Kyoto, 615-8510 Japan 1 SSLS Development Dept., Ushio Inc. 1194 Sazuchi, Bessho-cho, Himeji, Hyogo, 671-0024 Japan
Abstract
The external quantum efficiencies of AlGaN-based deep ultraviolet light emitting diodes are less than 5%, due to the causes such as low hole concentration in p-type AlGaN. To avoid problems associated with p-type AlGaN and to obtain the deep ultraviolet emission with high power and efficiency, high-quality Al-rich AlGaN/AlN quantum wells were pumped by an electron beam. An output of 100 mW and a power efficiency of 40% have been achieved at a wavelength of about 240 nm by optimizing both the electron beam condition and the quantum well structure
KEYWORDS : electron beam pumping, deep ultraviolet light source, AlGaN/AlN quantum well
1. はじめに
波長200~300 nmの深紫外発光デバイスは水や空気の浄化や殺菌、医療、半導体プロセス等への応用が期待されている。しかし、現行の深紫外光源は短寿命、高コスト、有毒ガスの使用など様々な欠点を有している。これらの欠点を補う深紫外発光デバイスの材料としてAlxGa1-xNが注目され、研究が盛んに行われている[1,2]。AlxGa1-xNは直接遷移半導体であり、またAl組成を変えることによりバンドギャップを3.5eV から6.1eV[3]まで変化させることができるので、深紫外領域をカバーすることが可能である。近年の結晶成長技術の著しい向上により、AlxGa1-xN量子井戸(Quantum well: QW)の低温と室温の積分強度比から見積もられる内部量子効率(Internal Quantum Efficiency: IQE)は、70%(280 nm)[4]、50%(250 nm)[5]と高い値が報告されている。本研究室でも、Modified Migration Enhanced Epitaxy(Modified MEE)法[6,7]によって(0001)サファイア基板上にIQE=36%を持つ高品質なAlxGa1-xN/AlN QWを作製することに成功した[8]。
しかし、深紫外領域におけるAlxGa1-xNベースの発光ダイオード(Light Emitting Diode: LED)の外部量子効率(External Quantum Efficiency: EQE)は、未だ5%以下と非常に低いのが現状である[9-12]。EQEはIQEとキャリア注入効率(Carrier Injection Efficiency: CIE)、光取り出し効率(Light Extract Efficiency: LEE)の積で表わされるので、EQEが低い原因を各効率に分けて考えることは非常に重要である。IQEは上述したように高い値が実現しているが、一方でp型AlxGa1-xNのアクセプタ( Mg )の活性化エネルギーが非常に大きい(Al N:630meV[1])ためホール密度が低く、CIEが低い原因となっている。また、LEEに関しても、p-GaNやp型電極による光吸収や全反射による光ロスが大きいため低い値となっており、8%との報告もされている[11]。
以上から、EQEが低い多くの原因はp型部分に起因していることが分かる。そこで、p型に関する問題を回避するために、電子線励起法が提案された。実際に、電子線励起法によるAlxGa1-xNを用いた深紫外光源の実現への試みはすでになされており、MiyakeらはSiドープしたAlxGa1-xN薄膜の電子線励起深紫外発光デバイスを作製し、波長247nmで2.2mWの深紫外出力を達成した[13]。本研究では、さらなる高出力かつ高効率な深紫外発光を得るために、Modified MEE法で作製した高品質なAlxGa1-xN/AlN 量子井戸の電子線励起の実証実験を行った。
ここで、量子井戸を使うことにより、薄膜やバルクに比べて以下の3つの利点が得られることを強調したい。1つ目は、キャリアの閉じ込め効果が非常に高く、IQEが高くなるという点である。2つ目は、再吸収を抑制できるという点である。これは活性層であるAl1Ga1-xNのバンドギャップがAlNのバンドギャップより低いので、AlxGa1-xN層から出た光がAlN層で再吸収されるのを原理的に回避できることが要因である。また、Al1Ga1-xN層での再吸収も井戸幅が薄いために極力避けることが可能である。3つ目は偏光特性である。AlNにコヒーレントに成長したAlxGa1-xN薄膜では、Al組成を増加させていくと、x~0.6で価電子帯頂上のバンドが重い正孔(Heavy Hole:HH)バンドから結晶場分裂正孔(Crystalfield split-off Hole:CH)バンドにスイッチングすることが知られている。その結果、光学遷移選択則からE||cに偏光した光が支配的になるため、約250nmより短波側においては(0001)面からの放射が得られにくいという問題が生じる。一方、本研究室では量子効果が価電子帯バンド構造に大きな影響を及ぼし、Al 組成の高いAlGaNであっても、発光がE⊥cに偏光しやすい、すなわち、(0001)面からの強い放射が得られることを実験的に検証した[14]。つまり、量子井戸の方がより結晶成長技術の成熟した(0001)面からのLEEを高くすることができると考えられる。
2. 実験方法
本研究で使用した試料は(0001)サファイア基板上にModified MEE法でAlNを~600nm成長させ、その上に同様の方法でAl0.69Ga0.31N/AlN量子井戸を8周期作製したものである。Al1Ga1-xN井戸層およびAlN障壁層の幅はそれぞれ1nm、15 nmである。ここで、試料のうちQWがある領域((1nm +15nm)×8 =128nm)をQW領域と定義する。
電子線励起による発光特性の評価のため、電子銃、試料、光検出器を真空チャンバー内に設置した。熱電子放出によって生成された電子線を磁界レンズでφ=0.5mm程度に絞って試料表面に照射し、試料裏面から出てくる深紫外光をフォトダイオード(Photo Diode:PD)で測定した。試料裏面は発光の全反射を抑制し、LEEを改善するために、粗くしてある。また、試料裏面からPD表面までの距離は3mmとし、以後提示する深紫外光出力はPDの測定値そのものを表わしている。用いたPDは、ALGAN社製の大きさ1cm×1cmのAlGaN PD[15]である。AlGaN PDは280nm以下のみに感度があることから(図1 を参照)、バンド端発光に起因するスペクトルのみを測定可能である。また、カソードルミネッセンス(Cathodoluminescence: CL)に関しては、表面から出てきた光をレンズで集光して、液体窒素冷却CCDを接続した50cm分光器を用いて検出した。
3. 実験結果と考察
3.1 量子井戸の光学特性評価
まず、基礎的な光学特性を明らかにするために、低温と室温でフォトルミネッセンス(Photoluminescence :PL)の測定を行った。240nm付近にバンド端発光に起因するスペクトルが観測され、深い準位によるスペクトルは観測されなかった。また、低温と室温の積分強度比からIQEを見積もると、57%と高い値が達成できていた。
また、CLスペクトルも室温において測定した。結果を図1に示す。PLと同様にバンド端発光付近のスペクトルが観測できた。また、320nmにdeep levelによる発光が観測された。これは表面励起のPLでは観測されなかったのに対し、裏面励起のPLでは観測されたことから、AlN/sapphire付近の結晶性の悪い部分に起因していると考えられる。
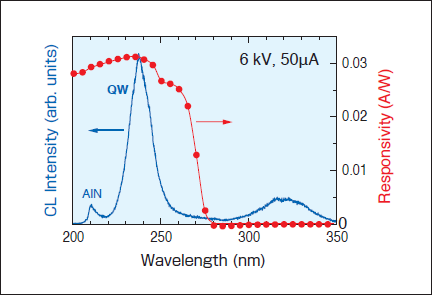
図1. Al0.69Ga0.31N/AlN 8QWのCLスペクトルとAlGaN PDの感度特性
3.2 モンテカルロシミュレーションによる
加速電圧の最適化
固体の表面に照射された加速電子は、固体中の原子や電子と相互作用を起こしながら、固体中に侵入する。この侵入長は固体の平均原子番号、原子核の重さ、密度および電子の加速電圧によって決まることが知られている[16]。ここで、量子井戸を電子線励起する際には、加速電圧VAを最適化する必要があると考えられる。この理由は以下のように説明できる。加速電圧が高すぎる場合は、一部の電子がQW領域を通り過ぎてしまうために、本質的な発光成分に寄与しない下地のAlN層を励起してしまい、エネルギー損失につながる。逆に加速電圧が低すぎる場合は、表面側のQWでしか電子正孔対が生成されず、また生成される電子正孔対の数が減少する。そこで、Al0.69Ga0.31N/AlN 8QWに最適な電子の加速電圧を見積もるために、モンテカルロシミュレーションを行った。シミュレーションにはフリーソフトのCASINO[17]を用いた。例として、VA=8kVの結果を図2に示す。表面から深くなるにつれて、電子線のエネルギーが吸収されていく様子がわかる。

図2. VA=8 kVにおけるAl0.69Ga0.31N/AlN 8QWのモンテカルロシミュレーション。 図中の数字は加速電子のエネルギーが初期の何%になっているかを示している。
さらに定量的に議論するために、QW領域でのエネルギー吸収を考える。図3は、吸収エネルギーそのものの値とそれが照射エネルギーに占める割合を加速電圧の関数として示している。ここで、後者はCIEに対応していると考えられることを言及しておく。吸収エネルギーが、VA=8kV付近で最大になっているのは、上述のとおり、これ以上の加速電圧では照射された電子の多くがAlN層に達していることを示している。また、吸収割合の方も同じメカニズムに従って、VA=8kVあたりから減少していることが分かった。以上の観点から、加速電圧の最適値は8kVであると予想される。
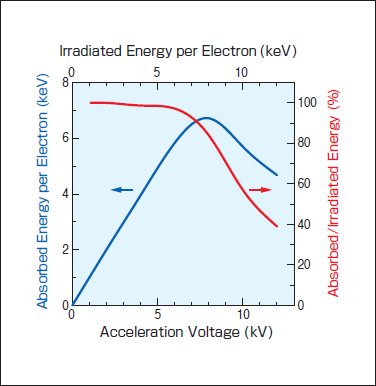
図3. QW領域において吸収されるエネルギー(左軸)とそれが照射エネルギーに占める割合(右軸)の加速電圧依存性
3.3 深紫外光出力とパワー効率
モンテカルロシミュレーションでの考察を実験的に確かめるために、2節で説明した測定系を用いて深紫外光出力を測定した。VA=6,8,10kVにおける深紫外光出力とパワー効率(Power Efficiency : PE)の照射電流依存性を図4に示す。すべての加速電圧に対して、照射電流Iを増加するにつれて出力が増加した。また、VAを6kV から8kVまで増加すると、出力の増加が確認でき、とくにI=45μAのときに100mWの出力を達成した。しかし、加速電圧をこれ以上上げても、出力はこれ以上増加しなかった。また、効率に関しては、VA=8kVの時に最大となり、とくにI=5μAのときに最大40%のPEを実現した。これらの結果はAl0.69Ga0.31N/AlN 8QWの試料に対して、VA=8kVが最適であることを示しており、またモンテカルロシミュレーションと同じ傾向を示していることから、妥当な結果であるといえる。
最後に100mWの出力を達成したとき(VA=8kV, I=45μA)の各効率の見積もりを行った。PLの低温室温積分強度比からIQE=0.57、モンテカルロシミュレーションの結果(図3)からCIE=0.84とすると、ηEH×LEE =0.58という結果が得られる[18]。ここで、ηEHは0<ηEH <1を満たす定数であり、照射された加速電子のエネルギーのうち、電子正孔対を生成するのに使われるエネルギーの割合を示している。深紫外光は粗い裏面から効果的に出ていくと考えられるので、妥当な値になっていると考えられる。ηEHやLEEの内訳などの詳細な考察に関しては、現在検討を進めているところである。
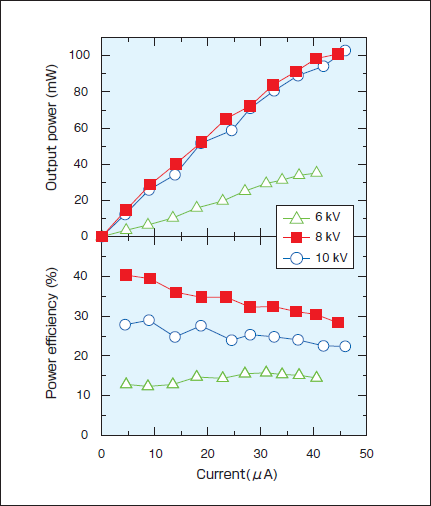
図4. VA=6,8,10kVにおけるAl0.69Ga0.31N/AlN 8QWの深紫外出力とパワー効率の照射電流依存性
4. まとめ
AlGaN/AlN量子井戸の電子線励起について、適切な量子井戸設計とその量子井戸に最適な加速電圧の選択により、最大100mWの深紫外出力と最大40%のパワー効率を実現することに成功した[18]。この結果は、ハイパワーかつ長寿命でポータブルな深紫外光源を実現できる可能性を十分に秘めている。
5. 謝 辞
本研究を行うにあたり、ALGAN株式会社の人羅俊実様にはAlGaN PDの手厚いサポートをしていただきました。感謝の意を申し上げます。


