(2015.10)
信学技報
a-Ge膜のFLA結晶化における印加電圧依存性
Lamp-voltage dependence of FLA crystallization for a-Ge film
平野 翔大1 部家 彰1 松尾 直人1 河本 直哉2
中村 祥章3 横森 岳彦3 吉岡 正樹3
1 兵庫県立大学大学院工学研究科
2 山口大学理工学研究科
3 ウシオ電機株式会社播磨事業所
あらまし
GeはSiに比べて高い電子移動度を持つため,次世代MOSFETのチャネル材料として期待される。本研究ではフラッシュランプアニール (FLA) 結晶化において,a-Ge薄膜の結晶化過程を精密制御するため,ランプ印加電圧依存性を検討した。ラマンスペクトルの結晶相に起因するピークの半値幅 (FWHM) からFLA結晶化を行ったGe膜は固相結晶化 (SPC) に比べて液相結晶化 (LPC) の方が低欠陥密度であることが示唆された。高温条件 (高印加電圧条件:2800-3400V) では,原子空孔を介したGe原子の拡散が促進されるため,欠陥密度が低減されたと考えられる。Ge膜の結晶化において,原子空孔を考慮した結晶化過程を制御することの必要性が示唆された。
キーワード: Ge, フラッシュランプアニール,固相結晶化,液相結晶化,空孔
Abstract
Ge is expected as a channel material for the next generation MOSFET because the electron mobility is larger than that of Si. In this study, to control the crystallization process of a-Ge thin film, lamp-voltage dependence of Flash Lamp Anneal (FLA) crystallization for a-Ge film was investigated. Full width at half maximum (FWHM) estimated from Raman spectra of the Ge films prepared by FLA crystallization indicated that the defect density in Ge film for liquid-phase crystallization (LPC) was lower than that for solid-phase crystallization (SPC). It is considered that the defect density was decreased by the diffusion of Ge atoms via the vacancies in high-temperature regions (high lamp voltages : 2800-3400V). For the FLA crystallization of Ge film, it is necessary to control crystallization process considering the behavior of vacancy.
Keywords: Ge,Flash lamp anneal,Solid-phase crystallization,Liquid-phase crystallization,Vacancy
1. はじめに
GeはSiに比べて3900cm2/Vsと高い電子移動度を持ち,低温での結晶化が可能であるため,次世代MOSFETのチャネル材料として期待されている[1]。また無機半導体膜の低温結晶化はフレキシブルシートコンピュータに用いられる高性能薄膜トランジスタ (TFT) の実現のために重要な技術であり,急速熱処理 (RTA) やマイクロ熱プラズマジェット照射 (μ-TPJ) などによるa-Geの結晶化が検討されている[2-3]。我々はこれまでにa-Si膜のエキシマーレーザーアニール (ELA) 結晶化を検討しており,固相状態での2次元結晶成長について,原子空孔を仮定した固相成長による結晶化機構を提案した[4-6]。またガラス基板への熱損傷を回避しつつ,ミリ秒台での熱処理が可能であるフラッシュランプアニール (FLA) 結晶化についても検討している。現在までに,FLA結晶化を用いて結晶化させたGeを用いた薄膜トランジスタの電気特性も報告されている[7]。 本研究ではFLA結晶化においてa-Ge薄膜の結晶化過程を精密制御するため,ランプ印加電圧依存性を検討した。
2. 実験方法
電子ビーム (EB) 蒸着法により,a-Ge膜を石英基板上に基板ホルダ温度RT,堆積速度0.1nm/sで30nm堆積した。試料を1%HF水溶液で処理した後,400℃に予備加熱した状態でFLAによる結晶化を行った。FLAの条件は,ランプ印加電圧2500, 2600, 2800, 3000, 3400V,照射回数は1, 5 回であった。結晶性評価にはラマン分光 (Ar+レーザ,波長514.5nm) ,電子スピン共鳴法 (ESR) ,X線回折装置 (XRD) を用いた。表面観察には原子間力顕微鏡 (AFM),走査型電子顕微鏡 (SEM) を用いた。ラマンスペクトルは1試料につき,2か所測定した。SEM観察はpoly-Ge膜をセコエッチングで表面の酸化膜・残留アモルファスGeを除去してから行った。0.5%HF水溶液と二クロム酸カリウムを混ぜたエッチング溶液を用いて,温度35℃で5秒間エッチングを行った。
3. 結果と考察
3.1. FLA poly-Geの結晶構造および結晶欠陥
FLA結晶化を行ったa-Ge膜のラマンスペクトルから得られた結晶化率,結晶相のピーク位置,ピーク半値幅 (FWHM) をFig.1に示す。FLA結晶化したGe薄膜は全条件について97%以上結晶化していたが,印加電圧が低くなるとわずかながら結晶化率が低くなる傾向を示した。また高印加電圧 (2800, 3000, 3400V) と低印加電圧 (2500, 2600V) においてのピーク位置の振る舞いから,Ge膜の結晶化過程は,高印加電圧側はLPC,低印加電圧側はSPCと考えられる。低電圧側では単結晶Ge (300cm-1) に比べ,ピーク位置が低波数側にシフトしていた。また照射回数が増えると,わずかに高波数側にシフトしていた。照射回数の増加により,応力が緩和したためと考えられる。LPCでは温度が高く,原子空孔を介したGe原子の拡散が促進されるため,欠陥密度が小さくなる。一方,SPCでは温度が低く,Ge原子の拡散が抑制されるため欠陥密度が大きくなると考えられる。 また,FLA結晶化を行ったa-Ge膜のうちランプ照射を5回行った試料の電子スピン密度をTable.1に示 す。LPCにおいては検出限界以下であったが,SPCではスピン密度が2.80~3.26×1018 cm-3であり,Ge膜中に結晶欠陥が多く存在することが分かった。このようにGe膜の結晶化過程が,結晶欠陥の生成に影響していると考えられる。
次にFLA結晶化を行ったa-Ge膜の (111) ピークのXRDパターンをFig.2に,各ピークにおけるFWHMと印加電圧の関係をFig.3に示す。照射回数による差はあまり見られなかったが,高印加電圧 (2800, 3000,3400V) と比べると低印加電圧 (2500, 2600V) ではピークの広がりは結晶粒径や歪に関係すると考えられる。またLPCとSPCにおけるFWHMの差は顕著に見られるが,LPCでの印加電圧依存性はあまり見られないことから,結晶成長は印加電圧よりも結晶化過程の影響が強いと考えられる。Ge膜の結晶化において,結晶化過程を制御することの必要性が示唆された。
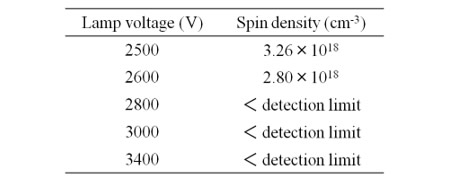
Table. 1 Spin densities of the Ge films after FLA at various lamp voltages.
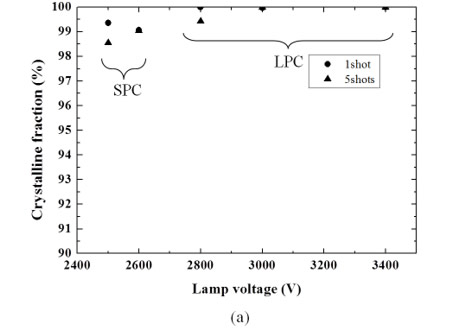
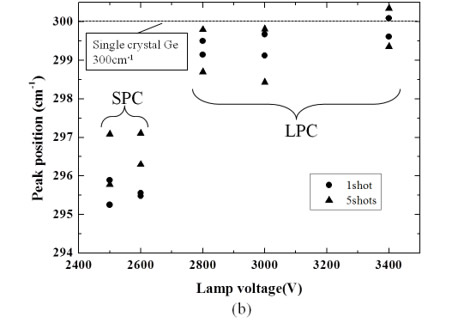
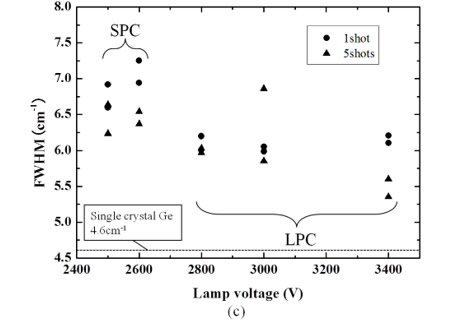
Fig.1 Crystalline fraction (a), Raman peak position (b), and FWHM (c) of Ge films after FLA as a function of lamp voltage.

Fig.2 XRD patterns of the Ge films crystallized at various lamp voltages.1shot (a) and 5shots (b).
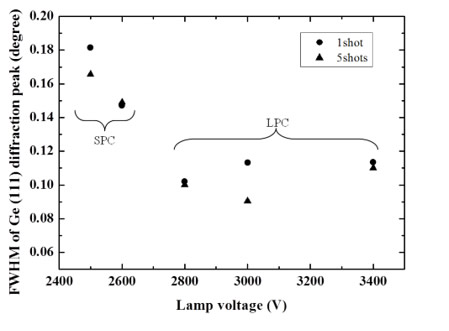
Fig.3 FWHM estimated from XRD patterns of Ge films as a function of lamp voltage.
3.2. FLA poly-Ge膜の表面形状
照射回数1回,2500V (SPC),3400V (LPC) のランプ印加電圧でFLA結晶化を行ったa-Ge膜のAFM像と自乗平均面粗さ (Rms) をFig.4に示す。LPCにおいてはRmsが99.5nmと非常に大きいことや表面形状から,Geの凝集が起こっていると考えられる。SPCではRmsが比較的小さく,凝集は起こっていないと考えられる。 また,照射回数1回,2500V (SPC),3400V (LPC) のランプ印加電圧でFLA結晶化を行ったa-Ge膜にセコエッチング処理を行った後のSEM像をFig.5に,SEM像から見積もった各ランプ印加電圧におけるpoly-GeサイズをFig.6に示す。2500V (SPC) における粒径の平均は122nm,3400V (LPC) における粒径の平均は432nmであり,結晶化過程の違いにより平均粒径に300nm以上の差が見られた。SPCではLPCに比べ,poly-Geの密度が大きい傾向も見られた。LPCにおける結晶核生成。結晶成長は過冷却液体からの固体化によるモデルが考えられる。一方,SPCにおいては固相核生成からの再結晶過程による結晶成長であると考えられるため,LPCに比べてpoly-Geの粒径が小さいと考えられる。FLA結晶化においてランプ印加電圧を制御することにより,poly-Ge膜の結晶粒密度,結晶粒径を制御できる可能性があると考えられる。

Fig.4 AFM images of the Ge films crystallized by FLA. The shot number was 1. Plane view (a) and quarter view (b) at 2500V (SPC). Plane view (c) and quarter view (d) at 3400V (LPC).
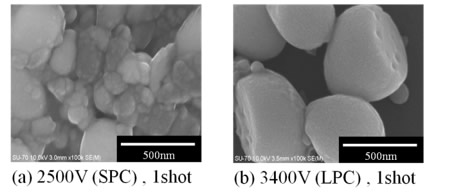
Fig.5 SEM images of the Ge films crystallized at 2500V (SPC) (a) and 3400V (LPC) (b).

Fig.6 Poly-Ge grain size estimated from SEM images as a function of lamp voltage.
3.3. FLA結晶化における原子空孔の影響
液相成長では原子空孔濃度が固相結晶化に比べ,高くなる。多ショット照射ELAにおける固相での結晶粒の2次元成長モデルをFig. 7に示す。FLAにおいても多ショットの場合,FLAによって与えられた熱エネルギーにより結晶粒内の結晶欠陥(原子空孔)は結晶粒界に移動する。ある臨界量の原子空孔が結晶粒界に移動することにより,非優先配向結晶粒内のGe原子の原子空孔への移動が促進される。その結果,優先配向の結晶粒が成長する。本実験では5ショットと照射回数が少ないために,顕著な結晶粒の増大は見られなかったが,FLA固相成長においてもGe膜中の原子空孔濃度は結晶粒成長に影響を与えることが予想される。 原子の拡散は原子空孔との位置交換で進行する。つまり,原子空孔濃度が大きいほど,拡散係数も大きくなる。即ち,空孔密度が大きいほど,自己拡散の頻度も大きくなる。そのため,高印加ランプ電圧条件ではGeの凝集が起こりやすいと考えられる。またFLA後の原子空孔濃度は,液相成長よりも固相成長の方が低いことから,液相成長における原子空孔は,Ge原子の自己拡散を促進することで,最終的な欠陥密度を低減したと考えられる。
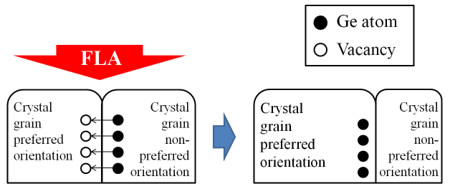
Fig.7 Schematic diagram of secondary grain growth model for SPC.
4. まとめ
Ge薄膜のFLA結晶化において,ランプ印加電圧について検討した結果,以下のことが明らかとなった。
- 1) FLA結晶化では,ランプ印加電圧により固相結晶化と液相結晶化を選択でき,固相結晶化と液相結晶化では原子空孔濃度の違いに伴う原子の自己拡散に違いがあり,これが結晶化に影響を与えていると考えられる。
- 2) 高印加電圧(LPC)では温度が高く,原子空孔を介したGe原子の拡散が促進されるため,欠陥密度が小さくなる。一方低印加電圧(SPC)では温度が低く,Ge原子の拡散が抑制されるため欠陥密度が大きくなると考えられる。Ge膜の結晶化過程が,結晶欠陥の生成に影響していると考えられる。
- 3) SEM像から見積もった2500V (SPC) における粒径の平均は122nm,3400V (LPC) においては432nmであった。SPCでは固相核生成からの再結晶過程による結晶成長であると考えられるため,LPCに比べて,結晶粒が小さいと考えられる。そのためFLA結晶化においてランプ印加電圧を制御することにより,poly-Ge膜の結晶粒密度,結晶粒径を制御できる可能性があると考えられる。


