(2016.03)
日本金属学会
2016年春期(第158回)講演大会
a-Ge膜のFLA結晶化におけるSiOxキャップ膜の効果
兵庫県立大工 吉岡 尚輝
兵庫県立大工 平野 翔大
兵庫県立大工 部家 彰
兵庫県立大工 松尾 直人
ウシオ電機(株) 中村 祥章
ウシオ電機(株) 横森 岳彦
ウシオ電機(株) 吉岡 正樹
阪大接合研 小濱 和之
阪大接合研 伊藤 和博
山口大理工 河本 直哉
緒言
GeはSiに比べ電子移動度が大きく、Ge膜の低温結晶化は薄膜トランジスタ(TFT)や薄膜太陽電池の特性向上のために重要な技術である。これまでにGe膜の固相結晶化(SPC)と液相(溶融)結晶化(LPC)の差異や原子空孔の挙動について検討している[1]。本研究ではGe膜のFLA結晶化におけるSiOxキャップ膜の効果を検討した。
実験方法
電子ビーム蒸着法により、a-Ge膜を石英基板上に基板温度RT、堆積速度0.1nm/sで30nmまたは60nm堆積した。その上に反応性スパッタ法によりSiOx膜を10nm作製し、キャップ膜とした。比較のため、SiOxキャップ膜がない試料にも400℃に予備加熱した状態でFLAによる結晶化を行った。FLAの条件は、ランプ印加電圧2500 - 3400V、照射回数1回である。結晶性評価にはラマン分光(Ar+レーザ、波長514.5nm)を用いた。
結果
FLA結晶化を行ったGe膜のラマンスペクトルから得られた結晶相のピーク位置とそのピーク半値幅(FWHM)をFig. 1に示す。Ge膜厚30nmの試料ではSEM観察の結果から2600V以下ではSPC、2800V以上ではLPCであることが明らかになっている[1]。SiOxキャップ膜無しの場合、ランプ電圧2600V以下(SPC)ではGe膜厚で膜の内部応力と対応するピーク位置に差異が見られた。また、SiOxキャップ膜があるとピーク位置は減少し、SiOxキャップ膜の有無がGe膜の結晶成長(SPCおよびLPC)に影響を与えることを示している。SiOxキャップ膜無しの場合、結晶欠陥密度に対応するFWHMはGe膜厚30,60nm共にランプ印加電圧が大きくなると減少する傾向を示した。また、SiOxキャップ膜があると3400Vの高ランプ印加電圧(LPC)では差異はないが、2600Vの低ランプ印加電圧(SPC)ではFWHMは減少した。SiOxキャップ膜はSPCの結晶成長において結晶欠陥密度の低減に効果があると期待できる。以上のように膜厚10nmのSiOxキャップ膜はGe膜のFLA結晶化に影響を与えることが明らかとなった。
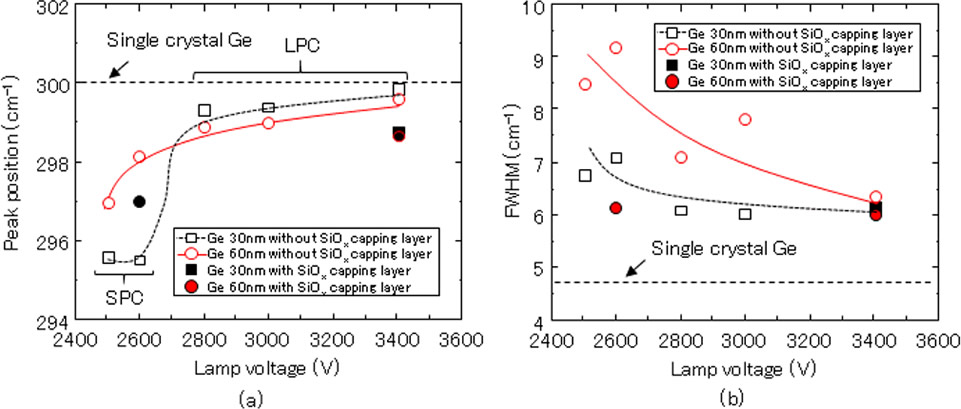
Fig. 1 Raman peak position (a) and FWHM (b) of Ge films after FLA as a function of lamp voltage. Lines are shown as visual guides.


