光技術情報誌「ライトエッジ」No.1
付属資料
(1995年冬発行)
半導体製造用エキシマUV/O3洗浄装置
半導体製造においては微細化が進み、迅速で精密な洗浄が要望されています。近年、上記目的に低圧水銀ランプ(185nm、254nm)によるUV/O3洗浄装置が使用され始めました。UV/O3洗浄(光洗浄)には、
- ●省エネルギー
- ●すでに形成されている素子や結晶にダメージを与えない
- ●低温で処理できる
などのメリットがある一方で、低圧水銀ランプでは、
- ●処理速度に限界がある
- ●点滅点灯ができない
などの問題があり、より発光効率が高く、処理能力の優れた短波長光源の開発が求められていました。弊社では従来の低圧水銀ランプとは全く放電機構の異なる誘電体バリアランプを開発し、本ランプを用いたエキシマ照射装置も同時に開発いたしました。本照射装置の発光波長は172nmの単色光であり、洗浄スピード、改質スピードが低圧水銀よりも速い、瞬時点灯、点滅点灯可能、人間の目に安全などの特徴があります。また、洗浄速度が大きいため、オゾナイザーを使用しない光アッシングの可能性もあります。
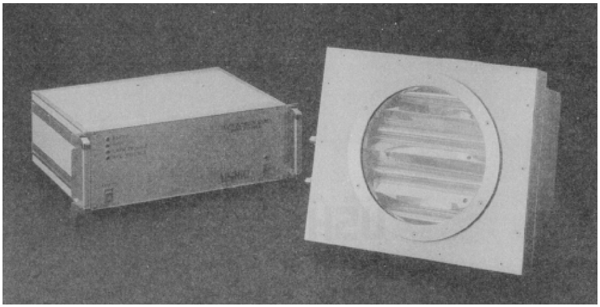
特 長
- 1)瞬時点灯、点滅点灯可能、枚葉処理に最適
- 2)高出力型低圧水銀ランプに比べ10倍以上の洗浄速度(試料との距離1mmの時。約7mmで同等)(低出力低圧水銀ランプに比較すると数十倍)
- 3)低圧水銀ランプの1/3の電力(熱発生量が小さく低温プロセスが可能)
- 4)発光波長が172nmの単色光であり、安全
用 途
- ●半導体基板のUV/O3洗浄
- ●フォトマスクのUV/O3洗浄
- ●層間絶縁膜(SOG)の濡れ性改善
- ●光アッシング
UV/O3洗浄(光洗浄)の原理
有機物の分解・除去
■低圧水銀ランプによる洗浄
精密洗浄の1つであるUV/O3洗浄には、従来は、低圧水銀ランプが用いられてきました。低圧水銀ランプは185nmと254nmの光を放射します。
原理を下記に記します。185nm紫外線は、空気中の酸素(O2)に吸収されオゾン(O3)を発生します。このオゾンに254nmの紫外線が吸収されると、励起酸素原子が生成します。
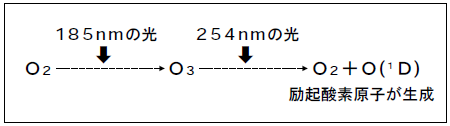
一方185nmのような短波長紫外線は光子のエネルギーが強く、有機物を切断すると言われています。この有機物に、上記の非常に酸化力の強い励起酸素原子が反応しCO2、H2Oのような揮発性物質を生成し、揮発除去します。
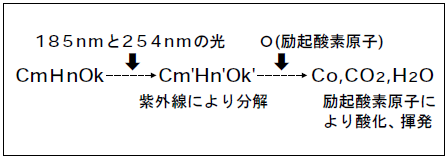
洗浄速度の因子はいくつかありますが、現状では、励起酸素原子の数が一番影響を与えると考えられています。
■ 誘電体バリア放電エキシマランプによる洗浄
キセノンガスが封入された誘電体バリア放電エキシマランプの放射紫外線の波長は、中心波長172nmで半値幅は14nmです。
大気中の酸素に吸収されるのは185nmの光と同じですが、175nmより短波長の光は直接、励起酸素原子を生成します。
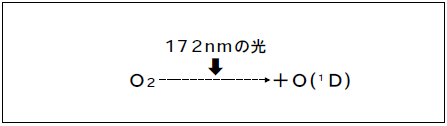
172nmの光はまた185nmの光と同様にオゾンを生成し、原子状の酸素を生成する経路も有します。この2つの経路で、本ランプは低圧水銀ランプより、多くの励起酸素原子を生成し、洗浄速度を早めることができます。
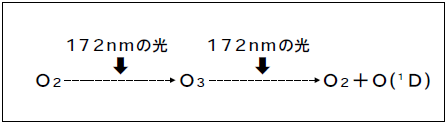
172nmの光は185nmの光よりも光子のエネルギーが強く、有機物を容易に切断いたします。この有機物に上記の非常に酸化力の強い励起酸素原子が反応し、CO2、H2Oのような揮発性物質を生成し、揮発除去します。

■ランプハウス仕様
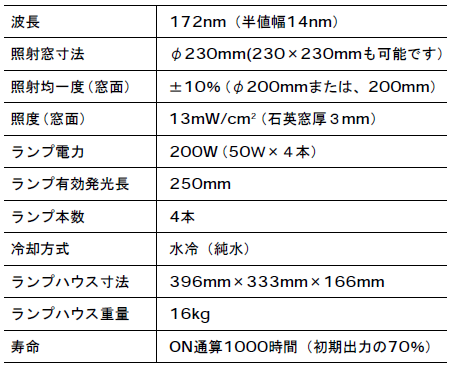
■電源仕様

■ユーティリティー

■外観図