光技術情報誌「ライトエッジ」No. 4(1996年2月発行)
第56回 応用物理学学会 学術講演会 講演予稿集
(1995年8月26日~28日)
28p-ZV-3
エキシマランプによるSiウエハのUV/オゾン洗浄
UV/Ozone cleaning of Si surface by excimer lamp
九大工、ウシオ電機(株) *、山口浩司、植松 豊、渡鍋 文哉、五十嵐龍志*、松野 博光*、本岡 輝昭
Kyusyu University,USHIO INC.* K.Yamaguchi, Y.Uematsu, F.Watanabe, T.Igarashi*, H.Matsuno*, T.Motooka
【目的】
Si基板を集積回路作成用基板として使用する場合、表面有機汚染物の除去が要求される。本研究では、この表面有機汚染物の除去を光源として誘電体バリア放電エキシマランプ(波長=172nm)を用いたUV/オゾン洗浄法により行い、その洗浄効果及び洗浄のメカニズムについて検討を行った。
【方法】
酸素ガスのフリージェットパルスを真空チェンバー(~10-7 Torr)内に導入し、p型Si(100)ウエハ表面にUV光とともに照射しUV/オゾン洗浄を行った。表面の清浄度の評価を昇温脱離法(TDS)により、また洗浄中におけるウエハ表面での反応を時間分解四重極質量分析法(QMS)により調べた。
【結果】
実験結果の一例として右図に質量数28(CO+,N2+,C2H4+)、44(CO2+)の昇温脱離スペクトルを示す。UV/オゾン洗浄を行ったウエハ-は洗浄を行っていないウエハに比べてそのシグナルの強度が常に低くなっている。また、湿式洗浄を行ったウエハと比べてみるとそのシグナルの強度は常にほぼ同等またはそれ以下になっており、これらのことからその洗浄効果を確認できる。また洗浄中におけるQMS信号の時間変化から、酸素ガスとエキシマランプの照射によりウエハ表面でCO等が発生していることがわかった。
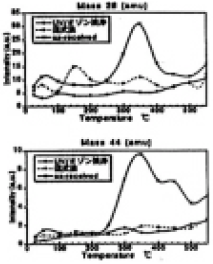
1116
論文を探す
キーワード
掲載誌:ライトエッジ No.4



