光技術情報誌「ライトエッジ」No.18(2000年3月発行)
レーザー学会学術講演会第20回年次大会
第60回応用物理学会学術講演会 講演予稿集(1999. 9. 甲南大学)
1p―H―1
(2000年1月)
露光用2kHz ArF エキシマレーザーの開発
2kHz ArF excimer laser for 193nm lithography
(株)ウシオ総合技術研究所
斎藤隆志、三橋健一、新井基尋、多田昭史、渡辺英典、抜々木陽一、五十嵐龍志、堀田和明
USHIO Research Institute of Technology Inc.
T.Saito, K. Mitsuhashi, M. Arai, A. Tada, H. Watanabe, T. Igarashi, K. Hotta.
E-mail saitotks@mail.ushio.co.jp
1. はじめに
ArFエキシマレーザは、0.3µmルール対応の次世代露光用光源と考えられており、その性能向上に向けた開発が活発に進められている.我々は、露光用1kHzArFエキシマレーザを開発し、基本特性を実証したことを既に報告している[1]。今回、更に高スループット化に対応すべく、2kHzArFエキシマレーザを開発し、その基本特性を実証したので報告する。
2. 装置
開発した装置には、高繰り返し時における放電の不均一性を低減するために、発光量、均一性の改善を計った誘電体バリア放電予補電離、高速ガス流チャンバを採用するとともに、電極間に100ns の高遠な高電圧を印加可能な個体パルス電源を搭載した。
3. 実験結果
図1に繰り返し周波数に対する出力特性、図2に5mJ@1kHz動作における出力制御結果を示す.放電の均一化を行った結果、1kHz 以上の繰り返し周波数においても、出力は増加し、2kHzの動作において12Wを得ることができた。更に、1kHz動作の移動積算値において、±0.3%(50パルス)と十分な高安定性を実証することができた。今後、放電回路部等の改良により、更に高出力及び高安定化を目指す予定である。

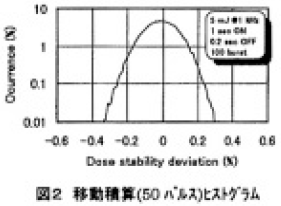
参考資料