光技術情報誌「ライトエッジ」No.26(2003年8月発行)
電気情報通信学会 シリコンデバイス研究会
(2002年3月)
フラッシュランプを用いた新しい
PZT膜結晶化技術
○山川 晃司・今井 馨太郎・有隅 修・有門 経敏・吉岡 正樹1・大和田 樹志1・奥村 勝弥2
(株)東芝セミコンダクター社、プロセス技術推進センター、横浜市磯子区新杉田町8
1ウシオ電機(株)、ランプ技術本部
2東京大学、先端科学技術研究センター
フラッシュランプを用いた新しい強誘電体キャパシタの成膜方法を開発した。基板加熱温度350°Cの条件で、パルス状(1.2msec.)のXeフラッシュランプ光をアモルファスPZT膜に照射すると、強誘電性ペロブスカイト単相に結晶化することができる。大きい照射エネルギー(27J/cm2)の光パルス照射が、基板方向への熱拡散を抑制し、Al多層配線上のPt/PZT/Pt構造キャパシタの成膜をも可能とする。また、SiO2上のアモルファスPZT膜でも、下地基板と反応することなく結晶化できる。本プロセスではPt、Ru、RuO2などの各種基板上で粒状のPZT膜構造が得られ、膜の表面から結晶化が進行することが予想された。Ru上部電極を用いることで最高温度350°CのプロセスでPZT膜を形成し、ヒステリシス特性を確認した。フラッシュランプによる超高速加熱法は強誘電体膜結晶化に応用可能であり、FeRAM混載LSIや1トランジスタ型FeRAMに有効であることを示した。
1. はじめに
FeRAMは高速動作、1E12回以上の書き込み耐性、低消費電力、CMOSプロセスとの整合などの利点をもち、FeRAM混載LSIとして、多機能カード、無線カード、マイクロコントローラなどに使用されてきている。また、大容量FeRAMはEEPROMの代替のみでなく、高密度メモリ混載LSIや低消費電力SRAMの置き換え分野などで期待が拡がっている。しかしながら、デバイスを作製する際に多くのプロセス起因の問題が生じる。例えば、ILD CVDやRIEプロセスにおけるPZTキャパシタ特性の劣化、COP(capacitor on plug)構造でのプラグ酸化によるコンタクト抵抗の増加、デバイス作製中のPb、Ptなどによるクロスコンタミ問題がある。多層配線上に強誘電体キャパシタを形成する方法はこれらの問題を克服する一つの方法である。この場合、Al多層配線へのダメージがない状態でPZT膜を結晶化しなくてはならない。また、次世代のFeRAMとして期待される1トランジスタ型FeRAMでは、ゲート上に界面劣化のない状態で強誘電体薄膜を形成する技術が必須となる。これらのデバイスを実現するため、下地基板への熱的ダメージの低減が望まれる。われわれは新しく開発したフラッシュランププロセスを用いてPZT膜の結晶化を行った(コンセプトを図1(b)に示す)。フラッシュランプ技術はRTA技術の広い普及により、これまで半導体プロセスでは使用されてこなかった。しかしその急峻な昇温特性から、現在、様々な応用が検討されている1)。ミリセコンドの短時間に大エネルギー光パルスを照射することで照射物の表面層近傍のみ温度をあげることができ、光照射の効果も期待できる。本プロセスは誘電体薄膜、各種薄膜のアニールなどにも適用可能と考える。
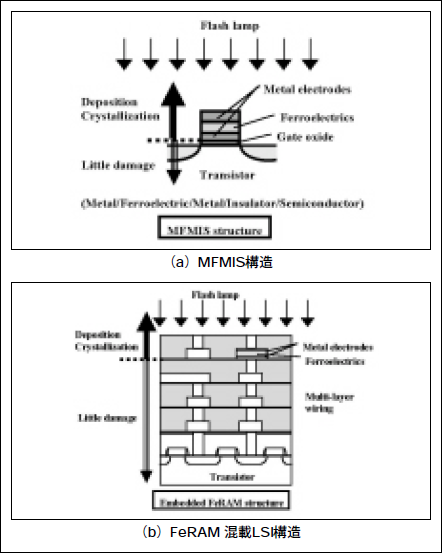
図1 フラッシュランプを用いたPZT膜結晶化プロセスのコンセプト
2. 実験
フラッシュランプ実験装置の概要を図1(a)に示す。基板加熱ステージの上に反射板で覆うようにしてXeフラッシュランプを配置する。Xeランプは太陽光のような広い波長範囲のスペクトルをもつ。このスペクトルはランプ強度、圧力などに影響を受ける。Xeランプに流れる電流と光パルス幅、強度は回路に組んだキャパシタとインダクタにて制御する。電流値はL(dJ/dt) + a(l/r)J1/2+RJ+1/C(Jdt)=V0のように表わすことでできる。ここでL、R、Cはそれぞれ回路のインダクタンス、抵抗、キャパシタンスを示す。左辺の第二項はフラッシュランプにかかる電圧で、ランプの径 r と長さ l により変化する。ランプ形状は照射パルス形に影響を及ぼす。典型的な値としては、電流値が最大1800A(エネルギー密度計算値:27J/cm2)、パルス幅1.0-1.5msである。PZT膜の結晶化を促進するために、基板温度(以降、アシスト温度と呼ぶ)を300 - 400°Cとした。アシスト温度はフラッシュランプ照射のない状態で熱電対を用いて試料表面にて測定した。フラッシュランプ照射時のPZT膜の表面温度は500 - 600°C以上に達すると考えられる。ここで使用したPZT膜は室温にてRFスパッタにより形成したアモルファス膜である2)。本フラッシュランププロセスによるPZT膜結晶化の挙動を検討するにあたり、Pt、Ru、RuO2、SiO2をそれぞれ成膜したSi基板を用いた。結晶化したPZT膜の構造特性と電気的特性はXRD、 SEM、SIMS、RT6000強誘電体テスター(Radiant社製)を使用した。
3. 結果と考察
最初にSi基板上にPt電極膜を形成した上でPZT膜を結晶化させた。フラッシュランプエレルギー密度(ほぼ電流に比例)、照射時間、アシスト温度などをパラメータとして結晶化挙動を調べた。ランプエネルギー密度が27J/cm2の時、アシスト温度350°CでPZT膜の結晶化が観測された。ランプ照射を行わない場合には、基板温度(アシスト温度)を450°Cまであげてもペロブスカイト相は観察されなかった。PZT膜の強誘電体ペロブスカイト相への相変化は様々な要因に影響される。電極界面でのアモルファスPZT膜中の過剰Pb、PtのようなPZTとの良好な結晶格子の整合性、高速昇温熱処理、酸素中でのRTOによる結晶化などはペロブスカイト相形成を促進する。図2はXRD結果から求めた様々なPb量を含む(Pb/(Zr+Ti)=1.05-1.20)PZT膜のフラッシュランプによる結晶化挙動を示す。過剰Pb量を含むPZT膜が低いアシスト温度で結晶化が進むことがわかる。
図3にフラッシュランププロセスにおいて、アシスト温度を変化させた時のPt電極上のPZT膜の微構造変化を示す。RTAプロセスにてPZT膜を結晶化した場合と異なり、フラッシュランププロセスでは粒状のPZT膜構造を示す。RTAによるPZT結晶化膜は一般的に柱状構造を示す[3]。この構造の違いはフラッシュランププロセスにおける熱パルスによる核生成および結晶成長挙動の違いによるものと考えられる。結晶化したPZT膜はPt(111)面上においても<111>方向への優先配向が見られない。アシスト温度の上昇とともに粒状のPZT結晶粒は柱状結晶へと変化し、RTAを用いて結晶化した膜の微構造に近づいてゆく。フラッシュランププロセスを用いてIrO2やRuO2電極上にPZT膜を結晶化した場合も、RTAを用いて結晶化したPZT膜と比較して異なった粒状の微細構造を示す。後者では非常に大きいPZT粒が観察されるのに対し、前者ではPt上と同様の細かい粒状結晶が形成される。RuとRuO2上に形成したPZT膜の結晶構造を表1に示す。図4、図5に示すように、アシスト温度によりPZTの結晶構造が変化する。このことからも上述した結晶化挙動が推測される。
本フラッシュランププロセスを用いたPZT膜結晶化実験で、アモルファス状態からペロブスカイト相への相変化が1msオーダーの非常に短時間で進行することがわかる。ミリ秒での相変化に関する報告例はこれまでになく、PZT膜の短時間結晶化に対して適当な方法がなかったことが原因と考えられる。レーザー照射などによるPZT膜結晶化例はあるものの、エネルギー密度の不均一性と局所加熱によるPbの多量の蒸発などが良好なPZT膜結晶化を妨げていたものと推測する。
本プロセスにて得られたPZT膜の電気特性例を図7に示す。上部電極はスパッタ法により形成したRuで、上部電極とPZT膜の界面の良好なコンタクトを確保するために350°Cのアニールを行っている。ここでRu電極を採用した理由は、350°Cのアニール(酸素中、30min.)で界面にRuO2が形成され、良好なコンタクトが形成されるためである。Pt上部電極の場合は600°C程度の高温アニールが必要となり、低温アニールでは接合部の整合性が改善されず、リーク電流の増加、ヒステリシスのシフト(インプリント)が見られる。Ruの場合はサーマルバジェットの低減に有効である。ここでのアシスト温度は350°Cである。本プロセスおよび構造はCOP(Capacitor On Plug)構造、多層配線上キャパシタ構造、MFISなどの1トランジスタFeRAM構造の作製において、いずれもサーマルバジェットを低減して下地基板への悪影響を防止することができる。
次にフラッシュランプの多数回照射の影響を調べた。ここではPt上に形成したPZT膜を試料とし、アシスト温度をパラメータとした。表2に多数回照射によるペロブスカイト相形成挙動を示す。フラッシュランプの照射回数の増加とともにPZT膜の結晶化が進むことがわかる。よって、フラッシュランププロセスにおけるPZT膜の結晶化は局所加熱効果によるもので、サーマルバジェットのトータル値がPZT膜の結晶性を支配する。本結果によりフラッシュランプ1ショットのエネルギー密度を低減することができ、ランプ寿命を延ばすことが可能となる。多くのFeRAM用ウエハを処理する際には重要なポイントとなる。
次にSiO2上でPZT膜を結晶化する実験を行った。SiO2上に直接PZT膜を結晶化させることは難しい。PbTiO3もしくはTiリッチなPZT膜の場合は結晶化温度が低いためにペロブスカイト相を得ることは可能であるが、MPB組成近傍のPZT膜では結晶化温度でPbがSiO2中に拡散し、あるいはPbとSiとの反応による鉛ガラスが形成されてペロブスカイト相が形成できない。われわれはフラッシュランププロセスを用いることでこれらの反応や拡散を抑制し、SiO2上にPZT膜を形成することができた。図8にフラッシュランプ照射有無の場合のXRDパターンを示す。通常のRTAプロセスではペロブスカイト相の生成が全く観察されないが、フラッシュランプ照射によりペロブスカイト相が形成できていることがわかる。MFISなどの1トランジスタ型FeRAMでは強誘電体/Si、強誘電体/絶縁相/Si構造でのそれぞれの界面の反応、拡散による劣化がメモリの電気特性、書き込み特性、保持特性などに影響を及ぼすため、これらの界面の熱的劣化を抑制することがキーとなる。本プロセスはPZT膜の結晶化のみならず、他の強誘電体膜を1トランジスタ型FeRAMに採用する場合にも有効と考えられる。
最後にAl配線層の上のPZT膜の結晶化について述べる。前述したようにFeRAM混載LSIではピュアメモリ以上にバックエンドプロセスの強誘電体キャパシタへのダメージを抑制する必要がある。このため多層配線層の上に強誘電体キャパシタを形成する方法が提案されている。この場合、Al配線層の劣化が起こらない500°C以下の温度での強誘電体膜形成技術がポイントとなる。PZT膜を室温RFスパッタにより形成しフラッシュランププロセスを用いた結晶化を試みた。図9に断面形状を示す。ここではPt下部電極上にPZT膜を結晶化しているが、Al配線層の劣化は観察されない。本実験では孤立したダミーAl配線を使用しているためにAl配線とのコンタクトなどをさらに調べる必要があるが、本フラッシュランププロセスがFeRAM混載LSI向けの多層配線上PZT成膜に使用できる可能性を示すものである。また、Cu配線や低誘電率膜からなる多層配線構造の場合はより重要性を増すと考えられる。

図2 フラッシュランププロセスの実験装置の概略図。

図3 フラッシュランプ照射有無の時のPZT膜の相変化の様子。
フラッシュランプ照射は強誘電性ペロブスカイト相形成を促進する。
膜中のPb量、基板温度(アシスト温度)などのパラメータにより
影響を受ける。
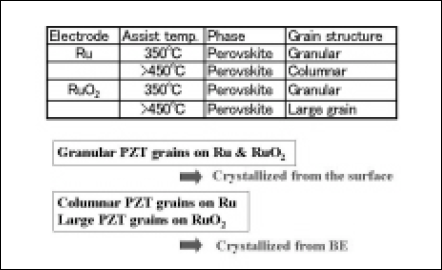
表1 RuとRuO2上でのPZT膜結晶化挙動。
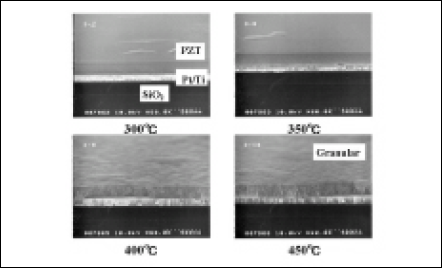
図4 フラッシュランププロセスにおけるアシスト温度のPt上に形成した
PZT膜の微細構造への影響。
PZT粒状粒子が観察される。(照射エネルギー : 20J/cm2)

図5 異なったアシスト温度で形成したRu電極上PZT膜の微細構造。

図6 異なったアシスト温度で形成したRuO2電極上PZT膜の微細構造。高温アシスト温度ではRTAプロセスと同じような大きい柱状組織が観察される。

図7 フラッシュランプにて作製したPt/PZT/Ru キャパシタのヒステリシス特性。本プロセスでは350°Cのアシスト温度と上部電極成膜後のアニールにて強誘電体特性が得られる。上部Ru電極成膜後のアニールは350°Cで、界面にRuO2層ができると考えられる。
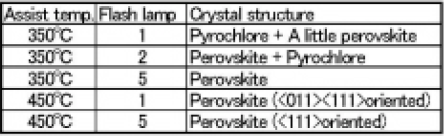
表2 フラッシュランプショット数のPZT膜結晶構造への影響。
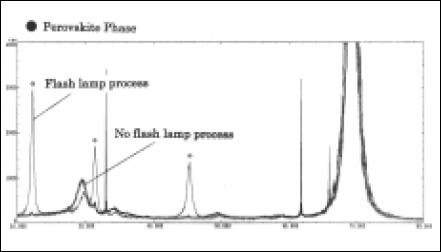
図8 フラッシュランププロセスによるSiO2上でのPZT膜の結晶化(XRD図形)。
(ドット:ペロブスカイト相)

図9 Al配線層上に形成したPZTキャパシタ膜構造。
(Al配線部分の形状劣化は観察されない)
4. 結論
新しく開発したXeフラッシュランププロセスを用いることで、下地基板への影響を抑制してPZT膜を結晶化できることを示した。このPZT膜の結晶化はミリ秒のオーダーで実現できる。構造特性、電気と区政評価により、本結晶化挙動は従来のRTAを用いた結晶化挙動と異なり、表面あるいは表面層で結晶化が促進されることで下地の影響を抑制できることが示された。さらに、SiO2膜上あるいは多層Al配線層上でも同様にPZT膜を結晶化することが可能である。本プロセスはFeRAM混載LSI用プロセス、あるいは将来の1トランジスタ型FeRAMに応用することが期待できる。


