光技術情報誌「ライトエッジ」No.29(2007年8月発行)
電子ジャーナルセミナー「プリント配線板パターン形成技術徹底解説」
(2006年8月)
プリント配線板露光技術の最新動向
ウシオ電機株式会社 システムカンパニー
佐藤 善彦
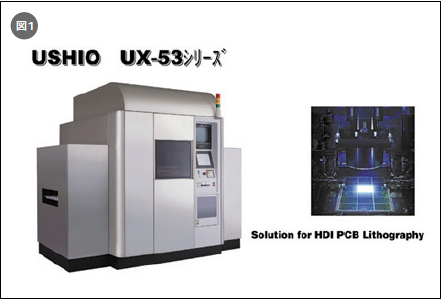
露光装置の概要と、プリント配線板用ステッパ「UX-53」のご紹介をいたします。

まず、弊社の露光装置の露光方式についてお話します。
次に、投影露光方式のご説明と、投影露光方式を用いた弊社の装置のバリエーションをお話します。
そして、プリント配線板用ステッパ「UX-53」のご紹介として、ターゲットとしているサブストレートのロードマップ、「UX-53」の特徴及び仕様、性能についてお話します。

まずは、弊社の露光装置の露光方式の概要、投影露光、バリエーションについてです。

露光装置の露光方式には、マスクとワークを接触させて露光を行う「接触露光方式」と、接触させずに露光を行う「非接触露光方式」の、大きく2つの方式があります。
「接触露光方式」を使う装置をコンタクト露光装置といいます。それは真空圧着を行なう「ハードコンタクト」と、吹付圧着を行う「ソフトコンタクト」に分かれます。
また、「非接触露光方式」には、「プロキシミティ露光装置」と呼ばれるワークとマスクの間に隙間を空けて露光する方式があります。ここまでが、投影レンズを使用しない露光方式です。
「非接触露光方式」で投影レンズを使う露光装置として、投影露光装置があります。これにはワークを分割して露光する方式と、ワークを一括して露光する方式があります。
また、投影レンズにより、縮小して露光する方式と、1:1で露光する方式があります。また、投影レンズにレンズ光学系を使用するもの、ミラー光学系を使用するものがあります。
弊社がプリント基板用に開発した露光装置は、1:1投影露光で、レンズ光学系を使用した投影露光装置です。
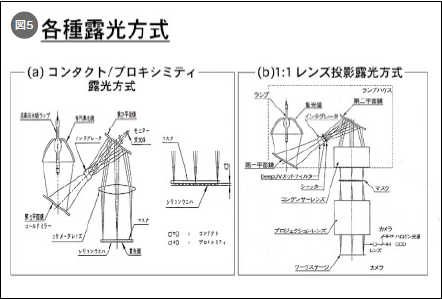
各露光方式の光学系。
「コンタクト/プロキシミティ露光装置」は、マスクとワークを接触または隙間を空けておき、そこにランプからの光を照射し、露光する方式です。レンズによる投影露光方式は、ランプからの光をマスクへ照射し、投影レンズを通して、マスクの像をワークへ投影し露光する方式です。

各露光方式の比較。
比較は、コンタクト方式、プロキシミティ方式、1:1のレンズ光学系を用いた投影露光方式、縮小レンズ光学系を用いた投影露光方式の4つです。
解像力は、コンタクト方式及び縮小レンズ光学系を用いた投影露光方式が良いといえます。
焦点深度は、1:1のレンズ光学系を用いた投影露光方式が深くなります。
深い焦点深度により、反りのあるプリント基盤の露光や、段差露光を行うことができます。
露光面積は、コンタクト/プロキシミティ方式が大面積を露光できます。
フォトマスク寿命は、1:1または縮小レンズ光学系を用いた投影露光方式の方が優位です。
装置コストは、構造が簡単なコンタクト/プロキシミティ方式が安価となります。
重ね合わせ精度は、分割露光を行なう1:1または縮小レンズ光学系を用いた投影露光方式が精度がよいといえます。
弊社の露光装置の実績は、「コンタクト/プロキシミティ露光方式」、「1:1のレンズ光学系を用いた投影露光方式」の一括露光、分割露光で、製作実績があります。
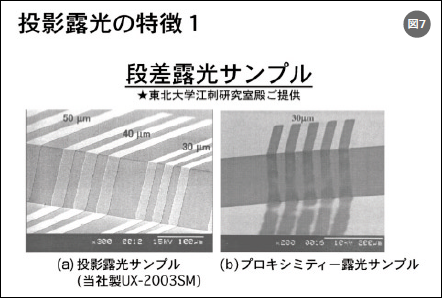
投影露光の特徴の1つとして、焦点深度が深いということがあげられます。写真は、段差のあるワークに露光したサンプルです。100µmの段差に対して、段差の上と下また段差部でも、(a)の投影露光の方がきれいに露光されていることが分かります。
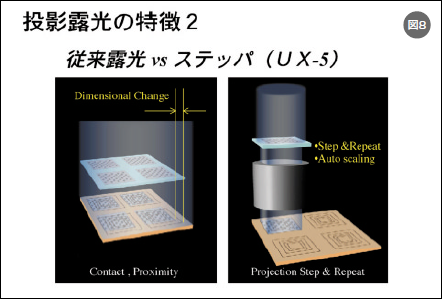
投影露光の特徴の2つ目としては、基板の収縮に対応できるということがあります。プリント基板が伸縮して、マスクとワークが合わなくなった場合に、コンタクト、プロキシミティでは伸縮に対応できません。しかし、分割投影露光であれば、各ショット毎に露光することと、スケーリングを行うことにより、良好な重ね合わせが可能です。

この図は、弊社の投影露光装置のアプリケーションマップです。横軸が露光エリア、縦軸が解像力になります。
半導体のステッパは、解像力が1µm以下のこの領域となります。
弊社の露光装置は、解像力が数µmから20µm程度の領域で、10µm前後の解像力が得られる露光装置を開発しています。
TAB用の露光装置、プリント基板用の露光装置、ウェーハレベルパッケージ等のLSIパッケージ用の露光装置などがあります。

「露光装置」というと、最も知られているのは半導体LSI用ステッパですが、弊社が開発する露光装置は、用途が異なるため、求められる性能も違ってきます。
上の図は、弊社が今まで開発してきた露光装置の仕様と用途を一覧にしたものです。

それでは次に、プリント配線板用ステッパ「UX-53」をご紹介します。

上の図は、弊社のユーザ要求から推定した、サブストレートパターン層線幅のロードマップです。横軸は年単位、縦軸はL/Sのµm単位となっています。
2009年には10µm L/Sの量産対応が求められています。
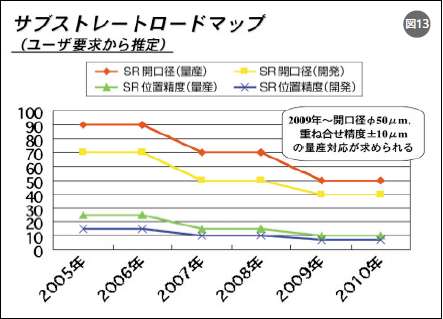
上の図は、ユーザ要求から推定した、サブストレートSR層開口径と位置精度のロードマップです。
SR開口は、2009年にはΦ50µmの量産対応が求められています。
SR層重ね合せは、2009年には±10µmの量産対応が求められています。
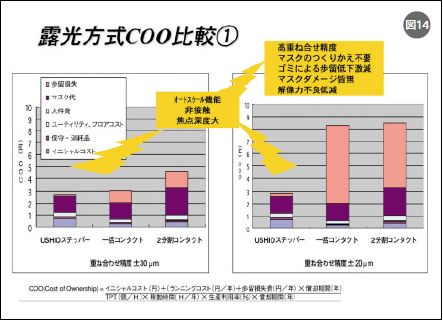
これはウシオステッパ、一括コンタクト、2分割コンタクトのCOOの比較を行ったグラフです。重ね合せ精度が±30µmでは、ステッパと一括コンタクトは同等。重ね合せ±20µmになると、一括コンタクトでは歩留まり損出がかなり多くなり、歩留まりは悪化します。これは、重ね合せ精度が厳しくなると、基板の収縮に対応できない、ゴミによる歩留まり低下による影響です。
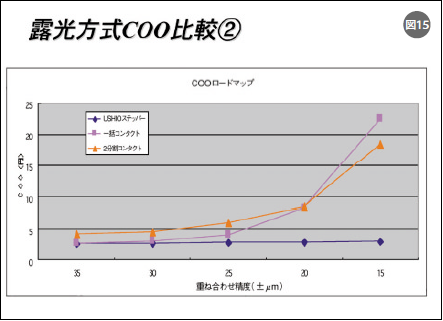
上の図は、重ね合わせ精度を横軸に、COOを縦軸にしたグラフです。
重ね合せ精度が±15µmになると、更に一括コンタクトはCOOが悪化すると予想されます。
それに比べ、弊社ステッパは、重ね合せ精度が±15µmになってもCOOはほとんど悪化しません。

上の図は、コンタクト露光装置とステッパの重ね合わせ精度を比較した結果です。ステッパtoステッパの場合、Ave+3σで6.43となり、Cpk:工程能力指数も1.63と、かなり良い結果が得られています。これは前述のように、オートスケール機能により、プリント基板の伸縮しに対応したアライメント→露光が行われているためです。

上の表は、プリント基板用分割投影露光装置(UX-53シリーズ)の特徴を示したものです。
最大の特徴は、ワークステージにサーフェースステージを採用したことにより、装置重量軽減、スループットの向上、クリーン化、アライメント精度向上を行うことができたことです。

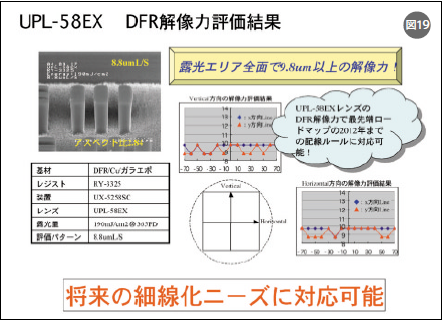
上の図は、配線層に用いるDFR(ドライフィルムレジスト)の解像力評価結果を示したものです。25µm厚さのDFRを用いて、露光エリア全面で、9.8µmの解像力が得られています。
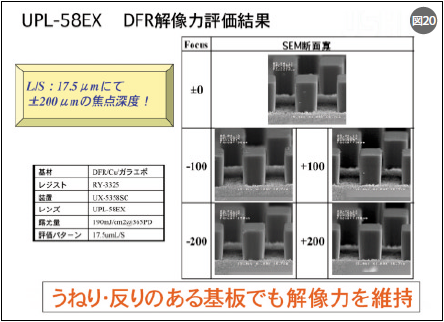
上の図は、同じDFRを用いて、投影レンズの焦点深度を確認した結果を示したものです。焦点深度を±200µm振った状態でも、17.5µmL/Sのレジスト形状に変化がないことが分かります。
深い焦点深度により、うねり・反りのあるプリント基板にも対応可能となります。

上の図は、投影レンズの焦点深度を振っ時の、露光エリア面内の線幅バラツキの評価結果を示したものです。
25µm厚さのDFRを露光し、15.6µmL/Sの線幅バラツキが、焦点深度±50µmで約±1µm以内となっていることが分かります。これも、焦点深度を振っても、線幅が変わらないということなので、プリント基板の反り、うねりに投影露光方式が有効であることがいえます。

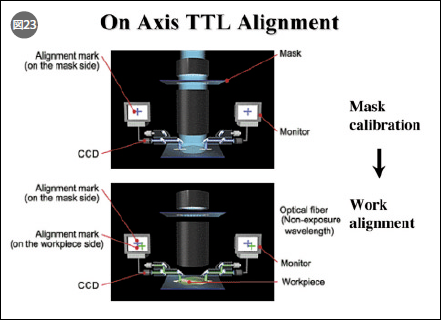
上の図は、On Axis TTLアライメントの方法を示した図です。
はじめに露光光を使って、投影レンズで投影したマスクマークを検出します。次にワーク(基板、ウェーハ)を搬入し、非露光光にてワークマークを検出することにより、ワークのX,Y,θずれ量が分かる。また、スケール量も計算で分かり、X,Y,θ、Zoomを移動させて、マスクとワークのマークを一致させます。

上の図は、アライメントの再現性を評価した結果を示しています。
同一ワークの同一マークを、100回以上アライメントを繰り返したときの再現性は、±0.5µm以内に入っていることが分かります。
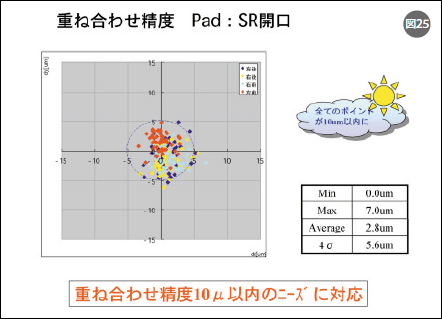
上の図は、プリント基板用分割投影露光装置にて、SR層重ね合わせで、4カメラアライメントを行ったときの、各アライメントマーク部のアライメント精度を示したものです。
4箇所のアライメントマーク部で、18Shot全てが10µm以内に入っていることが分かります。
Ave0+4σで見ても、8.4µmと非常に良い結果が得られています。


上の図は、UX-53シリーズのラインナップの仕様比較を行ったものです。
露光波長がi線、in線、ihg線の投影レンズを搭載した装置があります。
SR用途には、ih線またはihg線で、照度が高いレンズでスループット向上を行うことが出来ます。
DFR用途には、i線またはih線で、解像力の高いレンズでファインパターンに対応が可能です。

上の図もUX-53シリーズのラインナップを示したものです。
この装置は、露光エリアがΦ250mm、Φ320mmと大面積露光を行い、スループット向上を行うことが可能です。


UX-53シリーズで採用した、サーフェスステージの効果を説明しています。
サーフェスステージ採用により、装置重量低減、スループット向上、装置内クリーン化、高重ね合わせ精度を実現しました。
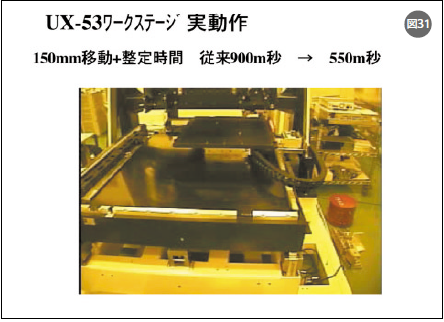
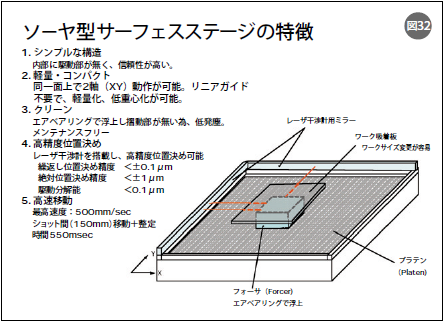
上の図は、ソーヤ型サーフェスステージの特徴を示しています。
シンプルな構造で、リニアガイドを使用しておらず、エアベアリングで浮上しているため軽量で、クリーンなステージになっています。
また、位置決めにはレーザ干渉計を使用しているため、高精度な位置決めが可能です。
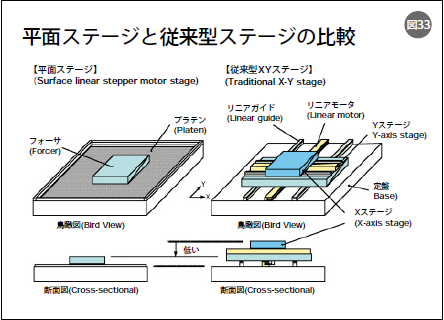
上の図は、サーフェスステージと従来型XYステージの比較を示したものです。
サーフェスステージは従来型に比べると、構造自体が単純で、ステージの重心位置が低いことが分かります。

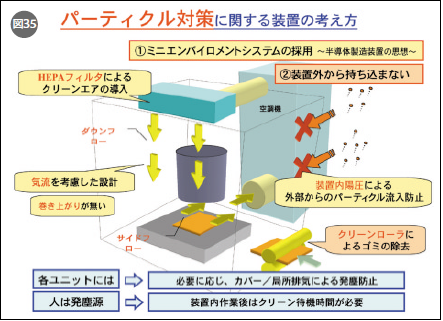
上の図は、パーティクルに対する装置の考え方を示したものです。
装置内を局所的にクリーンにすることにより、装置外環境の影響を受けないようにしています。
装置内陽圧化を行い、装置外からのパーティクルの流入を防いでいます。
また、クリーンローラを附属することにより、基板が装置内にゴミを持ち込むことを防止します。
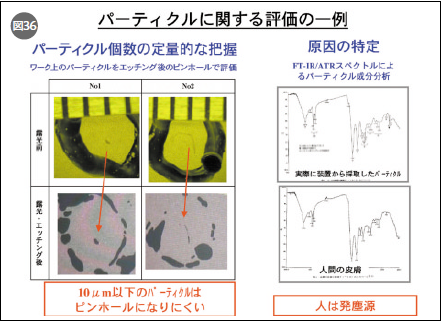
上の図は、装置内のパーティクルの評価を行った例を示しています。
左側は、ワーク上のゴミがどれくらい露光に影響するかを調査したもので、10µm以下のパーティクルはピンホールになりにくい結果が得られました。右側は、FT-IR/ATRスペクトルによるパーティクルの成分分析を行った例です。この例では、装置内から採取したパーティクルは人間の皮膚であることが分かりました。

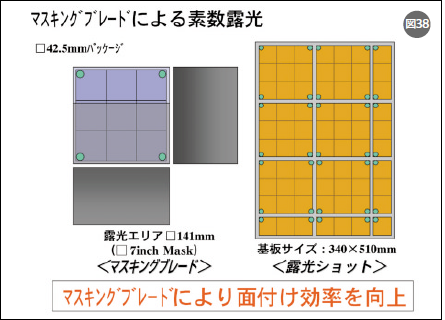
上の図は、マスキングブレードによる素数露光を示したものです。
露光エリア□141mmの場合、□42.5mmのパッケージが、3行x3列の9個配置できます。それを340x510mm基板に露光する場合、基板の右側と、下側は露光エリアがはみ出してしまうため、マスキングブレードを使用し、不要な部分の光は遮蔽して、露光することを素数露光と呼んでいます。通常のShotは4点でアライメントしますが、素数露光の部分は2点or1点アライメントを行います。
この素数露光により、パッケージの取り数が向上します。
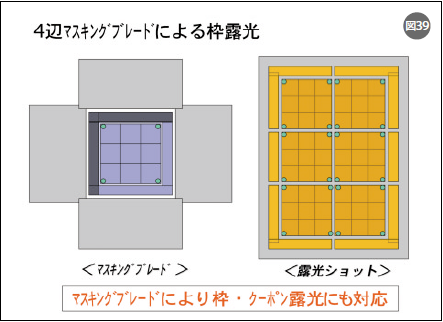
マスキングブレードを4辺にすることにより、枠露光を行うことができます。マスクにあらかじめ、パッケージパターンの周りに枠露光のパターンを4辺に入れておきます。右上のショットを露光するときは、下側と右側のブレードで枠露光パターンを遮蔽した状態で露光を行います。
露光するショットにあわせて、枠露光パターンを遮蔽することにより、基板に対して枠を露光することができます。
また、枠パターンの中に、クーポンを入れることもできます。
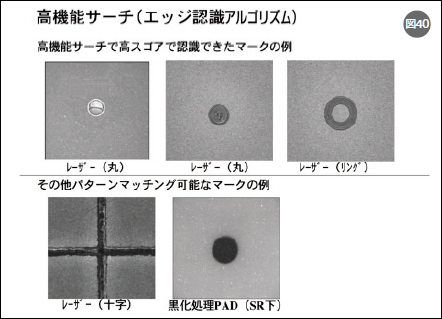
上の図は、プリント基板で使用されるアライメントマークの例です。
レーザで作成した丸穴の上にDFRを張ると、丸穴の中に気泡が入り、マーク検出できないこともあります。
その場合、弊社が開発したエッジ認識のアルゴリズムにより、精度良くマーク検出を行うことができます。
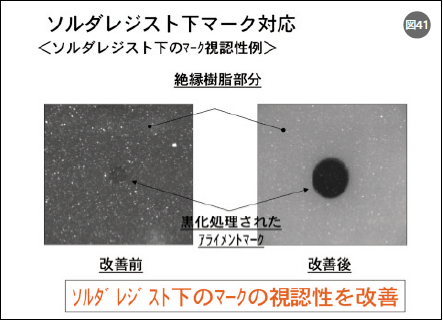
上の図は、ソルダレジストの下にあるマークの認識を改善した例を示しています。
弊社独自の照明方法にて、ソルダレジストの下の視認性の悪いマークを、視認性を向上させることができます。

マスクにIDをバーコードで入れておくことにより、マスクを装置に搭載する際に、バーコードで読み取り、レシピと照合することにより、レシピ選択ミスを防止することができます。
また、マスクバーコードを読み取り、レシピを選択することも可能です。

UX-53のコントロールソフトウェアは、レシピ作成やデータの管理はパソコン上で行い、装置の側のタッチパネルにて、装置のオペレーションを行います。
そのため、上図に示すような特徴があります。


高密度プリント配線板用露光装置の「分割露光の特徴」と、その中でも「ウシオの特徴」を記述しています。
コンセプトは「微細化対応」と「歩留まりUP」です。

UX-5シリーズのウシオの特徴としては、「1.実績と信頼性」、「2.性能、コスト、納期」、「3.開発・技術力」、「4.保有技術・ノウハウ」の、4つの大きな特徴があります。
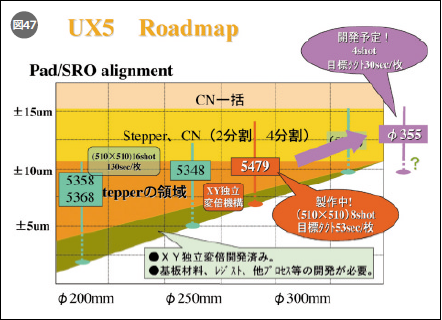
UX-53シリーズのロードマップです。
アライメント精度が±15µm以上では、コンタクト一括の露光装置で何とか生産できていたものが±10µm以下となると、ステッパーの領域となってきます。
そこで、以下に精度を維持したままで、生産生を確保するかが大きな課題となります。
弊社では露光エリアΦ200mm→Φ250mmと開発を行ってきましたが、更にΦ280mmを開発しました。
このあたりから、等方変倍だけでは重ね合せ精度±10µm以下は厳しくなってきており、XYの独立変倍機構の開発を行いました。
これにより、510x510基板を8ショットで露光することができ、スループットも倍以上に早くなります。
更に511x510基板を4ショットで露光できる大口径レンズを開発検討中です。


