光技術情報誌「ライトエッジ」No.29(2007年8月発行)
2006秋季 第67回応用物理学会学術講演会
瞬間熱処理法による
ボトムゲート型TFT用Si薄膜の結晶化
Crystallization of Si thin films for bottom-gate-TFT by Rapid Thermal Annealing
北陸先端科学技術大学院大学1、ウシオ電機2
西崎 昭吾1、大平 圭介1、柄沢 武2、鳥飼 哲哉2、松村 英樹1
Jpn. Adv. Inst. Sci. & Tech. (JAIST), R&D center, Ushio Inc.
S. Nishizaki1 , K. Ohdaira1 , T, Karasawa2 , T, Torikai2 , H, Matsumura1
E-Mail: s-nishi@jaist.ac.jp
はじめに
薄膜トランジスタ(TFT)の性能向上のために、レーザアニールにより作製されるpoly-Siの研究が盛んに行われている。通常作製されるトップゲート型poly-SiTFTは、プリカーサ膜の非晶質Si(a-Si)とゲート絶縁膜を、従来からのボトムゲート型a-Si TFTのように大気暴露することなく連続的に製膜することができない。そこで、ボトムゲート型a-Si TFT構造を保ったまま、瞬間熱処理法により、後からpoly-Si TFTとする方法を我々は検討している。ここでは、図1に示すボトムゲート型構造を瞬間熱処理法によりa-SiのみをpolySi化する際の、絶縁膜中へのCrの拡散、SiNxの電気絶縁性などを調査した。
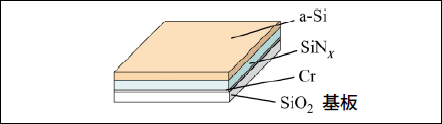
図1. ボトムゲート構造
実験
2x2cmの石英基板上にゲート金属のCrをスパッタ法により製膜後、絶縁膜のSiNxとプリカーサ膜のa-Siを触(Cat-CVD)法により連続製膜した。大気圧のAr雰囲気中において、瞬間熱処理法によりa-Siの結晶化を試みた。ラマン分光法を用いてa-Siの結晶化を評価し、SEMにより表面観察を行った。SiNx中へのCr金属の拡散をRBS法により調査した。併せて、半導体パラメータアナライザを用いて、熱処理前後の絶縁性を評価した。
結果
瞬間熱処理前後のラマン分光法によるスペクトルを図2に示す。熱処理後には、およそ516cm-1から518.5cm-1にSiのTOフォノンピークが確認され、a-Siが結晶化していることが分かる。SEMにより観察した結晶粒は平均150nm程度であった。図3にSiNx200nm、Si400nmの熱処理前後のI-V特性を示す。リーク電流値は熱処理前後で変化しておらず、SiNxの絶縁性が維持されていることが分かる。RBS法により下地電極のCr がSiNx中に拡散していないことが明らかとなり、下地の絶縁膜にダメージを与えることなく表面のa-Siのみを選択的に結晶化できることが分かった。これらの結果は、ボトムゲート型a-Si TFTの構造を保ったまま、瞬間熱処理法により上部のa-Siのみを結晶化できる可能性があることを示している。
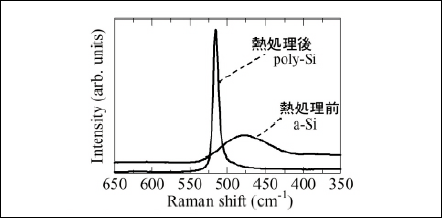
図2. 瞬間熱処理前後のラマンスペクトル
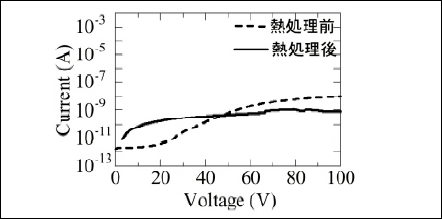
図3. 瞬間熱処理前後のI-V 特性



