光技術情報誌「ライトエッジ」No.29(2007年8月発行)
2006.7 ナノオプティクス研究グループ第15回研究討論会
干渉による露光ムラを低減する
近接場光リソグラフィ用フォトマスク
Photomask for near-field photolithography decreasing exposure irregularity due to interference
鈴木貴之,蕪木清幸,森本幸裕,川添忠*,大津元一*,**
ウシオ電機,科学技術振興機構*,東大工**
Takayuki Suzuki, Kiyoyuki Kabuki, Yukihiro Morimoto, Tadashi Kawazoe*, and Motoichi Ohtsu*,**
Ushio INC, SORST JST*, The University of Tokyo**
Abstract
We have demonstrated a near-field photomask, which decreases exposure irregularity coming from optical interference fringe. The near-field photomask is constructed from a glass substrate including CuCl quantum dots and Cr-shading layers. In the exposure process, the light from Hg-lamp was absorbed by a lot of quantum dots and the photoresist was exposed by the luminescence from the quantum dots. Since the lights coming from different quantum dots lose coherence with each other and each quantum dots disperses in the glass, the interference fringes disappeared on the developed pattern of photoresist, which appeared in the case of a single light source.
1. はじめに
近年の半導体回路の集積化により、リソグラフィにおける光源の短波長化が進んでいる。これは、光の回折によりリソグラフィの加工寸法が制限されるためで、光源波長λと最小の加工寸法Rとの間にはの関係がある。ここでk1はレジストや超解像技術によって決まる値、NAは露光光学系の開口数である。

光源の短波長化により実現されてきた微細加工であるが、それに伴い光源が複雑、高価となっている。また、短波長を扱うための光学素子やマスク、レジストなども新たに開発する必要があるなどコスト面に大きな問題を抱えるようになった。
このような問題に対して光源波長によらず微細加工が可能なリソグラフィ技術として近接場光リソグラフィが提案されている。近接場光リソグラフィでは、回折のない近接場光によってレジストを感光させることにより、従来用いられていたg線(波長436nm)やi線(波長365nm)であっても微細加工を行うことができ、低コストな加工法として研究が進められている。1), 2), 3)
近接場光リソグラフィでは、波長よりも小さな幅を持つ開口に光を照射し、この開口に近接場光を生じさせる。このとき発生する近接場光の強度は開口に入射した光の強度に依存する。したがって開口に入射する光に意図しない強度ムラが生じてしまうと、近接場光強度も意図したものとは異なる分布が生じることになり、フォトマスクに形成したパターンを正確に転写することができなくなってしまう。
このような強度ムラを生じる原因の一つとしてフォトマスク内での光の多重反射による干渉が挙げられる。そこで、干渉を防ぐことができるフォトマスクとしてマスク基板中に量子ドットを含むフォトマスクを考案した。
この量子ドットは光源からの光を吸収し、発光する。また、隣接する量子ドットが発した光も吸収し、発光する。この過程を繰り返し光は光源と反対側の面に放射される。こうして吸収発光を繰り返すことにより、光はコヒーレンスを失い干渉の発生が低減される。
本稿では、この量子ドットを用いた実験について説明する。
2. 実験
2-1. 量子ドットガラス作製
量子ドットガラスの作製には、母材となるガラス材と量子ドットとなるCuClの粉末を混合し、これを電気炉内で加熱した。溶融した試料を冷却し凝固させた後、この試料を研磨により平坦化した。
2-2. 透過率測定
作製した量子ドットガラスの透過率を分光光度計で測定した。
2-3. 露光
光源として高圧水銀ランプ、レジストにはg線用レジストを使用し、マスクとしてシリコン基板に角型の開口を形成したものを用いた。
光源の光をそのままマスクに照射する場合(a)と、量子ドットに光を照射し、この量子ドットからの光をマスクに照射した場合(b)について実験を行った。図1に概略を示す。また、図2に使用した高圧水銀ランプのスペクトルを示す。
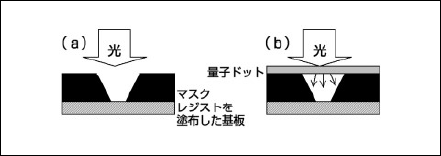
図1 実験概略

図2 高圧水銀ランプスペクトル
2-4. 観察
露光した後、現像処理を行い、表面をAFMを用いて観察した。
3. 結果
作製した量子ドットガラスの透過率スペクトルを図3に示す。g線(436nm)を十分カットすることができることが分かる。
量子ドットなしで露光した試料(a)と量子ドットを介して露光した試料(b)のAFM観察による表面像と矢印部分の断面形状を図4に示す。(a)では干渉によると見られる周期的なパターンが現れているのに対して、(b)ではそのようなパターンが見られていない。このことから、量子ドットの発光を介して露光を行うことによって干渉の発生が低減できたと考えられる。

図3 量子ドットガラス透過率スペクトル

図4 AFMによる観察結果
4. まとめ
量子ドットの発光を介して露光を行うことによって干渉によると見られるパターンが観察されなくなった。このことから量子ドットをマスク基板に用いたフォトマスクを近接場光リソグラフィに用いることで干渉の発生を低減し、正確なパターン転写が期待できる。


