光技術情報誌「ライトエッジ」No.34(2011年3月発行)
月刊オプトロニクス12月号(オプトロニクス社)
(2010年12月)
EUV光源の開発状況
笠間邦彦
技術研究組合 極端紫外線露光システム開発機構
1. はじめに
hp32nm以細のリソグラフィはEUV光(13.5nm)を用いるEUVL(Extreme Ultraviolet Lithography : 極端紫外線露光)技術が最有力候補である。しかしながらEUVマスクインフラ準備、EUV光源およびEUVレジストのRLSトレードオフなどの課題があり、当初、2012年頃と想定されていたデバイス適用が遅延しているのが現状である。そのため、ArF液浸のダブルパターニング(DPT)の適用が検討されているが、Pitch-Splitting-DPTでは特に位置精度が厳しく、またSpacer-DPTでは工程数が長い。いずれのDPT手法も、長TATでコスト増を招くため、解像性が優れシングル露光であるEUV露光に期待する声が高まっている。
EUVAでは、EUV露光の最も重大な課題の1つである光源の開発に注力し、2つの光源方式LPP(Laser Produced Plasma)(担当;平塚研究室(コマツ、ギガフォトン参加))とLA-DPP(Laser Assist Discharge Produced Plasma)(担当;御殿場研究室(ウシオ、XTREME参加))の併行開発を進めている。その他の開発拠点としては、米国Cymer社がLPP光源の開発を行っている。ここでは、LPPおよびLA-DPPそれぞれの光源開発の現状について報告する。
2. LPPおよびLA-DPP光源の特徴と要求性能
図1(a)にLPP光源(、b)にLA-DPP光源の概念図を示した。LPP光源は高繰り返し(50~100kHz)CO2ドライバレーザをSnドロプレットに照射し、そこで得られたプラズマからのEUV光を大口径Mo/Si多層膜コレクタで集光する。中間集光点(Intermediate Focus;IF)から先は露光光学系であり、光源の強度等の諸性能はIF点で評価される。LPP光源の高出力化はCO2レーザの高出力化とプリパルス・プロセスによって進められている。ここでプリパルス・プロセスとは、YAGレーザなどのレーザ照射によりSnドロプレットを細かなSn粒子に破砕してから、メインのCO2レーザを照射する手法である。1)微細Sn粒子にすることで、CO2レーザの吸収効率が向上し、またプラズマが比較的低密度になりEUV光の再吸収が低減するため、EUV発生効率(CE;ConversionEfficiency)の向上やデブリ発生の低減を図ることができる。
一方、LA-DPPは回転電極をSn熱浴に浸してSn薄膜を電極に形成し、それにトリガーレーザを照射してプラズマ放電(ピンチ放電)を発生させ(~30kHz)、そこで生じたEUV光を多数枚シェルからなる斜入射コレクタで集光する方法である。2)回転電極上のSn膜のみがプラズマ生成に関与するため、固定電極DPP方式で生じた電極磨耗の問題は解消されている。またレーザをプラズマトリガとするため特別なパルス発生電源回路も必要ない。LA-DPPの高出力化は、後述のように主に繰り返し周波数の増大とトリガーレーザの最適化によって行われている。
表1に、露光装置メーカから要求されている光源仕様を示す。3)露光スループット、100ウェハ/時間を達成するには、IF点出力200Wが必要とされる(レジスト感度10mJ/cm2)。積算ドーズ安定性は+/-0.2%、光源が及ぼす 露 光 光 学 系 への汚 染・損 傷の問 題が 無 いこと(30,000時間の積算露光時間で、10%以下のマスク・ミラー反射率低下。通常の稼働では、10年程度の露光光学系の寿命に相当)、また、Out-of-Band(13.5nm光以外の光)もレジスト感光、熱発生の影響を考慮して、表の様に規定されている。なお、露光光学系のMo/Si多層膜ミラーの反射率を考慮して、IF点におけるOoB強度も表に追加した。
LPP光源ではCO2レーザの散乱による10.6µm波長のOoB光を低減するためSPF(Spectral Purity Filter)をIF点前後に設置する。Cymer社は、SPF設置により35%、ドーズコントロールにより20%、トータルでは48%のEUV光が減衰すると報告している。4)SPF 設置無しでの出力をRaw出力、またSPFを設置して露光可能な状況でのEUV出力をExposure出力と区別している。LA-DPPではSPFは不要で、ドーズコントロールしても出力低下は無いとしている。
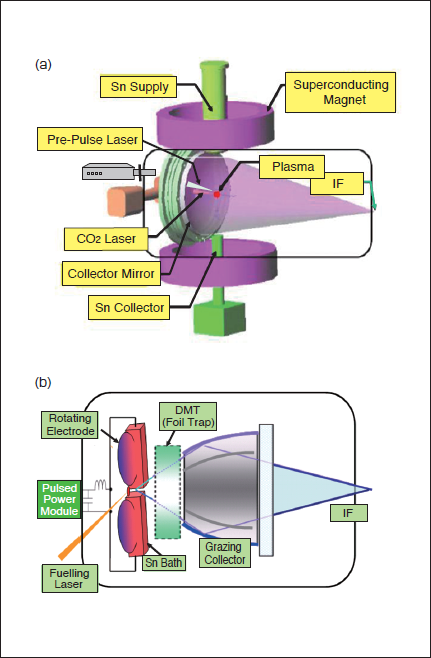
図1. (a)LPP(Laser Produced Plasma)光源の概念図,(b)LA-DPP(Laser Assist Discharge Produced Plasma)光源の概念図

表1. EUV光源の要求性能
(露光装置メーカからのJoint Requirements)
3. LPP光源の開発状況
LPP光源の課題として、① CO2レーザの高出力化(20kW)&高Duty cycle化(>75%)、② Snドロプレットの小径化(<30µmφ)、位置ドリフトの低減およびプレパルス化、③大口径コレクタミラーの熱対策、そして④プラズマから発生するデブリ対策、が挙げられる。
図2に現在、開発に用いている実験光源(ETS 装置;CO2レーザとEUV発光チャンバからなる)、表2にETS装置を用いた開発状況をまとめた。発光点出力から求めたIF点出力(Raw)は、25W(2009年EUVLシンポジウム,プラハ)から、69W(2010年SPIE、サンノゼ)、そして104W(2010年4月プレス発表、10月EUVLシンポジウム、神戸)と向上している(Duty cycle 20%)。5)この出力向上は、主にCO2レーザの出力向上(5kWから7.9kW)、プレパルスプロセス採用によるCEの向上(1.5%から2.5%)による。
図3に磁場印加によるSnイオンの除去効果を示す。超伝導磁場の磁力線方向に垂直な位置に置かれたファラディカップ(位置;H方向52.5度、V方向30度)により、Snイオンを観測したところ、磁場無しの場合に観測されたSnイオンが磁場印加により全く検出されないことがわかる。プラズマから発生するデブリとしては、Snイオン以外に中性Sn粒子が考えられるが、この中性粒子に起因するSn膜堆積に対しては、必要最小質量のSnドロプレットの採用により、出来るだけ発生するデブリを減らすとともに、堆積したSn膜をIn-situでガス・クリーニングする方針である。既に、充分なSn堆積膜のエッチング速度が得られており、このクリーニング機構を実際のEUV発光チャンバに組み込む検討が進められている。
一方、Cymer社は、10月のEUVLシンポジウムにおいて、HVM1と呼ばれるβ光源を用いて、10~15W@IF(Exposure)、Duty cycle 10~40%で稼働試験を行っていると報告している(プリパルス無し)。6)更に、プリパルスとCO2レーザ高出力化により、Duty cycle 1%と低いものの、175W@IF(Raw)~80W@IF(Exposure)のEUV出力が得られたと発表している(CE 3%)。
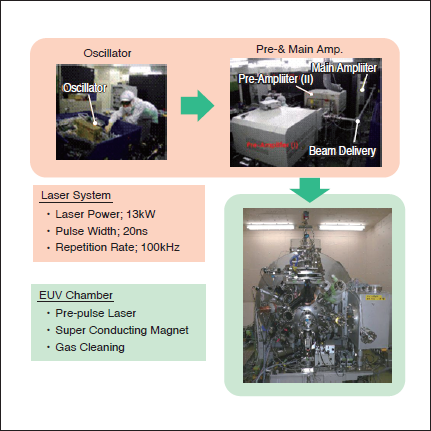
図2 LPP-ETS 実験装置
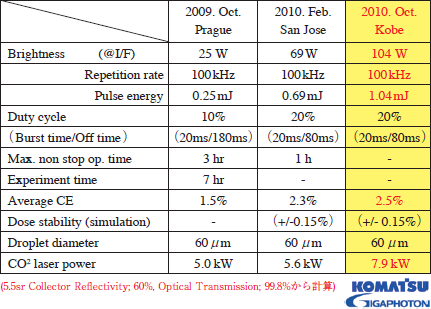
表2. LPP-ETS実験装置によるEUV出力性能
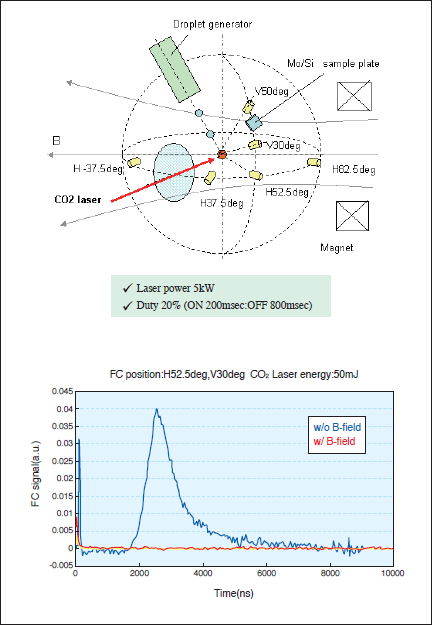
図3. 磁場印加によるSnイオンの除去
4. LA-DPP光源の開発状況
LA-DPP光源は、ASML社製ADT(α-Demo-Tool)露光装置に搭載されており、低出力(5~8W@IF)ではあるが、実際のプロセス開発、デバイス試作に使用されている。また、図4に示すβ光源が昨年のEUVLシンポジウムで報告された(発光点出力420W/2π・sr)。7)このβ光源を使って、発光点出力640W/2π・sr、CE 2.13%、Duty cycle 100%(連続発光)で、IF点出力14.7W@IF(Exposure)を実測したことを、今回のEUVLシンポジウムで発表した。8)今後、斜入射コレクタなどの改善が進み、集光率の向上が図れれば51W@IF(Exposure)が見込めるとしている。またデブリ対策としてDMT(DebrisMitigation Tool)とバッファガスを用いることによってコレクタ寿命>1年と見積もられている。現在、更なる高出力化に向けて、①回転電極への均一Sn薄膜塗布、②Sn熱浴の恒温制御、③トリガーレーザ最適化、④コレクタ捕集効率向上および⑤デブリ対策、を検討中である。高出力化は、パルス強度はあまり強くせず、主に繰り返し周波数を増大(~30kHz)させることによって進める方針である。また、トリガーレーザの工夫により、ピンチ放電プラズマを微小で高密度にでき、これによりCEの向上と高速Snイオンの発生を減少すると共に、CEの向上を図ることができる(汚染、およびコレクタ表面のスパッタの低減)。表3にLA-DPPの稼動試験の結果をまとめた。

図4. LA-DPPβ光源

表3. LA-DPP β光源によるEUV出力性能

図5. LA-DPPβ光源のEUV出力(Duty Cycle 100%、Input Power 30kW, CE 2.13%)
5. 光源ベンチマーク
2010年10月のEUVLシンポジウムにおいて報告されたEUV光源特性を表4にまとめた。要求出力200W@IF(Exposure)に対して、現状出力は10~15Wレベルに留まっている。また長期安定稼働の実績も不充分で、今後、高出力下での熱対策、およびデブリ対策の有効性確認など、多くの課題が残されている。しかしながら、両光源とも、高出力化、長期信頼性に対する開発方針は明確になっており、HVM露光装置の開発スケジュールに整合する開発促進を期待したい。
本研究の一部はNEDOの委託により実施されました。EUVAプロジェクト推進にあたり、経産省、NEDOからの多大なご支援に深謝いたします。
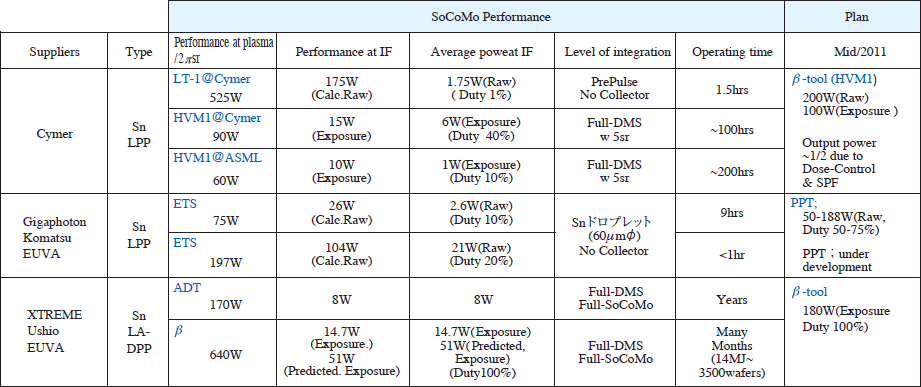
表4. EUV光源のベンチマーキング(EUVシンポジウム、2010年10月神戸)



