光技術情報誌「ライトエッジ」No.24(2002年4月発行)
マイクロマシン/MEMS 徹底解剖セミナー
●マイクロマシン/MEMSの設計・製造技術とそのツール
(2001年10月)
マイクロマシン/MEMS用
露光技術と装置
ウシオ電機株式会社システム事業部
プロジェクト 推進室
住谷 正人
センサや回路あるいはアクチュエータのような異なる要素をシリコン基板上に集積化し、小型ながら複雑かつ高度な働きをするシステムを、米国ではMEMS(Micro Electro Mechical System)、日本ではマイクロマシンと呼ぶ。このマイクロマシン加工における基本技術の1つが露光技術である。
ここでは、まずマイクロマシンの露光技術における要素について考え、次に各種露光方式の特徴と問題点について考察する。最後にマイクロマシン用露光装置として大面積一括投影方式を中心とした当社の露光装置の特徴についてご紹介する。
1.マイクロマシンと露光技術
マイクロマシンは、80年代後半から学会を中心に研究開発が進み、既に圧力センサー・加速度センサー・マイクロジャイロ等のデバイスが実用化されている。最近では、光スイッチなどの光デバイス・高周波デバイス(RF-MEMS)・バイオ関連等においても応用が期待され、またシステムLSI製造においてセンサ・アクチュエータなどの個別部品を1チップ化する技術への適応も注目されている。このようにマイクロマシン技術は半導体製造技術とも融合し、その応用範囲が急速に拡大している。
これらマイクロマシン加工の特徴は「立体的な微細加工」を行う点である。また片面に回路パターン、その反対面にアクチュエータを形成するなどの「両面加工」もその特徴と言える。そして、これらマイクロマシン加工の基本となるのは露光技術である。以下にマイクロマシン加工における露光技術の要素について考えてみたい。
その代表的な要素は、「高アスペクト比露光」と「段差露光」である。これらは、立体的な加工を特徴とするマイクロマシンにとって重要なポイントであり、これら要素が露光方式選定の基準ともなる。また通常の両面加工時には、裏面に設けられたアライメントマークを用いて表面に露光するパターンの位置合わせを行う「裏面アライメント露光」が行われる。更に必要に応じ表裏面に露光するパターン同志を予め位置合わせし両面を同時に露光する「両面同時露光」も行われており、露光現像工程の半減により生産性の向上につながっている。これらの「裏面アライメント露光」「両面同時露光」もマイクロマシン露光技術の大切な要素である。

表1 マイクロマシン技術の応用例

表2 露光技術要素
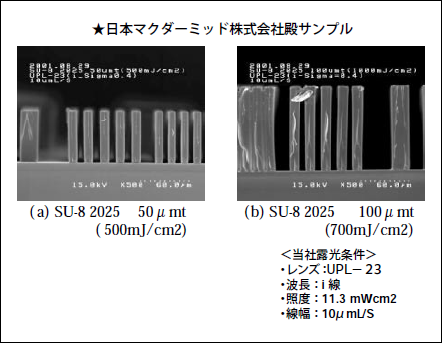
図1 高アスペクト比露光サンプル
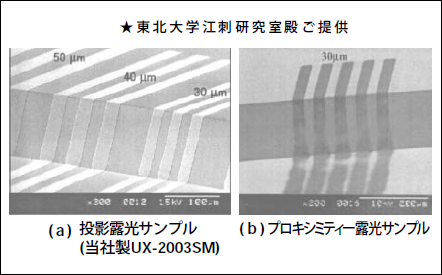
図2 段差露光サンプル
2.各種露光方式の特徴と問題点
露光装置はその露光方式によって、コンタクト/プロキシミティー露光装置、一括投影露光装置および分割投影露光装置に分類される。露光装置の性能(解像性能・重ね合わせ性能)や生産性(処理能力・装置コスト)は、これらの露光方式によって大きく左右される。
コンタクト/プロキシミティー露光方式はマイクロマシン加工に最も多く用いられている露光方式であろう。使用される理由は装置の導入コストの低さと維持メンテナンス性の良さである。しかし、コンタクト/プロキシミティー露光方式は、マスク・ワークの接触によるマスクダメージ・ワーク欠損の発生が問題となる。また段差があるワークへの露光では解像性能にも問題が生じてくる。
一括投影露光方式では上記問題を回避できる。マスクのダメージは無く、深い焦点深度で段差露光に有効である。しかし投影レンズの歪が重ね合せ性能を低下させる。現状、実用的な重ね合せ精度はおおよそ±2µm程度である。また投影レンズの解像力と露光エリアの大きさ・使用波長領域幅は反比例の関係にある。一括投影露光方式の選択では解像力・歪、露光エリア・露光波長など適切な投影レンズ仕様の選択がポイントとなる。
一方、分割投影露光方式は一括の露光エリアは小さいが高解像・低歪の投影レンズが搭載され高精度なステージとともに解像性能・重ね合わせ性能どちらも高い基本性能を備えている。
しかし一般に裏面アライメント機能がなく、また装置価格も高価なため、現状その使用例は多くない。それでも今後は、システムLSI製造など半導体製造技術の融合とともに、その高い基本性能をいかした使用例が増えるものと予想される。
上記のように、各種露光方式にはそれぞれ一長一短がある。その選択は、実際の露光工程に要求される要素・性能と各露光方式の特徴をよく理解し行う必要がある。
尚、いずれの露光方式においても要求に見合う適切な「解像性能」「重ね合わせ(アライメント)性能」そして「生産性」が露光装置選定の基準性能となる。

図3 露光方式一覧

表3 露光方式比較一覧
3.当社の大面積一括投影露光装置
ウシオ電機は1986年からTABテープ用露光装置の設計製作を開始し、現在は各種電子部品用を中心にプリント基板・Siウエーハ・ガラス基板・ロールワークなど多様なワークに対応した露光装置を手がけている。コンタクト/プロキシミティー露光装置、一括投影露光装置、分割投影露光装置の各種露光方式をラインナップしているが、中でもマスクダメージのない投影露光方式を採用した一括もしくは分割投影露光装置がその中心である。
マイクロマシン加工用としては、裏面アライメント・両面同時露光機能を選択可能な一括投影露光装置が中心となる。搭載される投影レンズは多くのバリエーションを持つが、総じて1倍のテレセントリックレンズであり、極端な高NAは求めずに最大8インチ一括露光が可能な大面積露光エリアと高精度組立技術による低歪を特徴としている。投影露光方式の特徴をいかし、深い焦点深度により「高アスペクト比露光」「段差露光」に対応。広い露光エリアによる高い生産性も含めて、マイクロマシン加工に適した露光装置であると自負している。
尚、アライメント方式は裏面アライメント・両面同時露光にも対応した独自のTTL On Axis方式を採用、専用のマークを必要とせずに高精度なアライメントを実現している。
更に当社では、厚膜・高アスペクト比露光プロセスに効果的な「露光波長選択」技術、温度他で伸縮するワーク材料の使用時でも高精度な重ね合わせを実現する「オートスケール機能」、投影レンズのNAを変更可能とし解像性能優先と焦点深度優先を使い分ける「NA可変機能」らも実現しており、応用範囲の拡大による露光技術要素の多様化に対応しているまた今後の高精度なニーズに対応すべく分割投影露光方式への取り組みも開始している。

図4 当社の露光装置

図5 解像力・焦点深度
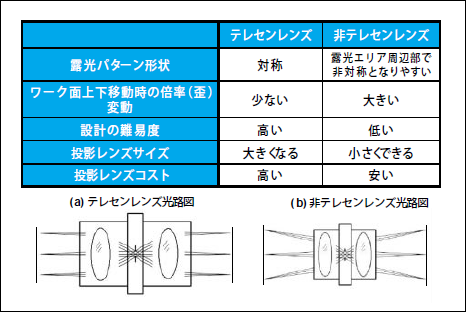
図6 テレセン・非テレセンレンズ比較
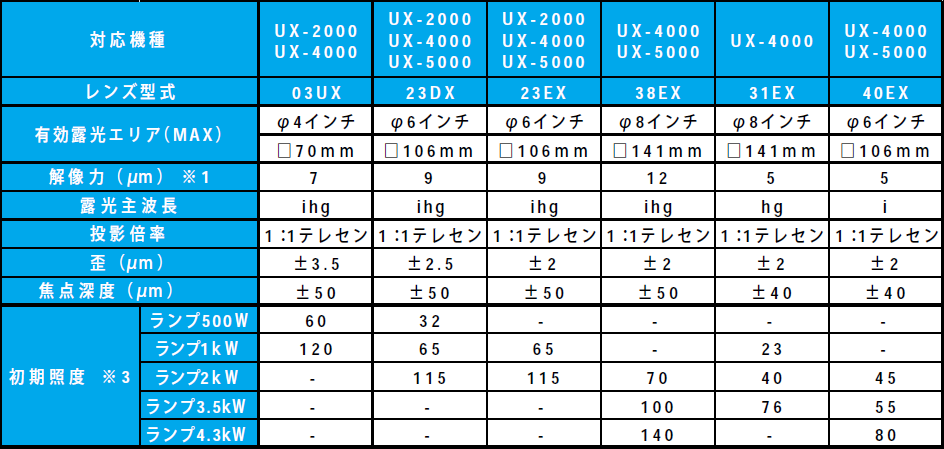
表4 投影露光レンズ性能一覧

図7 オートスケール機能・NA可変機能
4.まとめ
上記1で露光技術の要素について述べた。当社では、これら要素の中でも「段差露光」と「裏面アライメント露光」がマイクロマシン露光技術における最も重要な要素と認識している。
そしてこの要素を実現するための最適な露光方式が一括投影露光方式と考える。
「裏面アライメント機能付一括投影露光装置」。マイクロマシン露光技術に対する当社からの提案である。

図8 まとめ



