光技術情報誌「ライトエッジ」No.26(2003年8月発行)
マイクロエレクトロニクスショー
(2003年4月)
半導体先端パッケージ用ステッパ
「UX-7シリーズ」製品のご案内
ウシオ電機株式会社 プロジェクト推進室
住谷 正人
1. 半導体と実装基板の差を埋める「10µmの技術」
昨今、LSIのデザインルールは0.1µmL/Sの領域に入ろうとしている。一方、LSIの性能に大きな影響を及ぼすパッケージや実装工程は依然100µmL/S前後の技術が支配的である。両者のデザインに大きなギャップがあることにより、「LSIの高速化が十分生かされない」、「機器の小型化が進まない」といった問題が顕在化している。
これらの問題を解決するために、今後はデザインルール10µm前後の配線・接続技術が不可欠になると考えられられている。いわゆる「スーパーコネクト」と呼ばれる領域である。この領域の技術を利用したウェハ・レベル・パッケージ(WLP)やフリップチップBGA、システム・イン・パッケージ(SiP)など、新しいパッケージ手法の採用が今後急激に増加すると予測されている。これらのパッケージ工程では「再配線層」や「バンプ」の形成に10µmL/S程度のパターニングが行われるが、このプロセスに最適化された露光装置が無いのが実状である。このニーズに応えて開発されたのが、「UX-7シリーズ」である。当社では昨年12月に販売を開始した。
2. 先端パッケージに最適化したステッパ
UX-7シリーズは、従来半導体製造の露光プロセスで使用されているステッパと同じ逐次露光方式の投影露光装置だが、先端パッケージ工程に最適化し、COOを大幅に低減した。
一般的に露光方式は、ステッパ方式とプロキシミティ方式の2種類がある。前者は最先端の微細化を追求した非常に高精度で高価格な装置であるため、低コスト、低COOという点で不満が大きい。また、高NAレンズは焦点深度が浅くなるため、厚膜プロセスや、露光面に段差のあるプロセスには不向きである。一方、後者はマスクコスト、マスクのダメージ、アライメントの自由度などで量産性に問題がある。
UX-7シリーズは前者のステッパの領域に属する装置であるが、解像力(NA)、焦点深度、重ね合せ精度を、デザインルール10µmのプロセスに最適化した。広い露光エリア、高照度、マスクコストの軽減により、従来ステッパやプロキミティ露光装置に比較しCOOを大幅に低減した。
以下にUX-7シリーズの特長を記す。
- ●高スループット
最大Φ300mmのウェハに、1ショット最大□45mm(Φ64mm内接する任意な角)で分割露光を行う。1ショットで前工程に使用されるステッパの4ショット、スキャナの2ショット分をカバーでき、高出力ランプを搭載することにより、高スループットを実現できる。 - ●深い焦点深度
解像力3µm(1µmtポジ液状レジストにて)、倍率1:1のテレセントリック投影レンズを使用している。焦点深度は±10µmを持っている。これにより、絶縁膜の開口、再配置、ポスト、保護層、バンピングなど、先端パッケージに必要な一通りの工程を網羅できる。 - ●高精度重ね合わせ
レーザ干渉計付きステージを搭載し、重ね合せ精度±1µm(3σ)を保証している。 - ●マスキングブレード機構によるマスクコスト削減
1枚のマスクを4つフィールドに分割して使用できる、マスクスライド機構+マスキングブレード機構を装備している。1枚のマスクで複数のレイヤーをカバーできるため、マスクコストが大幅に削減できる。 - ●Job作成支援ソフトを提供
ショットマップの作成、マスクデザインへの展開を容易にするため、Job作成支援ソフトを提供する。これにより、前工程のウェハ受領から生産に入るまでの期間を短縮する。
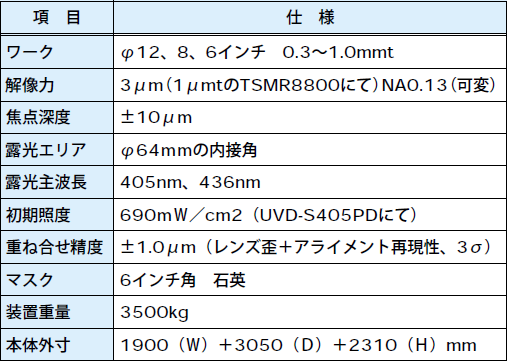
UX-7シリーズの主な仕様
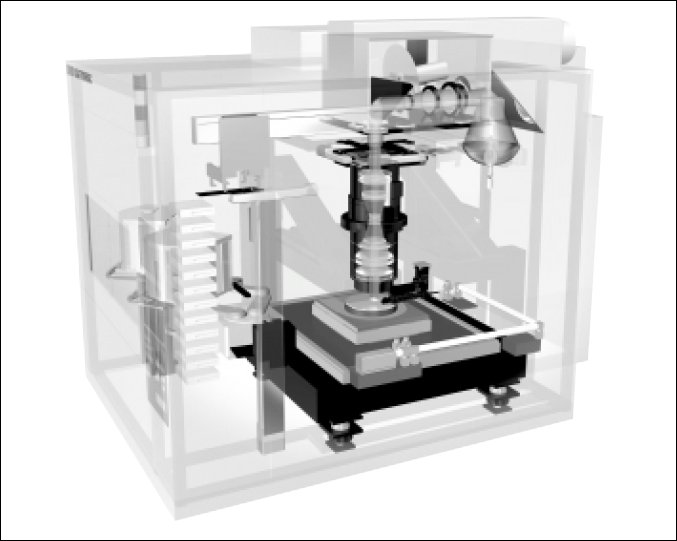
UX-7シリーズの外観
3. 今後の展開
今後、IT機器の軽薄短小・高速化が進めば、「10µm」のニーズはさらに拡大すると予想される。当社は、同じ「10µm」市場をターゲットとして、すでにTAB露光装置、プリント基板用分割投影露光装置を市場展開しており、今回、UX-7シリーズが加わったことにより、次世代の高密度実装技術にLSI、実装基板の双方からアプローチする形が整った。
さらに、同レベルの技術はMEMSやバイオテクノロジーなどの新しい分野にも展開すると考えられ、これらのニーズにも応えて行きたい。



