光技術情報誌「ライトエッジ」No.26(2003年8月発行)
第6回 SEMI マイクロシステム/MEMSセミナー
(2002年12月)
大面積投影露光装置
ウシオ電機株式会社 システム事業部
第2技術部第2課 川橋 孝司
はじめに
マイクロマシン加工における基本技術の1つに露光技術がある。弊社ではこの露光装置を製造している。露光装置には大きく分けてプロキシミティー/コンタクト露光装置、大面積一括投影露光装置および分割投影露光装置がある。また露光工程は両面同時露光と裏面アライメント露光があり各々の工程が可能な装置が実用化されている。
マイクロマシン加工用露光装置の方式選択は各工程で要求される課題と露光方式の特長を見極めて行う必要がある。
弊社の投影露光装置には両面同時投影露光装置と裏面アライメント機能付き投影露光装置があり、使用している投影レンズは小NAで有効露光口径を大きく取ったタイプが多い。従って焦点深度が深く段差やスロープが有るワークでも良好にパターニングする事が可能である。また、ワークと非接触であることから特にダメージが発生しやすいワークへの適用が可能である。
両面同時投影露光装置はその生産性の高さと両面合わせ精度からマイクロマシン用途だけでなくパワートランジスタなどの両面デバイスにも適用されている。
ここではマイクロマシンと投影露光技術の関係についてプロキシミティー露光装置と比較しながら述べる。
1. 露光装置の種類と比較
露光装置はその露光方式によって、プロキシミティー露光装置、一括投影露光装置および分割投影露光装置に分ける事ができる。
プロキシミティー露光装置はマイクロマシン加工に最も多く用いられている露光装置である。使用される理由は初期導入コストと維持メンテナンス性の良さである。しかし、プロキシミティー露光装置はマスク欠損、ワーク欠損の発生が予測される。特に段差があるワークの段差底面に露光するような場合は解像力も含め問題が顕在化する。
また一括投影露光装置を選択した場合、焦点深度が深いことから上記問題は回避され、さらに、ワークの非接触露光が可能であるが、投影レンズの歪が総合重ね合せ精度を低下させる。この場合の実用的な総合重ね合せ精度はΦ150mm程度でおおよそ±2µm程度である。
一方、分割投影露光装置の場合は解像力、重ね合せ精度は問題となることは少ないが、装置価格が高いことと、解像力を優先することから焦点深度が浅くなってしまうことが挙げられる。
2. 投影露光機の種類
マイクロマシンでは両面に露光でパターニングを行うことがある。この場合、選択されるものに裏面アライメント方式及び両面同時露光方式がある。裏面アライメントは片面に設けられたアライメントマークを使って反対面にパターニングする工程である。
2-1. 裏面アライメント露光装置
マイクロマシンの場合は片面に分割投影露光装置などでLSI回路を形成し反対面にアクチュエータを実装するような場合がある。このような場合は予め裏面に設けられたアライメントマークを使って表面に露光されるパターンとの位置合わせを行い露光する方式が必要となる。このようなアライメント方法を裏面アライメントと呼んでいる。アライメントはワーク吸着面の下に設置されている裏面顕微鏡でマーク位置を計測することから始まる。概略の手順を以下に述べる。まずワーク搬入前にマスクのアライメントマーク位置を裏面に設けられた顕微鏡で計測する。この時、主光学系は露光光を放射する。次に露光光を遮断し処理ワークを装置に搬入する。その後裏面顕微鏡から非露光波長を照明し、ワーク裏面のアライメントマーク位置を計測する。偏差分だけワークステージを移動し位置合わせを行う。位置合わせが完了したらワーク厚み分ワークステージをZ移動し表面に主光学系の焦点位置を合わせた状態でパターニングします。
従来のプロキシミティー/コンタクト法ではアライメント完了時のマスク・ワーク位置関係が露光時の接触により変化したり、マスク面とワーク裏面のアライメントマーク位置(Z位置)の差が顕微鏡焦点深度範囲を外れてしまうため顕微鏡の駆動部に高精度Zステージを設けるなどの工夫が必要であった。これに対し投影露光方式の場合、マスクとワークが完全に非接触であるため、これらの問題は原理的に解消できる。

図1 裏面アライメント露光装置の構成
2-2. 両面同時露光装置
両面同時投影露光装置は投影レンズとマスクがワークの両面におのおの配置されている。両面露光のメリットは露光現像の工程数が片面の場合の約半分になることです。また、プロキシミティーの場合、上下マスク間の間隙が少ないため、ワークハンドリングが困難であるが、投影露光の場合これを解消できる。実際にはパワートランジスタのパターニングや水晶振動子の加工、インクジェットプリンタヘッド加工などに用いられている。
両面同時露光装置の場合、装置の構成上(主光学系のパスが長い)最大有効口径は6インチ程度が現実的な限界と考える。
次に具体的な動作を以下に述べる。アライメントは上下のマスク間およびマスクとワーク間で行う。マスク間のアライメントは以下の手順で行う。マスクが上下にセットされた状態で主光学系の下照明系から露光光を放出する。マスク間アライメント位置検出系は上マスク上に配置されている。弊社装置で使用している投影レンズは両テレセントリックタイプである。従ってマスク間アライメント位置検出顕微鏡には下マスクと上マスクのアライメントマークが同時に映し出される。計測結果を元に上マスクを移動しマスク間アライメントを完了する。
次にワークとマスクの位置合わせを行う。マスワークアライメント検出系はワーク上に配置されている。ワークが搬入される前に下側主光学系から露光光を照射しる。この状態で下マスクのアライメントマーク位置を計測する。露光光を遮断しワークを搬入する。上主光学系のZ位置をワーク厚み分Z移動する。この状態でマスクワークアライメント検出系から非露光光の光を導入しワークマークの位置を検出する。その後ワーク位置を移動して上下マスクとワークの位置合わせを完了する。
プロキシミティー方式で両面同時露光を行う場合、ワークと上下マスクの保持の問題からワークの位置合わせが出来なかった。しかし投影露光の場合はマスクとワークの保持は物理的に分離する事が出来る。この為上下のマスクに対して正確にワークのみを位置合わせする事が可能となる。

図2 両面同時露光装置の構成
3. 重ね合せ精度
3-1. オンアクシスTTL非露光波長アライメント方式
解像力が要求されないような投影露光系では露光波長と非露光波長(アライメント波長)の2波長で収差補正を行っている。しかし大口径化や高解像力の要求に従い2波長での補正設計がレンズ性能を低下させてしまうようになってきた。この為従来は露光波長をアライメント光に使う方式を採用していた。この方式は露光波長をアライメントマーク周辺に部分照明しアライメントする方法である。この為アライメントマーク周辺のパターンはアライメント時の照明光により露光されてしまう。これに対しオンアクシスTTL非露光波長アライメント方式は非露光波長光でアライメントする事が出来ます。
また、この方法はマスクマークとワークマークを各々単独で検出できる方式である。従って、従来マスク越しにワークマークの検出が出来ないような場合でもオートアライメントが可能となる。
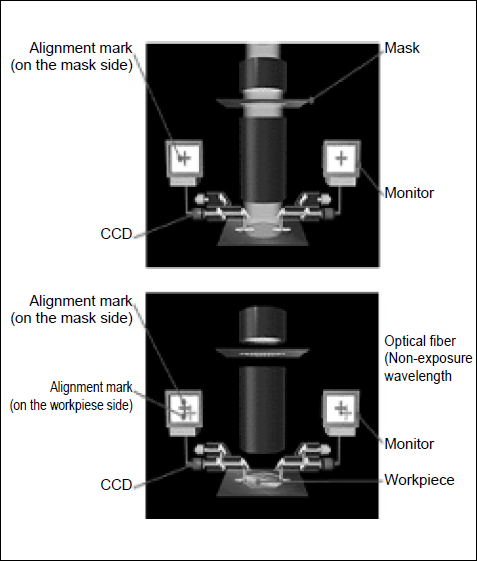
図3 アライメント
3-2. 重ね合せ精度
高精度の重ね合わせ露光を行なう際に問題になるのが、ワーク伸縮による重ね合せ時の位置ずれがある。一般的にはマスク補正等で対応しているが、弊社ではこれに対応する方法にオートスケール機能がある。ワークアライメントマークのピッチを自動計測し、マスクマークピッチと比較することで最適投影倍率を算出し、補正後露光します。ただし、投影露光にはレンズ歪(±1~2µm)があるため、より高精度(±1µm以下)の重ね合わせが必要な場合はレンズ歪の影響が少ない分割投影露光装置またはプロキシミティー露光装置を選択する方法があります。
4. 投影レンズ
弊社露光装置に使用されている投影レンズは有効口径がΦ100~200mmまである。また、分割投影露光用に低歪、高解像力レンズの開発も行った。有効口径Φ64mm、解像力3µm、レンズ歪0.6µmである。
まとめ
マイクロマシン加工における各種露光方式にはそれぞれ一長一短がある。その選択は、実際の露光工程に要求される要素・性能と各露光方式の特徴をよく理解したうえで総合的な判断が必要となる。
また、露光装置選定には「解像性能」「重ね合わせ性能」「生産性」「コスト」を充分考慮し行なうことが重要である。



