光技術情報誌「ライトエッジ」No.30 (2008年3月発行)
究極の「光」、次世代半導体の実現へ
究極の「光」、次世代半導体の実現へ
[回路線幅45nmを切り、さらに、その先の30~10nm台を目指す―いま、半導体製造技術の最先端では、波長13.5nmの「EUV※1」を用いた新しい露光技術が注目を集め、大きな期待が寄せられています。
この露光技術は、次世代半導体の実現に最も有効で効率の高い技術と位置付けられ、日本の「EUVA※2」が国家プロジェクトとして、総力をあげて早期の実用化に取り組んでいます。
ウシオは、半導体の露光用光源のトップメーカーとして、2002年の「EUVA」発足以来、このプロジェクトに参画し、露光技術の核となるEUV光源の開発を担当しています。本誌では、EUVA専務理事の小川眞佐志氏のお話とともに、ウシオグループが取り組むEUV光源の開発の現状をご紹介します。
※1 EUV:Extreme Ultraviolet(極端紫外線)
※2 EUVA:Extreme Ultraviolet Lithography System Development Association
(技術研究組合 極端紫外線露光システム技術開発機構

EUV光源
”日本発“のEUV露光技術を
EUVA(理事長:牛尾治朗ウシオ電機会長)は、2002年6月、経済産業省、NEDO(新エネルギー・産業技術総合開発機構)によって設立され、光源、装置、デバイスのそれぞれの分野から、日本を代表する9企業※3がプロジェクトメンバーとして参画し、EUV露光技術の総合的な開発を推進しています。
『このEUV露光技術は1986年に日本で提案されたものですが、現在、その実用化の一番乗りを目指して、世界各国で開発が進められています。まったく新しい技術のために、解決すべき課題が数多くあり、各企業が個別に取り組んでいては、とても厳しい開発競争を勝ち抜くことはできません。そこで、有力メーカーが連携し、“日本発の技術”として早期の実用化をはかることを目的に、EUVAが設立されました。ウシオさんには、その光源部分の開発を担っていただいています』
(小川眞佐志EUVA専務理事)

EUVA専務理事小川眞佐志氏
半導体の微細化は、露光用光源の短波長化の歴史と言っても過言ではありません。
光源は、これまでに436nm、365nm、248nm、193nmと短波長化が成功し、これらによって、直近では、回路線幅65nmを切るまでの微細化が進んでいます。しかし、従来の光源システムで線幅45nmを実用化することは限界となります。これをカバーするために、液浸露光など、新しいプロセス技術の導入が進められていますが、これらのプロセスは極めて複雑になっていきます。
回路線幅45nmを切り、さらに、その先の30~10nm台の微細化を実現するには、これまでにない新しい短波長の光が必須となります。その光が“究極の光”といわれる波長13.5nmの「EUV」です。
DPPとLPP、両方式からアプローチ
EUVを発光させるには、DPP(放電方式)とLPP(レーザー励起方式)の2つの方式があります。DPPは、放電によって直接EUVを生成できることや、装置がコンパクトで使いやすいことが大きなメリットです。もう一方のLPPは、クリーンでエネルギー効率が高く、パワーアップしやすいことが特色です。
EUVAは、世界で唯一、両方式でEUV露光技術の開発を進めています。光源開発では、ウシオ電機とエクストリーム※4がDPP開発を、ギガフォトン※5とコマツがLPP開発を、それぞれ取り組んでいます。
■EUV露光装置の構成
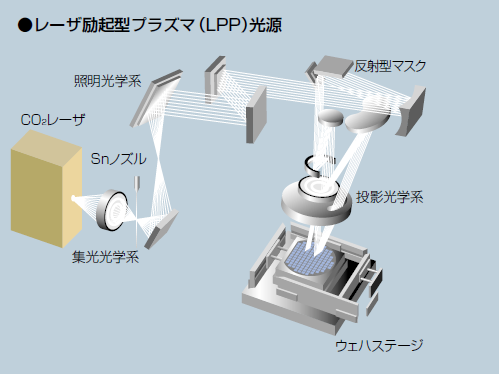
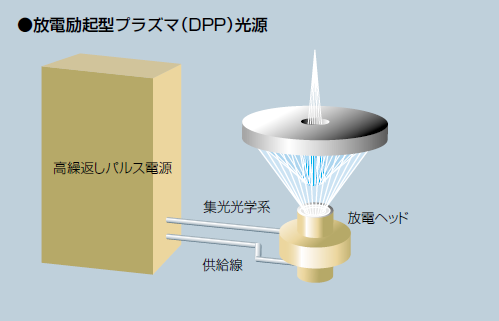
線幅26nmを達成
2006年、EUVAでは、DPP方式によるEUV光源と2枚ミラーの投影光学系の試作に成功し、これらを搭載した小面積露光装置(SFET)によって、Selete※6において回路線幅26nmを達成しました。EUVAの最終目標とする「実用試験機(β機)に対応する集光点出力50Wレベルの性能」も、2008年3月の達成に向けて、開発は着実に進んでいます。
EUV光源を搭載した量産タイプの露光装置では、直径300mmウエーハで1時間100枚の処理能力が求められます。そのためには、115W以上の集光点出力が必須とされています。ウシオグループは、今後も、産・官・学の叡智が結集するEUVAで、光源メーカーとしての重要な使命を果たしていきます。
『ウシオさんには、露光用光源と、高出力放電ランプの技術的蓄積を生かしたノウハウを提供していただいています。我々の使命は、世界に先駆けて実用化を果たし、市場をリードすることにあります。そのためにも、技術開発のキーを握るウシオさんをはじめ、参画企業の共同研究の成果に、いっそう期待しています』
(小川眞佐志EUVA専務理事)
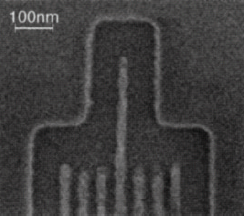
SFETで露光したハーフ・ピッチ26nmのパターン(提供Selete)
半導体とウシオの「光」
ウシオは、ICが登場する1960年代から、半導体露光用光源の開発を手掛け、露光装置メーカーと連携しながら、g線ランプ、i線ランプ、KrFレーザー、ArFレーザーなど、数々の新光源を開発してきました。現在では、露光用光源のすべてを揃える世界で唯一の光源メーカーとなり、この分野で85%の世界シェアを獲得しています。
また、80年代には、クリーンでファインな光エネルギーを用いたレジストハードニング装置やレジスト除去装置、均一加熱装置などを開発し、半導体製造装置メーカーとしての地位を確立しました。
ウシオは、今後も、光の最先端技術を究めるとともに、光のリーディングカンパニーとして、生産性・信頼性の向上、コスト削減、省エネルギーなどのご要望にお応えし、エレクトロニクス産業の発展に貢献していきます。
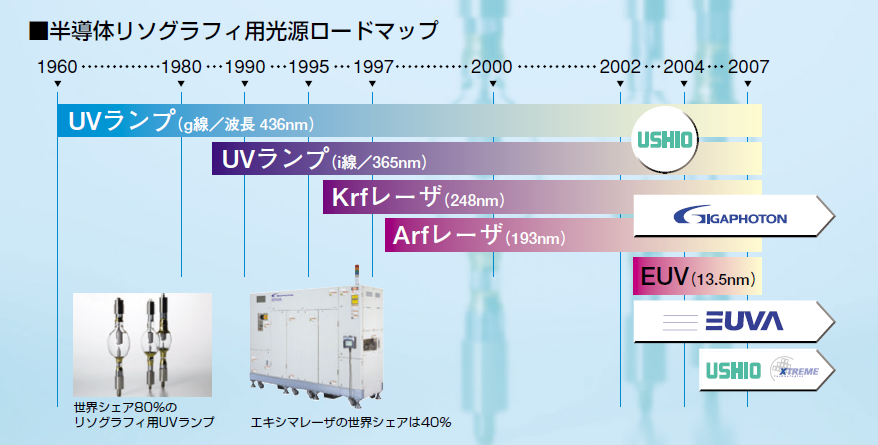
エクストリームテクノロジーズとフィリップスEUV
DPP方式によるEUV光源の最高出力500Wを実証
エクストリームテクノロジーズGmbH(以下、エクストリーム)とフィリップスエクストリームUV GmbH(以下、フィリップスEUV)は、2008年2月26日、高集積回路の量産装置(HVM)に必要とされるEUV光源の出力目標を十分に上まわる500Wを実証した、と発表しました。
両社は原理実験により、DPP方式のEUV光源で、これまで数キロヘルツ程度しか確認されていなかった繰り返し周波数が、100kHzまでスケールアップでき、スキャナ入り口では500W以上の出力が達成できることを示しました。本実験結果は、アメリカ合衆国カリフォルニア州サンノゼ市で開催中のSPIE(International Society for Optical Engineering)の‘Advanced Lithography 2008’で発 表されました。
マーク・コスアウト フィリップスEUVゼネラルマネージャ「光源の高出力化は、EUV開発の主たるボトルネックのひとつとなっており、従来、量産化のためには180W以上の出力がターゲットとなっていました。実験では、競合するLPP(レーザープラズマ)方式より、我々のDPP(放電)方式の光源のほうが、はるかに大きい出力が比較的容易に実現可能であることが示されました」
吉岡正樹 エクストリーム社長「これはDPPの拡張性を示す大きな進歩です。両社の協力による大きな成果であり、世界初のEUV光源の実用化という両社共通の事業目標の可能性を示すものです」
フィリップスEUVとエクストリームは2007年11月、EUV光源を共同開発するため、業務提携を発表しました。両社は、現在世界にあるEUVを使用する露光機のアルファ機すべてにEUV光源を供給しており、量産用EUV光源の実用化についての知識を多数有しています。両社は、放電ランプのように、電極間でプラズマを燃焼させるDPP方式のEUV光源技術を採用しており、電極を延長し回転させるというアイデアが大きなブレークスルーへと結びつきました。この技術は、高出力時の過度な熱負荷を簡単に取り除き、電極の長寿命化も実現しています。



![ライトエッジ No.30 [特集号] EUV光源](./content_file/file/lightedge_30.png?_size=1)