光技術情報誌「ライトエッジ」No.30(2008年3月発行)
「レーザー研究」日本レーザー学会
(2001年10月)
リソグラフィ用EUV光源
EUV Source for Lithography
堀田 和明
ウシオ電機次世代光源開発室(〒100-0004 東京都千代田区大手町2-6-1 朝日東海ビル)
ギガフォトン研究企画部(〒254-8567 神奈川県平塚市万田1200)
Kazuaki HOTTA
Next Generation Light Source Dev. Dep. USHIO INC., 2-6-1 Ohtemachi, Chiyoda-ku,Tokyo 100-0004
Research Planning Dep. Gigaphoton, 1200 Manda. Kanagawa 254-8567
(Received May 7,2001)
EUV(Extreme Ultra-Violet)lithography is most promising technology after 50nm technology node from around 2007.There are many problems in order to realize EUV lithography and the most serious prob lem is to develop the EUV source.A debris free EUV source with a collectable radiation power of 50W to 150W at over 5kHz in the spectral range of 13-14nm will be required to achieve a 300mm wafer throughput of up to 80wafer/hour. Several types of laser produced plasmas(LPP’s)and gas discharge based plasmas(EUV lamps)are under investigation as EUV sources. However,there are big d ifferences between the status quo and the required specification.In this review,the status of EUV source candidates is introduced and future direction of deve lopment will be briefly commented。
Key Words:EUV lithography,EUVsources,Laser produced plasma(LPP ),Discharge based piasma(EUV lamp)
1. はじめに
EUVリソグラフイは波長13nm~14nmのEUV(Extreme Ultra-Violet:極端紫外)光を使う縮小投影リソグラフィである.半導体デバイス量産用リソグラフィとして,現在,波長248nmのKrFエキシマレーザーリソグラフイが製造ラインに導入され,次世代の100nm技術ノード(デザインルール)1)向けに波長193nmのArFエキシマレーザーリソグラフィが,また,70nm技術ノード向けに157nmのF2レーザーリソグラフィが開発されている.Euvリソグラフィは,Siデバイス時代の最後のリソグラフィといわれ,50nm技術ノード(70nmノードの次)以降におけるリソグラフィとして最有力視されている.現時点で,50nm技術ノードでのデバイスの量産は2007年頃からとコンセンサス1)がとれている.しかし,微細化が大幅に加速されている状況で,最先端デバイスメーカではEUVリソグラフィを,F2リソグラフィを飛ばして,2004年頃から導入するだろうという意見さえ発表されている2).また,米国のEUVLLC(後出)から,2005年にEUV露光機の商用化を目指す,というアナウスがある3).
EUVリソグラフィが50nmノード以降のリソグラフィとして最有力視される理由に,①従来からの光リソグラフィの延長である,②波長が13nm帯と短いため,Siデバイスの最後まで,複数世代(50nm,35nm技術ノード)で使える,③SR(シンクロトロン放射光)と違ってスタンドアローンなリソグラフィ装置が実現する,などが挙げられている.中でも,①,②の波長がBnm帯と短い光リソグラフィであることがその主たる理由である.リソグラフィにおいて,光源の波長と解像度(デザインルール)の関係はリーレー(Rayleigh)の式,R=k1・λ/NA,で議論される4).Rは解像度,k1はk1(ケーワン)ファクター,λは光源の波長,NAは露光光学系の開口径である.k1はレジストや超解像技術(RET:Resolution Enhanced Technology)などで決まる値で,理論限界の最小値は0.25である.また,NAは0.9位まで大きくすることは困難と思われる.Table 1に技術ノード(デザインルール)と光源,NAおよびk1の関係を示す.KrFリソグラフィの導入時は光源の波長248nmとデザインルールは同等であったが,ArFリソグラフィの導入は波長193nmより短い100nm技術ノードから始まっている.F2リソグラフィに至っては,波長157nmの1/2以下である70nm技術ノードに使われようとしており,NAにおいてもk1においても限界に近づいている.従って,光源の短波長化は必須になってきている.波長127nmのAr2レーザーが発振している5)が,電子ビーム励起であり,エキシマレーザーのような放電励起では発振が得られていない.以上のことから,波長13nm帯とデザインルールより遙かに短いEUVリソグラフィヘの期待が大きい.
Fig.1はEuv露光機の基本構成図である.また,Fig.2は米国のEUVLLCが開発しているリソグラフィ実験用EUV露光機ETS(後出)である6).EUV光を透過する材料がないので,従来の露光機とは異なり,光学系とマスクは全て反射型で,また,光源,露光光学系,マスク,レジスト,およびステージ,など露光機の構成要素の全てが同一の真空チェンバー内に設置される.
EUVリソグラフィは日本で最初(1986年)に実験検証され7),その後,日本,米国,欧州で研究が進められてきた.米国のEUVLLC(Extreme Ultra violet Limited Liability Co.)は,デバイスメーカが共同で,1997年に,設立したEUVリソグラフィの開発会社で,EUVリソグラフィの開発で世界をリードしている.実際の研究開発は,Sandia,Lawrence Livemlore,Lawrence Berkeleyの3研究所が形成するVNL(VirtualNa-tional Lab.)への委託により行われている.EUVLLCが開発を急ぐETS(Engineering test stand)は,最初のフルフィールド露光面積のEUV露光実験機として,稼働し始めている6).光源としてLPP(後出)を用いている.一方,国内のASET(超先端電子技術開発機構)厚木センタでは,1998年から4年の計画で,EUVリソグラフィの要素技術の研究開発とリソグラフィ実験を行なっており,数々の成果を上げている8).光源としては既存のSR(シンクロトロン放射光)を活用しており,光源そのものの開発は行っていない.
EUVリソグラフィを実現するためには,その要素技術の中で,光学系,マスク,コンタミネーション,などにまして,EUV光源が特に重大な開発課題になっている.現在まで実現している光源の性能は量産時に必要とされる性能と大きくかけ離れていている.例えば,出力で必要性能の50~150Wより約一桁低い.従来のリソグラフィでは光源があってリソグラフィ技術が開発されてきたが,EUVリソグラフィでは具体的な光源がなくて開発に着手された.波長13nm~14nmが選ばれたのは13.5nm近傍に垂直入射で67%の反射率のピーク値を持つMo-Si多層膜9)があったからで,1988年頃から,米国や日本において,Mo-Si多層膜を光学系と反射型マスクに用いる縮小投影型EUVリソグラフィの開発が始まった10,11).しかし,後述のLPPから,波長11.5nm付近において,デブリフリー(後出)で,13.5nmより5倍以上の高効率発光が見いだされ,一方で,Mo-Be多層膜が69%の高反射率を示すことから,米国では11nm帯でのEUVリソグラフィの開発に移行した12).一時は,LPPにおいて波長11.5nmで60W@6kHzの実現の見通しを得て,EUV光源には問題がないと判断されていた.ところが,Mo-Be多層膜に使われるBeの毒性が問題視され,しかも,多層膜の安定性に欠けることなどが判ってきたことから,再び,Mo-Si多層膜が使用可能である波長13nm~14nm(以下,13nm帯)の光源が必要になってきた.すなわち,EUV露光の波長は13nm帯に決定され,加えて,量産に必要なEUV光源として,出力50~150W,繰り返し5kHz,など実現が非常に難しい要求性能(2.2で述べる)が提示され*1,上述のように,EUV光源の開発が焦眉の重要課題になってきている.本文においては,先ず,EUV光源としてのプラズマとEUV光源への要求性能につき述べ,次にEUV光源の現状をレビューする.最後に,今後の開発方向につき述べる.
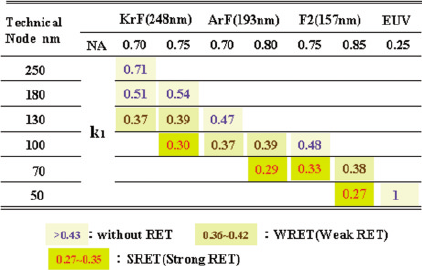
Table 1 Technology node, NA and Kl factor
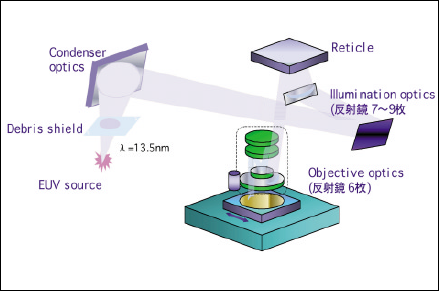
Fig.1 Schematic view of EUV lithography tool. (after Mr.K.Ohta(ASET/Nikon)).
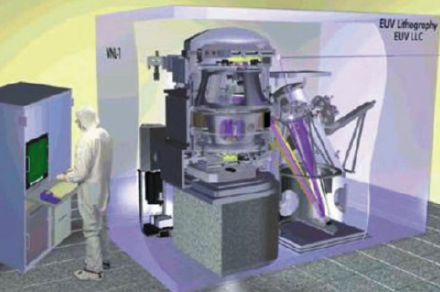
Fig.2 EUVLLC's ETS (Engineering Test Stand) for EUV Lithography.6)
2.EUV光源としてのプラズマとEUV光源に要求される性能
EUV光源においては,レーザー光をターゲットに照射することにより,または,高密度電流ピンチ放電などの放電により生成されるプラズマから13nm帯EUV光を得ている.レーザーを用いる方式はLPP(Laser Produced Plasma:レーザー生成プラズマ)と呼ばれ,放電を用いる方式は放電プラズマ(DischargeBased Plasma)やEUVランプと呼ばれ,本稿ではEUVランプを用いる.次に,EUV発光のために必要なプラズマの特徴と量産時に必要とされるEUV光源への要求性能につき述べる.
2.1 リソグラフィ用EUV光源に用いられるプラズマの検討
13nm帯EUV光源に用いられるプラズマとして,高効率高出力化のための電子温度,イオン密度および媒質である原子の検討,また,高繰り返し化,小エタンジュー化及び低デブリ化の検討が不可欠である.高効率化が重要視されるのは,高出力化のためだけではない.光学系,特に光源に一番近い集光光学系の反射鏡(多層膜)が,EUV光源からの13nm帯EUV光以外の光を吸収し,発熱することにより,歪むなどの問題が発生する13).そこで,他の波長域の発光を抑制し,13nm帯EUV光の発光効率を向上させる検討は重要である.
13nm帯EUV光を効率よく得るための電子温度Teおよびイオン密度N1については富江氏が考察14)している.それによれば,発光の輝度の限界は黒体輻射から得られるので,黒体輻射の検討から,13nm帯(光子エネルギー:約90eV)の発光に適するプラズマのTeは50eV位となる.
また,黒体輻射に近い,すなわち,限界輝度に近い発光を得るにはNixƒoscxd≫1015/cm3を満たすイオン密度Niが必要になると計算される(Te=50eV,イオンの質量数=100とした場合).ƒoscは振動子強度で,dはプラズマの厚みである.ƒosc=0.01,d=0.1mmとすると,Ni≫1019/cm3と非常に大きな値になる.
発光(4d-4fの狭帯域発光)のピーク値を示す波長は原子番号によって決まる15).原子番号が54のXeは前述したように11nm帯に発光のピーク値を持つ.13nm帯に発光のピーク値を示すのは原子番号50のSnである.そこで,LPP開発の当初では,Snの固体ターゲットが検討されていた.しかし,後述するデブリの点から,米国でのLPPではXeを用いている.また,H様Liイオン(Li2+)のライマン(Lyman)α共鳴線の波長は13.5nmで,Liを用い高効率発光が期待できる.しかし,Liの高い化学反応性が問題になる.
リソグラフィ用光源としては,生産性(スループット)とドーズ量(レジストヘの照射エネルギー)の制御性から,5kHz程度の高繰り返し化が必要となる.現状のリソグラフィ用KrFエキシマレーザーは2kHzの高繰り返し動作であり,さらには4kHzが要求されている.次世代のArFエキシマレーザーでは6kHzという要望さえ出ている.EUV光源での高繰り返し動作においては,プラズマからの除熱が,特に,プラズマを閉空間に閉じこめるEUVランプにおいて,大きな課題になる.
プラズマの形状にも制限が加わる.エタンジュー(Etendue)というプラズマの発光面積と集光可能な拡がり立体角をかけたパラメータが規定される.レーザー光における伝搬定数M2(=πθW0/2λ,θ:拡がり角,W0:ビーム径)に相当するパラメータである16).エタンジューは光の伝搬において保存されるので,エタンジューが大きいとレジスト上での輝度がとれず,大きなEUV出力が必要になる.また,エタンジューを小さくすることは,光源の入力密度を大きくする必要があり,光源側で問題になる.
LPPにしろEUVランプにしろプラズマ生成時にデブリと呼ばれる飛散微粒子が発生する.デブリが光学系の多層膜(反射面)に付着したり,入り込んだりすることにより反射率が低下する.従って,デブリの発生はEUV光源において重大な問題である.LPPにおいては,固体ターゲットを用いる場合,レーザーアブレーションによりデブリが発生する.そこで,デブリの発生を抑えるという点から,希ガスを用いるという考えが生まれ17),ターゲットとしてノズルで生成する希ガスジェットを用いたLPPが考案された18).これが現在の米国でのXeを用いたLPPの開発19)につながっている.しかし,Xeガスジェットをターゲットにした場合でも,EUV発生にプラズマを利用する限り,Xeイオンがデブリになり,この発生は避けられない.また,ノズルの先端がプラズマの熱で高温になることにより,さらには,プラズマに晒されることによるスパッタリングでデブリが発生する20,21).EUVランプにおいては,放電電極のスパッタリングやプラズマに晒される管壁の溶融,などでデブリが発生する*2.LPPに比べ,EUVランプの方が,デブリが問題になる.デブリの抑制が困難なことから,デブリから光学系を防御するガスカーテンやフィルタなどのデブリシールドの検討が不可欠と思われる*2,21).
2.2 量産時に用いられるEUV光源の性能
Table 2 に,量産時に必要とされるEUV光源の必要性能である出力,繰り返し,エタンジュー,安定度および集光光学系の寿命を示す.昨年(2000年),日米欧の露光機メーカ5社が集まり決定したもの*1で,レジスト感度を5mJ/cm2にした場合の,300mmウエハを80枚/時で露光するための必要性能である.
出力は,波長の2%のスペクトル幅(BW:BandWidth)内に含まれ,集光光学系(Condenser)で集光しうるパワーである.50~150Wと大きな幅があるのは,露光光学系の設計が未だできていず,光学系の損失が見積もれないからである.
集光光学系の寿命は集光効率が10%低下するパルス数で定義されている.集光効率の低下の主原因はデブリの付着によるので,集光光学系の寿命は光源側に課せられる要求性能となる.

Table 2 EUV source specification for 2005-2006 commercial tool.*1
3.EUV光源の開発現状
リソグラフィ用EUV光源の開発の現状をTable3にまとめる.光源の高出力化など進捗はしているが,Table2の要求性能と現状の性能では大きな隔たりがあることが判る.以下,LPPとEUVランプに大別し,開発状況を紹介する.なお,世界(欧米)中で開発されるEUV光源の性能は,昨年(2000年),共通の計測器を携えた“Flying Circus”と称する活動で,比較評価されている*3.また,Table3に示したEUV光源のプラズマパラメータを文献22)で詳細に比較しているので,参照されたい.
3.1 LPP(Laser Produced Plasma=レーザー生成プラズマ)21)
これまで米国(EUVLLC/RW社)において先行的に開発されていたLPPでは,Fig.3に示すようなノズルから吹き出すXeのガスジェットをターゲットにし,そこに高輝度YAGレーザー光を照射することによりプラズマを生成して,波長13nm帯のEUV光を得ている.ドライバーであるYAGレーザーはLD励起である.Fig.4に示すXeプラズマの発光スペクトルで判るように,11nm帯の発光効率が,Mo-Si多層膜が高反射率を示す13nm帯のそれより5倍程度大きい12).そこで,1.において述べたように,一時は11nm帯で高反射率を示すMo-Be多層膜と組み合わせることにより,EUV光源には間題がないと判断されていた.これまで得られている13nm帯EUV出力は,0.75J(繰り返し:L7kHz)のYAGレーザーを用いて,0.96mJで,発光効率は0.13%と低い*3,*4.そこで,現在は,Xeの液体ノズルによる高効率化に注力している23).ノズルからXeガスを吹き出すと,Xeがレーザー照射部(EUV発光部)の周辺に拡敵し密度が低くなると共に,13nm帯EUV光を吸収し,発光効率が上がらない.そこで,Xeが拡散しない液体ノズルを用いることにより,高効率化が期待できる.また,Xeの拡散がしないので,ノズル先端から離れたところにYAGレーザーを照射することができ,デブリの低減がはかれる.当面は,1.5kWのYAGレーザーを用い,6WのEUV出力を目指しており,最終的には,30W~70W以上のEUV出力を3~15kW以上(12kHz)のYAGレーザーで実現することを計画している.技術的には実現の見通しはあると思われるが,しかし,LD励起YAGレーザーが高価(現状で,約1億円/kW)で,かつ,励起用LD(半導体レーザー:1億円程度)の寿命が1年くらいと短いことが,導入コスト(Initial Cost)とCoO(Cost of Ownership or Oost of Operation:運転・保守コスト)が重視されるリソグラフィ光源においては,大きな問題になる.この点から,XeとLD励起YAGレーザーを用いるLPPでの開発課題は,YAGレーザーの出力の低減を可能にするEUVの高発光効率化,LDの長寿命化ということができる.また,LPP用として特化し,低コスト化・小型化を目指すLD励起YAGレーザーの検討が必要と思われる.
国内には米国の開発に対し特徴的で,興味深いLPPの研究がある.先ず,上記した希ガスを用いるという考えは日本から生まれている17)ことを特記しておく.最近では,Xeの液体ノズルと同様,Xeガスの拡散を防ぐことで高効率化とデブリの低減をはかったダブルノズルの研究がある24).また,13nm帯の発光に最適な原子であるSnを用いた場合でも,微粒子を用いればデブリが低減できるのではという目論見から,SnO2の微粒子を用いたLPPの研究がある25,26).Sn微粒子の生成が難しいため,SnO2を用いている.さらに,Snなどの固体の採用による13nm帯EUV発生の高効率化とキャビティによるデブリの低減を狙ったキャビティ閉じこめ型LPPの提案・検討がある*5.テープ状の固体にデンプル(キャビティ)を形成し,その中に,フェムト秒レーザーによるレーザーアブレーションで発生させた必要最小量の固体原子の蒸気を閉じこめ,もう一つのナノ秒レーザーによる加熱でEUVを発生させるという提案である。レーザードライバーにサブナノ秒のエキシマレーザーを使った研究もある27).Xeガスをノズルからクラスターにして放出し,クラスターが壊れる前にサブナノ秒のエキシマレーザーを照射してEUV光を得ている.

Fig.3 Xe gas jet farget for Lpp.
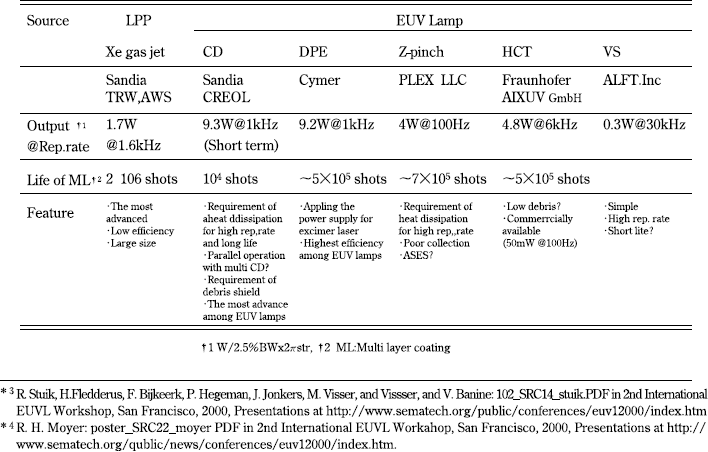
Table 3 Status of EUV sourve candidates.

Fig.4 EUV spectrum from Xe gas jet LPP.12)
3.2 EUVランプ
EUV光の波長が13nm~14nmと決まり,Xeを用いるLPPではその波長での発光効率が悪いことから,EUVランプが期待され始めた.Fig.5はEUVランプの中で後出のZ-ピンチ28)とCD29)からの発光スペクトルで,Xeを用いても,LPPと違い,11nm帯と13nm帯で発光強度の差がない.また,Euvランプが,LPPに比べ,非常に安価で,小型である.この点はリソグラフィ光源としての大きな魅力である.しかし,高繰り返し高入力化のための除熱やデブリの低減が重大な課題になる.
EUVランプとして,Table3あるいはFig.6に示すキャピラリ放電(CD:Capillary discharge),真空スパーク(VS:Vacuum spark)およびピンチ放電を用いたZ-ピンチ(Z-pinch),デンスプラズマフォーカス(DPF:Dens plasma focus),ホロー陰極プラズマ着火Z-ピンチ(HCT:Hollow cathode triggered pinch plasma)が開発されている.
EUVLLC(Sandia 研究所)でのCD*2・30)の開発がEUVランプの中で最も進んでいるように思われる.リソグラフィの実験まで行われている.CDの構造図と試作機をFig.7に示す.性能向上のために,種々な手が打たれている.高速立ち上がり電源や低インダクタンスの放電回路を用いた高効率化,冷却の強化による低デブリ化,高繰り返し化,予備放電(Simmer)による大幅な低デブリ化および電流波形の工夫による電極の長寿命化,などである.特記すべきは電極の材料(Ta?)と形状およびキャピラリヘの高熱伝導率材料(AIN?)の採用でデブリを1/70に低減したこと,XeとHe混合ガスを用いることで出力を90%向上できたこと,電極形状をデブリの防御ができるようにしたこと,などである.現在,1kHz,14W機を開発中である.しかし,50W以上の出力の実現は困難とみており,4個のCDの並列運転で>50W@5kHzを目指すという構想をもっている.また,デブリをさらに3桁から4桁に低減する必要があり,デブリの集光光学系への付着を防止するためのHeガスカーテンやフィルタの検討を始めている.
DPF(Cymer社)では,エキシマレーザーの高速電源技術の活用により,9.3W(1kHz)の高出力を得ている31).低繰り返し動作では25mJ/pulseが得られ,効率は0.22%と高い.ピンチプラズマが電極上に浮上する*6 ので,電極のスパッタリングによるデブリの発生が大きな問題である.
Z -ピンチ(PlexLLC社)28)では,Xeガス圧,放電条件の考察により,Fig.5に示したように,11nmよりも13nm帯で効率よい発光を得ているのが注目される.難しいとされる高繰り返し化のため,管壁材料として高熱伝導率のサファイアなどを検討している。マイクロ波で予備電離を行っているのが特徴である.予備電離にコロナ放電を使ったZ -ピンチ(Lambda Physik社)の開発も行われている32).
HCT(Fraunhofer institute)では,ガス圧をパッシェンカーブの左側になるように設定して,放電開始時に得られる放電をピンチ放電のトリガーに利用しているのが特徴である33).Fig.6のように,ピンチ放電が放電管壁に触れないので,高繰り返し化や低デブリ化の可能性を持っている.VS(ALFT社)は非常に単純な構造で,100kHzの高繰り返し動作に特徴がある34).電極のスパッタが問題になるので,電極を回転させるなどの工夫をはかっている.高出力化が課題になる.

Fig.5 EUV spectrum from Z-pinch28) and capillary discharge.19)
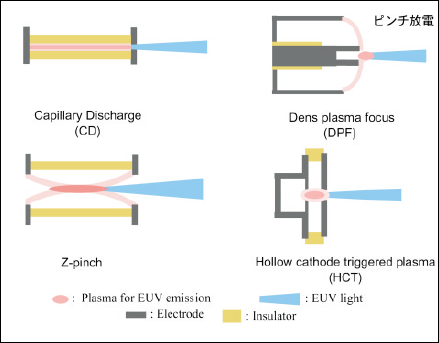
Fig.6 EUV lamps(Discharge based plasma).

Fig.7 EUV capillary discharge source.*2
4.おわりに(EUV光源の展望)
EUV光源の候補の中で,Xeを用いるLPPの開発が最も進んでおり,少なくとも,EUV露光機のβ機(リソグラフィ実験用装置)まで採用されると思われる。しかし,高コスト,高CoO,大型であることなど実用時の大きな問題があり,高効率化が最も重要な課題であると考えられる.そこで,LPPにおける高効率化の点から,Snを用いたターゲットの再考が意義深いと考えられる*5,26).この場合は,同時に,デブリシールドの開発への注力が前提になる.
EUVランプは小型で,低コストであるなどの利点を持つが,熱の問題で高出力化,高繰り返し化が難しく,また,デブリの発生が避けられないと思われる.そこで,例えば,複数個の並列運転を可能とする集光光学系やデブリシールドなどの工学的な検討*2が不可欠になると思われる.ともあれ,EUVランプの開発は始まったばかりである.高発光効率化を目指した新しいコンセプト(放電方式)の創出が強く期待される.
現在,国内におけるEUV光源開発の機運が高まっている.そこで,EUV光源の開発においては,光源単独での開発ではなく,露光光学系と一体になった開発が必要であることを強調しておきたい.理由は,EUV露光機では,光源と光学系が同一チェンバー内に設置される特殊性があり,また,プラズマからのデブリや13nm帯EUV光以外の発光が多層膜に害を及ぼすからである.さらに,上記したように,安価小型なEUVランプの場合,複数個の並列運転を可能にする集光光学系の開発が望まれるためである.EUV光源の開発期間は,これまでのリソグラフィ用光源の開発に比して,非常に短い.光学系と光源の共同・協調開発により短時間で,効率よいEUV光源の開発が可能になるものと思われる.
これまでのリソグラフィ用エキシマレーザーの開発においては,リソグラフィというエキシマレーザーの応用がエキシマレーザーの想像を絶するような性能の向上をもたらした.すなわち,10年前(1990年頃)では実現困難と思われた性能仕様を持つエキシマレーザーが開発されてきている35).6kHzの高繰り返し狭帯域化ArFエキシマレーザー36)や2kHz以上の高繰り返しF2レーザーの実現37)がその代表例である.EUVリソグラフィにおいても,高度な要求性能を満足する光源が実現することが確信される.
謝辞
本稿をまとめるに当たって,特に,経済産業省産総研の富江敏尚氏には数々のご教示をいただいた.また,東北大学科学計測研究所の山本正樹教授,東京工業大学堀田栄喜教授,日本原子力研究所関西研究所の大道博行先生,株式会社キャノンの鈴木義章氏,株式会社ニコンの村上勝彦氏,株式会社日立の松井哲也氏,ASET厚木センタの小川太郎氏,ウシオ電機平本顧問,およびギガフォトンの溝口計氏にはご教示,ご議論をいただいている.各位に謝意を表したい.
レーザーワード
Euvリソグラフィ(Euv lithography)
EUVリソグラフィは,波長13~14nmのEUV(Extreme Ultra-Violet)光を使う,半導体デバイス製造用縮小投影リソグラフィである.2007年頃からの50nm技術ノード(デザイルール)およびそれ以降のリソグラフィとして最有力視され,Siデバイス時代の最後のリソグラフィといわれている.波長が13~14nmに選ばれているのはこの波長帯に高反射率(67%)をもつMo-Si多層膜が存在するからである.EUV露光機では,EUV光を透過する材料がないため,光学系とマスクは反射型で,光源,光学系およびステージなど,構成要素の全てが同一の真空チェンバー内に設置される.EUVリソグラフィは,1986年に日本で最初に検証され,現在,日米欧で開発が進められている.米国では,最初のフルフイールド露光面積のEUV露光実験機が稼働し始めている.現状でのEUV光源の性能は量産時に必要とされる光源の性能と大きくかけ離れており,EUVリソグラフィの最大の開発課題は光源である.(堀田和明)



![ライトエッジ No.30 [特集号] EUV光源](./content_file/file/lightedge_30.png?_size=1)