光技術情報誌「ライトエッジ」No.30(2008年3月発行)
「超精密」精密工学会 超精密加工専門委員会編
(2005年11月)
EUVL用ディスチャージ生成
プラズマ光源の開発
技術研究組合EUVA平塚研究開発センタ御殿場分室
佐藤 弘人
1. はじめに
半導体回路の微細化・高集積化は、光リソグラフィ技術における微細加工技術の進展によるところが大きい。デザインルール45nm以下に対応可能な回路形成技術のうち、比較的大面積でスループットの高いリソグラフィ方式として、現在実用化されているArFエキシマレーザの193nmより一桁以上短い、波長13.5nmの極端紫外線(Extreme Ultraviolet、EUV)を用いたEUVリソグラフィ技術が候補の一つに挙げられている1)。
EUVリソグラフィ装置の実用化にあたっては、光源の開発が最も重要かつ困難な課題の一つであり、次節で述べるように、高出力、高安定、長寿命かつクリーンなEUV光源が要求されている。現在、主に米国、欧州、および日本において、高温プラズマからの放射を利用したEUV光源の実用化に向けた研究開発が進められている。
プラズマ放射を利用したEUV光源は2つの方式に大別される。一つは、ピークパワーの高いパルスレーザ光をターゲットに照射して加熱し、高温プラズマを得るレーザ生成プラズマ(Laser Produced Plasma、LPP)方式であり、もう一つは、パルス放電による電流駆動によって高温プラズマを生成する放電プラズマ(Discharge Produced Plasma、DPP)方式である。リソグラフィ用のEUV光源としてみた場合、いずれの方式もそれぞれ長短がある。技術研究組合極端紫外線露光システム技術開発機構(EUVA)においては、EUV光源についてLPP方式とDPP方式が並行して開発が進められている。
本稿では、リソグラフィ用EUV光源の概要と要求性能について述べた後、これまでEUVAにおいて実施されたDPP方式EUV光源の開発状況と主な実験結果について報告する。
2. EUVリソグラフィとEUV光源
図1にEUVリソグラフィ装置システムの機能ブロック図を示す2)。光源から発生したEUV光は集光光学系によって一旦中間集光点に集められた後、照明光学系へと導かれて整形され、反射型マスクを均一に照射する。マスクパターンは投影光学系によりウェハ上に縮小投影される。光学系には透過屈折型の光学素子は使えず、すべて反射ミラーを用いた光学系となる。反射ミラーにはMo/Siの多層膜ミラーが用いられる。このミラーが波長13~14nmで高い反射率を示すという理由から、EUV露光には13.5nm付近の波長が用いられる。
EUV光はガスによる吸収減衰が大きいため、光源からウェハに亘るEUV光の伝播経路は実質的な真空状態にする必要がある。さらに、上記の多層膜ミラーは表面がわずかに汚染染されてもその反射率が大きく低下してしまうため、真空系内は非常にクリーンな状態に保つ必要がある。
表1に、量産レベルにおいて要求されるEUV光源の性能を示す3)。これはリソグラフィ工程におけるスループットを100枚/1時間と設定して算出されたもので、露光装置メーカー3社が共同で策定した、EUV光源に対する要求スペックである。なお、これらの要求値は、図1における中間集光点(Intermediate focus、IF)に対するものである。1次光源であるプラズマから放射されたEUV光のすべてを中間集光点に集めることはできないため、1次光源からのEUV出力は中間集光点における要求値の数倍が必要である。また、露光で利用できるのはMo/Si多層膜ミラーによる反射率の高い約13~14nmの波長の光のみであり、EUV出力は波長13.5nm±1%バンド幅内の光に対して定義される。
露光の品質にかかわる光源の特性として、繰り返し周波数とEUVエネルギー安定性に対する要求が挙げられている。高繰り返しが要求されるのは、パルス発光であるので、露光フィールドの露光量を制御するにはある回数以上の多重露光が必要なためである。単位時間あたりの露光処理ウェハ枚数、すなわちスループットをあげるためには決められた時間内に必要な回数、露光する必要がある。表1に示されているように、リソ用のEUV光源およびそのシステムは、繰り返し周波数10kHz程度の高繰り返し動作を前提とした開発が必要である。
また、光学系の転送においてエタンデュ(Etendue)は増大しない、という光学的原理から、発光点のみかけの面積と利用立体角の積は、露光光学系によって決まるある値より大きくできない。すなわち、表1で要求されている値より大きなエタンデュの光源をもってきても、その超過分は下流の光学系では利用できないため、実効的なEUVパワーが下がり、システムとしての効率は悪くなる。つまり、光源サイズには上限があり、この制約条件の下で高出力化を図らなければならない。

図1 EUV露光装置のブロックダイアグラム

表1 量産用EUV光源に対する要求性能
3. DPP方式EUV光源の主な構成
DPP方式EUV光源は電流駆動によって高温プラズマを生成し、多価イオンから放射されるEUV光を利用する。リソグラフィ用には、発光ガスとしてXeまたはSnを用いた光源の研究開発が各機関で進められている。
図2にリソグラフィ用DPP方式EUV光源のシステム構成の例を示す。放電ヘッド、パルス電源、放電発光ガス供給装置、デブリシールド、集光光学系、冷却装置、真空排気系などから構成される。放電ヘッドで生成されたプラズマ(発光点)から出たEUV光は集光光学系によって捕集され、露光装置とのインターフェースにあたる中間集光点に集められる。放電部やプラズマから発生するデブリによる集光ミラーの汚染・損傷を防止するために、放電ヘッドと集光光学系との間にはデブリシールド装置が設けられる。以下、EUVAで開発を進めているDPP方式EUV光源の主なコンポーネントについて概略を説明する。
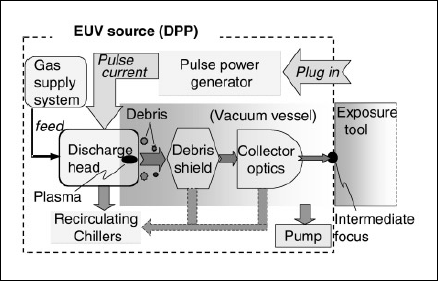
図2 EUV露光用光源システム
3.1 放電ヘッド
放電部は中心孔を有する陰極と陽極によって絶縁管を挟みこんだ構造となっており、陰極の中心孔を通して放電管に放電ガスを流量制御しながら供給する(図3参照)。絶縁管はセラミック製である。電極と接続されたパルス電源によって放電をさせ、生成したプラズマから発生した光を陽極の中心孔からチャンバ側に取り出す。実際の放電ヘッドには電極と絶縁管を冷却するための水冷機構が組み込まれている。
EUVを放射するプラズマの生成にはZピンチ現象を利用している(図4参照)。陽極と陰極間に大電流を流すと、放電プラズマとともに、電流を取り囲む磁場が発生する。発生した磁場と電流とが相互作用をし、電流には中心方向を向く磁気圧がかかり、プラズマが圧縮され、EUV放射に必要な温度・密度のプラズマが生成される。
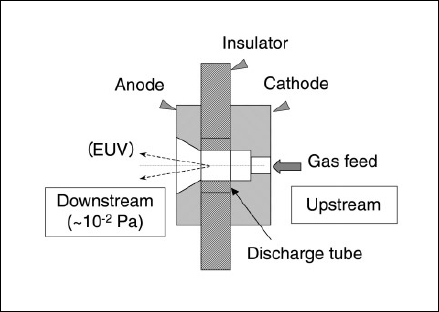
図3 DPP光源の放電ヘッド
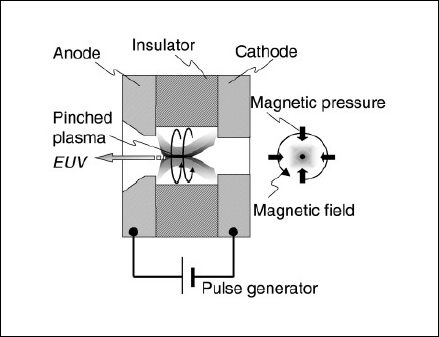
図4 Zピンチプラズマ
3.2 パルス電源
パルス電源は高速充電器、固体スイッチおよび磁気パルス圧縮回路から構成される(図5参照)。磁気パルス圧縮回路の各段はコンデンサと可飽和インダクタ(磁気スイッチ)から成る。基本構成はエキシマレーザ用の高繰り返しパルス電源と同様であるが、充電エネルギー等の動作パラメータはEUV光源用に最適化が図られている。EUV放射特性は駆動電流波形によって大きく変わるため、DPP方式においてはパルスパワー技術が重要な技術要素の一つである。
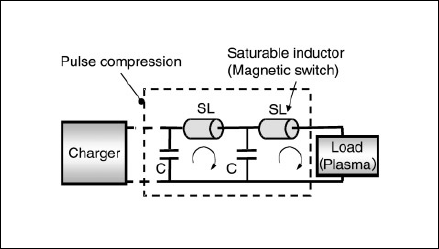
図5 磁気パルス圧縮電源と負荷
3.3 集光光学系
1次光源から放射されたEUV光を捕捉し、中間集光点に集めるための集光光学系は反射集光ミラー、ミラー保持体、アライメント機構等から構成される。反射集光ミラーとして多層膜ミラーを用いる直入射型と、斜入射ミラーを用いる斜入射型の2方式に大別される。後者の場合、1次光源、集光ミラーおよび中間集光点の位置関係は図6のようになる。斜入射ミラーの反射面は単層膜であるが、必要な反射率を得るためには、多層膜ミラー同様に、高空間周波数域の表面粗さが小さいことが要求される。

図6 斜入射型集光ミラー
3.4 デブリシールド
DPP方式の場合、放電部構造体(電極、絶縁管)がEUV光輸送の真空系と同一系内に置かれる。しかも、放電部構造体がプラズマと近接しているため、電極や絶縁管材料が高温によって蒸発したり、プラズマによりスパッタリングされたりしてデブリが発生する。発生したデブリは集光ミラー反射面の汚染・損傷を生起し、反射率の低下を招く。したがって、発生デブリのシールド手段は必須である。
図7はガスカーテンとデブリ捕捉板を組み合わせたデブリシールド装置の例である。一次光源(放電部)から発生したデブリはガスカーテンによってその速度が減速されるとともに、その進行方向が曲げられてデブリ捕捉板に衝突し、さらに減速あるいはデブリ捕捉板表面にトラップされる。一方、EUV光はガスカーテンによって曲げられることはなく直進し、ほとんどがデブリ捕捉板を通過してその先に設置された集光ミラーに入射する。
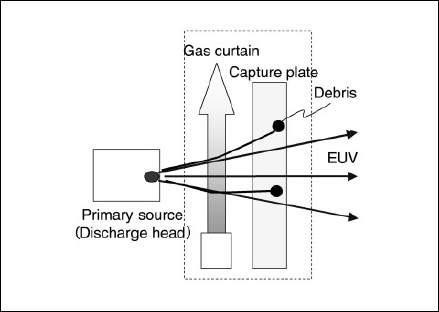
図7 デブリシールド装置
4. Xeパルス放電によるEUV放射特性
4.1 実験・計測装置
放電発光ガスとしてXeを用い、パルス放電によりEUV光を発生させ、その放射特性を調べた。図8に実験装置の構成を示す。真空排気可能なチャンバの一方側に放電部を、他方側にEUVパワーモニタおよびEUV分光器を取り付けた。チャンバ内部はターボ分子ポンプによって排気した。
EUVパワーモニタはオランダFOM研究所の“FlyingCircus”タイプである。これは、Mo/Si多層膜ミラーでの1回反射とZrフィルタを組み合わせることにより13.5nm近傍(バンド幅約4%)のEUV光だけを選択的に検出可能である4)。フォトダイオードからの光電流出力をオシロスコープで測定記録し、これを時間積分して1パルスあたりのEUVエネルギーを求めた。測定されたEUVエネルギー値を、プラズマがMo/Si多層膜ミラーの有効面に対して張る立体角で割ることにより、光軸近傍の単位立体角あたりに放射されるEUVエネルギーを算出した。このEUVパワーモニタに使用されているフォトダイオード(AXUV-100G、IRD社製)は時間応答性が比較的遅いため、EUV出力波形の測定にはこのパワーモニタとは別に高速タイプのフォトダイオード(AXUV-HS5、IRD社製)の前面にZrフィルタを配置し、検出器として用いた。
EUV分光器は平面結像回折格子を用いた斜入射型で、分光後の光をフォスファ付MCPで検出・可視像変換後、スペクトル像をCCDカメラによって取り込み、波長範囲約9~17nmの分光スペクトルを得た。
角度分布特性は、プラズマを中心とした円周上に配置したEUV検出ユニットによって測定した。各ユニットはZrフィルタ、Mo/Siミラーおよびフォトダイオードからなり、13.5nm波長域の角度分布特性が得られる。各検出器からの出力を同時に記録することにより、1ショット毎の角度分布特性が測定可能である。
また、光源像の測定用に専用のピンホールカメラを開発した。Si3N4/Zrフィルタを透過後2枚のMo/Siミラーで反射した光を背面照射型のCCDカメラで撮像することにより、波長13.5nm近傍の光源像を観察した。

図8 Xeパルス放電によるEUV発光実験装置
4.2 発光点のEUV放射特性
図9にXeパルス放電で得られた典型的なEUVスペクトルを示す。Xe流量を変え、放電電流波形は一定とした。EUVスペクトルはXe流量によって変わるが、これは流量によって放電前のガス初期密度が変化し、これが生成するプラズマの温度・密度の変化に反映されるためと考えられる。13.5nm近傍のEUV強度を大きくするための最適流量が存在し、この実験条件の場合、50sccmが最適であった。なお、流量単位のsccmは標準状態換算での体積流量(cm3/min)の意である。
図10にシングルショット動作における光軸上EUVエネルギー強度のXe流量依存性を示す。EUVエネルギー強度は、4.1で述べた“Flying Circus”タイプのエネルギーモニタにより測定された値に、測定したEUVスペクトルから算出した2%バンド幅への換算係数を乗じて求めている。同図からわかるように、EUVエネルギーを最大にする最適なXe流量が存在することがわかる。この傾向は図9のスペクトル測定結果と一致する。
図11にEUV角度分布特性の測定結果を示す。各角度における相対強度の値はその角度における200ショット測定の平均値でプロットした。角度分布特性から、軸対称光源を仮定することにより実効的な放射立体角Ωeを計算することができる。

ここで、αおよびβは放射角範囲、F(θ)は規格化した角度分布関数である。α=0°、β=75°としてΩeを求めると図11の場合約3.08srとなる。光軸上で測定した単位立体角あたりの放射エネルギーにこの実効放射立体角Ωeを乗ずることにより、光源の放射エネルギーが得られる。
図12は繰り返し周波数7kHzで動作させたときの発光点EUVパルスエネルギー測定結果である。シングルショット動作の場合とは異なり、Xe流量が多い方がEUVエネルギーが大きい。Xe流量200sccmのとき、200パルスの平均EUVエネルギーは4.32mJ/srである。これに実効放射立体角と繰り返し周波数を乗じた値、4.32mJ/srx3.08srx7kHz=93Wがこの発光点から実際に放射されるインバンドのEUVパワーである。
発光点のプラズマ形状あるいは輝度分布は、エタンデュ制限内で利用可能なEUVパワーや集光効率などに影響する重要な特性である。図13にEUVピンホールカメラによるプラズマ像の観測例を示す。図13(a)は光軸上の正面から、図13(b)は光軸から角度20°でそれぞれ観察した像であり、観察角度によってプラズマの見え方が異なる。この場合は、光軸方向に長いプラズマ形状であることがわかる。
図14はXe流量だけを変えてシングルショット動作させたプラズマ像を光軸からの角度20°方向から観測した像である。Xe流量によってプラズマの形状が大きく変化している。この例の場合、Xe流量を大きくすることによりプラズマのサイズ、特に光軸方向長さが短くなっている。光学系における光利用効率を低下させないためには、光の上流側エタンデュ≦下流側エタンデュの必要がある。図15に、図14で示した形状のプラズマに対して、捕集角0~50°としたときのエタンデュ制限値とエタンデュ内エネルギー比率の関係を示す。図15において、plasma_1およびplasma_2はそれぞれ図14(a)および(b)のプラズマに対応する。仮に、エタンデュ制限値を3mm2 srとすると、plasma_2はplasma_1よりも3倍ほど効率よく光を利用できることがわかる。ただし、ここでは発光点から放射された光の利用効率を問題にしているのであり、光の絶対的なパワーについては別の考察が必要である。EUV光源のパワーは集光点に対する要求であり、集光点パワーについて議論するためには、プラズマ形状、プラズマからの放射角度分布といった発光点特性に加え、集光光学系の特性(集光ミラー光学設計、ミラー反射率、構造物による損失など)を考慮した詳細な計算、あるいは集光点特性の実測評価が必要である。

図9 Xeパルス放電によるEUVスペクトルの例
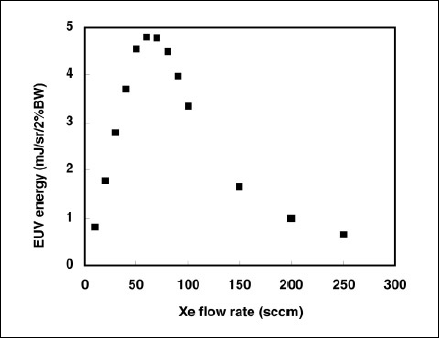
図10 EUVエネルギーのXe流量依存性

図11 EUV角度分布特性

図12 高繰り返し動作EUVエネルギー

図13 ピンホールカメラによるプラズマ像の例

図14 Xe流量によるプラズマ形状の違い
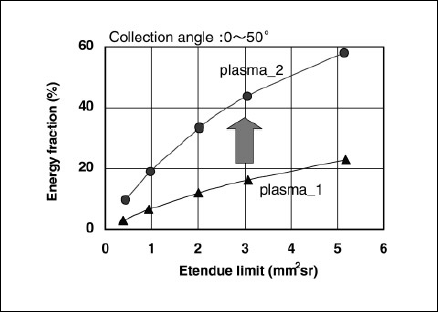
図15 エタンデュ制限内のエネルギー比率
4.3 集光点評価
1枚の斜入射ミラーを用いた集光光学系を実験システムに導入し、発光点と組み合わせて動作させたときの集光点特性を評価した。図16に集光点像撮影の実験配置を示す。集光点像は12.5nm~15nmの波長を透過するフィルタを取り付けた背面照射型CCDカメラによって撮像した。集光ミラーは5軸の位置調整装置に取り付けられており、集光点像を見ながらアライメント調整した。また、集光ミラーの保護と減光のために、集光ミラー前面に十字型のスリットが開いたステンレス板を置いた。
図17はアライメント調整後の集光点像である。十字型減光スリットがあるためx形に見えている。図18は集光点のエネルギー密度プロファイルであり、図17の集光点像から求めた実験値と光線追跡シミュレーションから求めた計算値を比較している。両者はほぼ一致しており、製作した集光ミラーの形状とアライメントがほぼ設計どおりとなっていることが確かめられた。

図16 集光点イメージ測定の実験配置
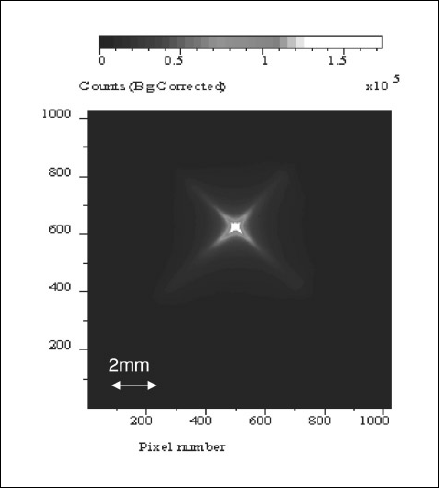
図17 CCD検出器による集光点像

図18 集光点エネルギープロファイルの実測値と計算値の比較
4.4 集光点パワーの高出力化
EUV光源の高出力化は発光点パワーの増加と集光効率の向上で達成される。EUVAでは放電電流波形の改善などで高出力化を進め、4.2で述べたようにXe放電で出力約93Wの発光点パワーを得た。この発光点と、新たに開発したネストタイプの斜入射集光光学系を組み合わせたときの集光点パワーを光線追跡シミュレーションにより計算した。プラズマサイズはピンホールカメラで実測したイメージをもとに与えた。図19に集光点における照度分布を示す。集光点に直径5mmの仮想的アパーチャを挿入して見かけのエタンデュを10mm2 srに制限したときの集光効率は約28%となった。背景ガスとデブリシールドの光透過率を72%と仮定すると、集光点パワーは93Wx28%x72%=19Wである。
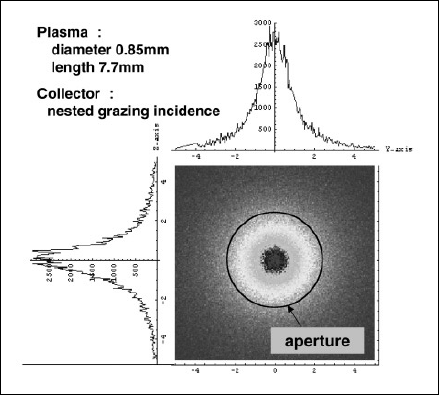
図19 集光点の照度分布計算結果
5. デブリ対策
図7で示したデブリシールド装置の効果を確認するためにSiウィットネスプレートを用いた曝露試験を実施した(図20)。10万ショット後のウィットネスプレート表面を顕微鏡観察すると、デブリシールドなしの場合は電極材料を成分とする数μm程度の粒状デブリが多数付着しているのに対し、デブリシールドを入れた場合はほとんどみられない(図21)。次に、X線マイクロアナライザを用いて粒のない部分を分析した(図22)。デブリシールドを入れることにより10万ショットの前後でプレート表面の電極材料元素濃度に有意差は見られず、デブリ遮蔽効果があることが確認された。
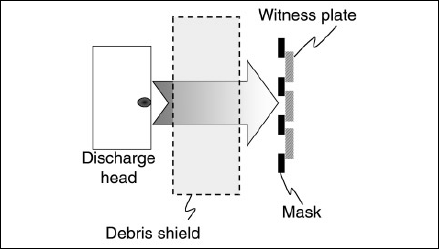
図20 デブリ遮蔽効果確認実験

図21 ウィットネスプレ-ト表面SEM写真(10万ショット曝露試験後)

図22 XMAによるウイットネスプレート曝露面の電極材料元素濃度分析
6. 今後の課題
Sn放電でXeよりも高い13.5nm変換効率が得られることが実証されている5)。EUVAでもSnを用いた原理検証実験に着手している。高出力化に関しては、高繰り返し動作に対応した安定なSn放電の研究を中心に進め、2007年末までに集光点50W以上を実証することを目標としている。
高出力化と並び、集光ミラーや放電部電極などの長寿命化が重要な課題である。集光ミラーについてはEUV光反射率の変化を評価項目とした寿命試験をすでに開始しており、反射率低下の原因が明らかになりつつある。今後は、複数のデブリ対策手段を組み合わせることで、集光ミラーの長寿命化を図る。放電部については、構造体の材質と冷却機構を改善し、耐熱性を向上させた放電ヘッドを開発中である。今後、高繰り返し動作での寿命試験を予定している。
7. まとめ
EUVAにおけるDPP方式EUV光源の開発状況について述べた。DPP光源を構成するパルス電源、放電ヘッド、集光光学系、デブリシールドなど主要コンポーネントを開発、導入し、集光点特性を測定した。今後は量産用光源に要求されている115Wを見据えた高出力化とともに、放電部や集光ミラーの長寿命化にも重点を置いた開発を進める予定である。
8. 謝辞
本研究は新エネルギー・産業技術総合開発機構(NEDO)からの委託を受け、技術研究組合EUVAにおいて行われた。ここに記して謝辞とする。



![ライトエッジ No.30 [特集号] EUV光源](./content_file/file/lightedge_30.png?_size=1)