光技術情報誌「ライトエッジ」No.30(2008年3月発行)
プラズマ核融合学会誌 Vo.81 12月号
講座 プラズマの光源応用~身近な明かりから次世代光源まで~
(2005年11月)
4.これからの光源
4.1 EUV 光源
Light Source for 21st Century
EUV (Extreme Ultra-Violet) Light Source
堀田和明(EUVA/ウシオ電機株式会社)
HOTTA Kazuaki USHIO Inc.
(Received 14 October 2005)
EUV lithography with a 13.5nm EUV (Extreme ultra-violet) light source is the strongest candidate of the next generation lithography for LSI. EUV is obtained from a high temperature and high density plasma by DPP (Discharge Produce Plasma) and LPP (Laser Produced Plasma).
Keywords:EUV (Extreme Ultra-Violet), EUV lithography (EUVL), 13.5 nm, DPP (Discharge Produce Plasma), LPP (Laser Produce Plasma), Xe, Sn, debris, debris mitigation
4.1 EUV 光源[1]
EUV(Extreme Ultra-Violet)露光は,Si LSI時代の最後の露光技術といわれ,2013年頃から量産が始まる解像線幅32nmの技術ノード以降の露光技術として本命視されています.開発が早まれば,2010年頃からの45nm技術ノードへの適用も期待されています.EUV露光は波長13.5nmのEUV(軟X線)光を使った縮小投影露光[2]です.13.5nmが選ばれたのはこの波長において高い垂直入射反射率(67%以上)を示すMo-Si多層膜があったからで,Mo-Si反射鏡により,これまでのLSI量産用露光機と同様の縮小投影露光機が実現します.Fig.1にEUV露光機と光源の構成を示します.EUV露光の開発が始まった(1986年)頃に具体的な13.5nmの光源があったわけではありませんでした.現状で,光源は,マスク,レジストと並んで,困難な開発課題です.Table1に,現時点で,EUV光源の量産時に要求される仕様と2004年末までに実現している性能を示します.この光源への要求仕様は,Fig.1の発光点(プラズマ)における性能ではなく,集光点(IF:Intermediate Focus Point)での性能です.EUV露光機における光源はプラズマ発生部,デブリシールドおよび集光光学系,などを含みます.
13.5nm EUV光の発光はXe,SnあるいはLiの高温・高密度プラズマから得ています.プラズマの電子温度は30eV程度以上が適当で,また,イオン密度は1017~1019/cm3程度です.このプラズマを得る方法としてDPP(Discharge Produced Plasma)とLPP(Laser Produced Plasma)があります.DPPでは,Fig.2(a)に示すZ-ピンチ[3]などの放電によりプラズマを得ており,LPPではプラズマ生成用ドライバレーザーをターゲットに照射することでプラズマを生成します.LPPの方が,DPPに比べ,高温高密度のプラズマが得られています.放電ガスあるいはターゲットがXe,SnおよびLiです.Xeの場合,13.5nmの発光は10価イオンの(4d-5p)遷移のみから得られます.これに対し,Snの場合は,複数価数(8~12価)のイオンの(4d-4f)遷移から得られ,Xeより高い発光効率が期待できます.LiではLi2+のLyman-α線から得られます.イオン密度を高くする必要があり,LPPでのみLiが検討されています.
DPPにおいては,Table1の量産時の出力を実現するためには,Snの採用が必須と考えられています.Snの放電を得るには固体のSnをガス化して放電空間へ供給しなければなりません.そこで,レーザー蒸発法によりSnをガス化する方法が検討されている.一例として,Fig.2(b)の回転電極にSnを塗布する方式[4]が挙げられます.また,Fig.2(a)のZ-ピンチにおいて,スタナン(SnH4)ガスを用いる方法が検討[5]されており,Xeの2倍以上のEUV発光効率を得ています.Snは後述のデブリとなって集光光学系などに固着するので,デブリ対策と固着したSnの排出が必要となります.LPPの場合,Snターゲットの工夫による高発光効率化の検討が盛んで,ドライバレーザーとして,多くの場合,YAGレーザーが用いられます[6,7].量産用光源としては,XeFエキシマレーザをLiの液滴ターゲットに照射するLPPが開発されています[8].集光光学系を400°C程度に加熱しておけばLiは固着しないので,反射率の低下がないとしています.また,ドライバレーザーの低コスト化を狙い,CO2レーザーを用いるLPPが開発されています[9].EUV露光用光源としては高発光効率による高出力化が必要ですが,むろんそれだけではなく,Table1に記した高繰り返し,高安定性,長寿命などが要求されます.中で実現困難なのは光学系の寿命(Table1のCollector lifetimeとSource cleanliness)で,その寿命をもたらすデブリの対策が非常に重要となります.デブリとはプラズマ生成時に発生する飛散物,中性原子・クラスタおよび高エネルギーイオンのことです.LPPでは,keV以上にもなる高エネルギーイオンが問題視され,磁場によるイオン偏向を用いたデブリシールドが開発されています[9].DPPの場合,電極や放電壁から飛散物が発生します.DPP用デブリシールドとして,エアカーテンとフォイルトラップの組み合わせが開発されています.デブリが光学系の反射面に付着したり,反射面を削ったりすることにより光学系の反射率が低下します.デブリの発生を低減することはもちろん重要ではありますが,発生は避けられないので,デブリから光学系を防御するデブリシールドの開発が重要な課題となります.
DPPでは,小型・低コスト・小フットプリント(設置面積)などの実用上での利点が期待されていますが,高入力化が難しく,高発光効率化や放熱の検討による高出力化が課題になります.また,デブリによる集光光学系の短い寿命(Collector lifetime)が,特にDPPにおいて重大視され,集光光学系の寿命がEUV露光の実現を危うくする(Show stopper)とまでいわれています.これに対して,LPPでは高出力化が可能ではありますが,ドライバレーザーが高コスト,広フットプリント(設置面積),大必要用力などの実用上の問題を抱えています.現状では,高出力化の点で,DPPの開発がリードしており,露光技術開発用の露光機(MET:Micro exposure tool)に搭載されています.少なくとも機まではDPPが用いられると思われています.しかし,LPP,DPPとも上記の利点,欠点があるため,これまではどちらかに選択されることはなく,開発が進められています.
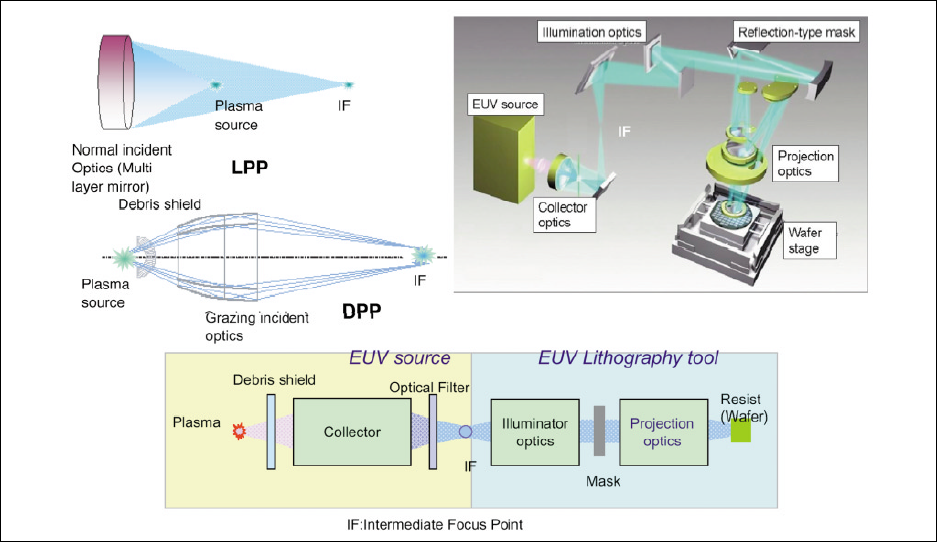
Fig.1 EUV lithography tool and sources.

Table1 EUV Source Requirements for HVM and Best Reported Values.
HVM: High Volume manufacturing, Bold: very risky, italic : risky

Fig.2 EUV sources : DPP.

authors’ e-mail: k.hotta@ushio.co.jp
J. Plasma Fusion Res. Vol.81, No.12 (2005)1007-1009



![ライトエッジ No.30 [特集号] EUV光源](./content_file/file/lightedge_30.png?_size=1)