光技術情報誌⌈ライトエッジ⌋No.30(2008年3月発行)
⌈EUV光源の開発と応用⌋シーエムシー出版
(2007年2月)
放電プラズマEUV光源(DPP)
ウシオ電機/EUVA御殿場分室
堀田 和明
EUVA御殿場分室
佐藤 弘人
1. はじめに
DPP(Discharge Produced Pasma)は、ガスの放電によるプラズマ生成で、135nmのEUV光を得る放電プラズマEUV光源である。既に、EUV露光実験用小面積露光機MET(Micro Exposure Tool)に用いられており1),2)、フルフィールド露光実験機であるα機にも搭載された3)。放電プラズマEUV光源はGDPP(Gas Discharge Produced Plasma)と呼ばれることもあるが、DPPの方が一般的で、本章でもDPPを用いることにする。DPPがMETやα機に搭載されたのは、LPP(Laser produced plasma)より出力で先行しているからで、露光用光源に要求される安定性、制御性、インターフェースなどを持つDPPの開発が進んでいる。図1に示すのは出力にみるこれまでのDPP開発の推移である。現状の実験レベルでの最大出力は後述の集光点において80W(バーストモード)で、信頼できる製品レベルでの出力は10W程度である。LPPでの現状での最大出力が4W程度であることからみて、LPPの開発に比べ、DPPの開発の進捗していることがわかる。
DPPの開発がLPPに先行している理由は、実用上での利点が期待できるからである。すなわち、LPP に比べ、LSI製造ラインへの導入に求められる小型化・低コスト(CoO(Cost of Ownership)+導入コスト)化・小フットプリント(設置面積)化および小用力(ユーテェリティ)化が実現する可能性が大きい。しかし、スケーラビリティの点で、DPPはLPPに劣り、本来、高出力化が容易でない。そのため、高入力化と高変換効率(CE:Conversion Efficiency、発光効率)化がDPPにとっての重大な課題となる。また、高入力化に伴う電源の寿命、後述のデブリによる集光光学系(コレクタ)の集光効率の低下による寿命など、部品の寿命が重大視される。DPP部品の寿命は、露光機のCoOの点から、EUV露光の実現を問うほどの重大な問題である。2005 EUVL Symposium(,05.11、@San Diego)では、EUV露光開発におけるリスクの2番目にEUV光源の部品・コレクタの寿命が挙げられ、高出力化が4番目に挙げられている。露光機メーカーは、EUV露光がLSIの量産に用いられる場合のEUV光源(量産機)に必要な仕様(ジョイントスペック: Joint spec)を提示している。このジョイントスペックでの出力は、露光光学系へのEUV光導入部である集光点(IF : Intermediate Focus Point,図2参照)での出力で、115W@IF以上(レジスト感度が5mJ/cm 2に対応)である。同じくジョイントスペックにおける繰り返し:>7-10kHz、安定性(積算):0.3%,3σ,>50pulses、寿命(Cleanliness):≥30,000hours、エタンデュmax 3.3mm2sr、最大入射角:0.03~0.2sr、スペクトル純度:<1%(130~400nm(DUV/UV)atwafer),<10~100%(400nm(IR/Vis)at Wafer)のパラメータと、当然、同時に要求されている。しかも、,'06年6月のEUV source workshop(@Vancouver)で発表されたジョイントスペックでは、レジスト感度が5mJ/cm2の実現が困難なことから、10mJ/cm2に対応する180W以上の出力が提示された。前述し た現状のDPPの出力は、115W@IFにしろ、遠い値である。さらに、レジスト感度は20mJ/cm2が必要との計算すらあり、その場合、一層大きな出力が要求されることになる。
DPPの開発は、量産機の実現に向けた新しい段階を迎え、EUV光を得るための発光ガスは、Xeから、高出力が得られるSnへと移っている。Snの13.5nmにおける発光強度(13.5nmのスペクトルバンド利用効率)は、Xeの3倍以上が期待でき、高いCEが得られるからである。後出する図12のSnとXeの発光スペクトルの比較例では、Snの13.5nmのスペクトルバンド利用効率は、Xeの4倍に近い。しかし、Snを用いるDPPにおいては、常温であるSnのガスとしての供給や固体Snデブリの防御とクリーニングなど、新しい開発課題が現出している。
ここでは、まず、DPPの構成と開発要素につき説明し、これまでのXeを用いたDPPの開発と既にスタートしているSnを発光ガスとした高出力化DPP技術の開発状況について述べる。
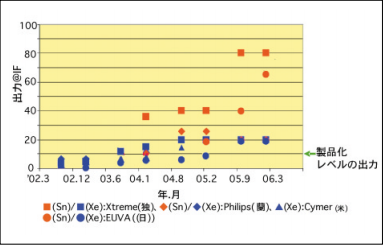
図1 DPP開発の推移
2. DPPの構成と開発要素
図2にDPPの構成を示す。DPPは放電ヘッド、ガス供給装置、パルスパワー(放電)電源、デブリシールド(DMT:Debris Mitigation Tool)、コレクタ、アパーチャからなる。加えて、図示はしていないが、コレクタの後に分光フィルタ(SPF:Spectral Purity Filter)が設けられる可能性がある。放電ヘッドにおけるプラズマ(発光点)からの13.5nmEUV光がDMT、コレクタ(SPF)、およびアパーチャを通して集光点(IF)まで導光される。集光点までがEUV光源としてのDPPであり、露光装置が必要とする出力、エタンデュ、放射角度、スペクトル純度で集光したEUV光が、集光点において、露光装置に導入される。従って、光源に要求される出力やエタンデュなどの仕様(スペック)は、前記したように、集光点における性能である。
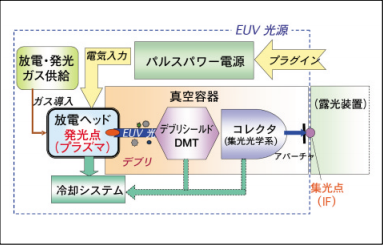
図2 DPPの基本構成
SPFを光源側に置くのか、露光光学系(照明系)に設けるかの議論があるが、光源側に置くとすると、発光点(プラズマ)での必要な出力は次式となる。
発光点パワー=集光点パワー/( コレクタ集光効率・MDT透過率・分光フィルタ透過率・残留ガス透過率)……(1)
DPPの場合、LPPに比べ、発光点のプラズマサイズが大きいのが短所で、露光機が必要とするエタンデュ(ジョイントスペックでは最大3.3mm2sr)を得るため、集光点にアパーチャを置く必要がある。露光機のエタンデュに合わせることをエタンデュマッチングと呼ぶ。ただし、後出の回転電極DPPにおいては、プラズマ径が小さく、エタンデュマッチングでの損失がない。上式(1)のコレクタ集光効率には、エタンデュマッチングでの損失を含む。この式から、コレクタ集光効率(透過率)を20%、DMTを透過率80%、ガス透過率を90%とし、分光フィルタの透過率を50%とすると、180W@IFを得るには発光点で、2.5kW/2πsrもの発光点出力が必要になる。SPFが不要の場合は、1.25kW程度と計算される。
プラズマ(発光点)から、このような高出力を得るためには、まずは、放電ヘッドにおいて高いCEが必要となる。CEは次式で示される。
CE=(発光点でのEUV発光エネルギー/2πsr)/放電入力エネルギ…………………………(2)
式(2)において、分子は立体角2πsrあたりのEUV発光エネルギーである。実際のDPPでは、2πsrと広い放射角は得られないので、2πsrに換算した値を用いる。分母の放電入力エネルギーは、後出の図3の電源回路におけるCfから放電ヘッドに入り込むエネルギーで、厳密に言えば、放電に費やされるエネルギーだけではなく、放電の最終段MPCと放電ヘッド部を含む放電回路での抵抗で消費されるエネルギーが含まれる。高CE化は、DPPの実用化にとって、不可欠である。高CE化は、高出力化のためだけに重要なのではない。高CEであれば、同じ出力を得るにも低い入力で良いため、放電ヘッド(主として、電極)の寿命がより長くなる。高CE化のためには、前記したように、発光ガス(燃料(Fuel))として、従来のXeに代わり、13.5nmのスペクトルバンド利用効率の高いSnの使用が必然となっている。しかし、Snは常温で固体であるため、Snガスとしての放電空間への供給方法が開発課題になる。また、放電ヘッドにおけるEUV光発生のためのプラズマの作り方、すなわち、放電ヘッドの構造、放電電流のピーク値、パルス波形および放電ガスの流量(ガス圧)、ガスの流し方、などの検討による高CE化も、当然、不可欠である。ただし、高いCEであっても、プラズマサイズが大きいと、後述のように、コレクタで集光効率が悪くなる。そこで、放電ヘッドには、CE×集光効率の最大化が求められる。高出力化には、高CE化と共に、高放電入力化が必要である。そのためには、放電ヘッド(主として、電極)における熱負荷低減を目的とした除熱が必要になる。EUV光源には露光の制御性から高繰り返し動作が要求される。量産時のジョイントスペックでは、前述のように、繰り返し7~10kHz以上が提示されている。この高繰り返し動作の実現のためには、上記の放熱と次に記す高繰り返し電源の開発が必要となる。放電ヘッドにおけるプラズマの作り方、高CE化、高入力化(放熱)などのついては、3節および4節で述べる。
DPP用高繰り返し電源には、図3に示すような、半導体スィッチと磁気パルス圧縮器(MPC:Magnetic pulse compressor)を組み合わせた全固体化電源が用いられる。半導体スィッチとしてIGBTが用いられることが多いが、スィッチング速度が速くないので、図のように、放電ヘッドにおいて必要なパルス幅数100nsの放電電流を得るため、多段のMPCが用いられる。また、半導体スィッチの耐圧は高くないので、昇圧のためパルストランスを用いることが多い。図3の電源回路においては、最終段MPCと放電ヘッドを含む放電回路の抵抗と浮遊インダクタンスを極力小さくしないと、電源(Co)からの放電ヘッドへのエネルギー移行の効率が悪くなる。繰り返しについては、エキシマレーザー用として全固体電源が開発されているが、最高繰り返しは6kHz程度で、電源の10kHz程度までの高繰り返し化の実現の可能性はあるが、それ以上の高繰り返し化は困難な開発課題になる。
発光点であるプラズマからは放電による高エネルギーイオン(KeV以上)を含むデブリが発生するので、デブリ防御のためのDMTは不可欠となる4)。すなわち、デブリがコレクタに付着あるいは衝突するとコレクタの反射率が低下するので、コレクタの長寿命化からDMTの役割は非常に重要である。DPPにおいては、図4に示すようなフォイルフィルタにHeなどのガスカーテンを組合せたDMTが開発されている。図のフォイルフィルタでは、中心から放射状に多数のフォイル(Foil:薄い金属板)を植え付けている。このDMTは、プラズマから発生するデブリをガスカーテンで曲げることにより、フォイルフィルタのフォイルに当て、コレクタの手前でトラップ(捕獲)しようという考えで提案されている。フォイルフィルタでは、図のように、中心から放射状に多数のフォイル(Foil:薄い金属板)を植え付けている。フォイルフィルタには、デブリ防御のための高収集(捕獲)性能が要求されるが、一方で、それに相反するEUV光の高い透過率が求められる。従って、DMTでの100%のデブリ防御は困難である。また、フォイルフィルタでは、放電ヘッドのプラズマからの光や熱輻射で高温になるので、放熱が必要である。
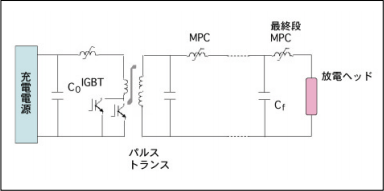
図3 DPP用全固体高繰り返し電源

図4 フォイルフィルタ
DPPのコレクタとして、図5に示すような、多数枚の斜入射反射鏡(シェル)をネスト構造に重ねた斜入射光学系が用いられる5),6)。斜入射反射率は入射角が浅いほど高いので、一つ一つのシェルにおける入射角を浅くした多数枚のシェルが必要になる。多数枚のシェルを用いるのは集光点での集光像の均一性を良くするためでもある。同じく入射角を浅くするため、斜入射反射鏡として、楕円面と双曲面の反射面で2回反射を行うウォルタタイプ(Wolter mirror)が用いられることが多い。内面が反射面となる斜入射光学系のシェルの製作には、型(マンドレル)を用いた電鋳法(Electroforming)と呼ばれる特殊な方法が用いられる。詳細は文献5)を参照して欲しい。シェルの基板はNiで、反斜面の金属として高い斜入射反射率を示し、化学的に安定なRuが選ばれる。コーティング材料に加え、反射面の表面粗さも斜入射反射率を決める主たる因子で、1nm(rms)程度が必要となる。コレクタには発光点からのEUV光とその波長域外の光が入り、また、DMTのフォイルフィルタから熱が伝わるので、高温となる。その場合、コレクタの反射面形状が変形する恐れがあるので、コレクタからの放熱が重要である。また、コレクタには集光点での集光像の均一性も問われる。上記の多数枚シェルのウォルタタイプを用いるのは、集光点での集光像の均一性を良くするためでもある。現状で、コレクタを用いた場合の集光点出力は、計算値に比べ、実際の値が低いことが問題視されている。発光点から集光点に導光する場合の諸検討、プラズマサイズ、DMTの透過率、コレクタの集光効率、などの正確な検討とIFでの出力測定法の確立が必要である。
DMTにおいて、上記のように、100%のデブリ防禦はできないことから、Snを使ったDPPにおいては、コレクタに付着したSnを剥離して集光効率の回復を図るというクリーニング技術の開発が大いに期待されている2)。Snと水素ラジカルや塩素と反応させて水素化物あるいは塩化物にし、ガス化して取り去ろうとするものである。
所望のスペクトル純度を得るため、上記のように、SPFが必要になる可能性が大きい。露光光学系に13.5nm帯域外(OoB:Out of Band)の光である深紫外/紫外光(DUV/UV:130~400nm)および可視/赤外光(IR/Vis:≥400nm)が入るとレジストが感光し、マスクの像にぼけ(フレア)が生じるからである。ジョイントスペックでは、前述のように、DUV/UVおよびIR/VisのOoB光強度のEUV光に対する比率が決められている。SPFを光源側に置くとすると、発光点でその損失分だけ大きな出力が必要となる。一方で、露光光学系にSPFを設ける場合は、その損失に見合う大きなIF出力が要求され、結局は大きな発光点出力が必要となる。'05年11月に開催されたEUV source workshop(@San Diego)において、発光点側に置くSPFとして薄い吸収フィルタ(Zr-S(i 厚さ<60nm)のmechanical filter)が、また、露光光学系側用として照明系のMo-Si多層膜鏡上へ形成するDUV無反射膜が報告された。前者の場合、耐久性(耐熱性)が問題になり、光源側からは露光光学系への設置が望まれている。
図6には上記したDPPの主な開発課題をまとめる。
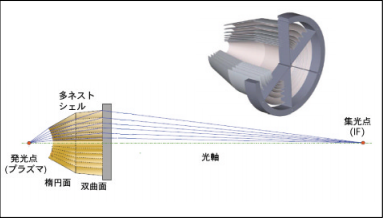
図5 DPP用コレクタ-多ネストWolter Mirror
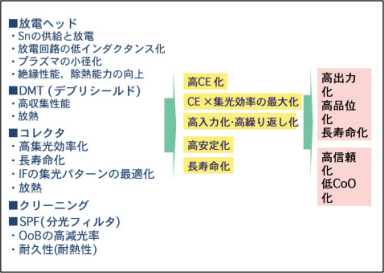
図6 DPPの主な開発課題
3.ピンチ放電DPP(これまでのXeを用いたDPPの開発)
最初の放電を用いるEUV光源すなわちDPPにおいては、キャピラリ放電(後述のピンチ放電ではない)を用い、ジュール加熱(放電抵抗×(放電電流)2)により、Xeの13.5nmEUV光を得ていた7),8)。しかし、キャピラリ放電では、放電の熱によりキャピラリ壁が溶融するため、高入力化が困難で高出力を得るのが難しく、また、デブリの発生が問題視された。そこで、キャピラリDPPは、それ自身の開発は中断したが、放電プラズマによるEUV光源の実現の可能性を示し、その後のピンチ放電を用いるDPPの開発に発展していった。それまでは、EUV光源としてLPPのみが開発されていた状況で、放電プラズマによりEUV光を得ようとした発想は特記すべきものである。
ピンチ放電とは、大電流で発生する自己磁場によりプラズマが収束(ピンチ)する放電であり、電子温度30eV程度で、イオン密度10 17~10 18/cm2程度の13.5nmの発光に適するプラズマが得られる。LPPに比べると、電子温度が低いのが特徴である。一般に、電子温度が高い場合は短波長側の発光スペクトルの強度が強くなる。そこで、電子温度が高いLPPにおいては、Xeの13.5nmの発光強度が11nmの1/5程度以下と低い。しかし、電子温度が低いDPPでは、後出の図12におけるXeの発光スペクトルで判るように、13.5nmで11nmと同程度の発光強度が得られている。図7に、開発された3方式のピンチ放電DPP、Z-ピンチ方式9),10)、Hollow cathode triggered plasma(HCT)方式11)およびDense plasma focus(DPF)方式12)を示す。図7(a)のZ-ピンチ方式では、円筒(放電管)の軸方向に大電流を流し、放電を径方向にピンチさせる方式で、放電管壁があるため、ピンチ放電が比較的安定にできる。ただし、高入力(高繰り返し)動作においては、放電の熱による壁の溶融(デブリの発生)を軽減させるため、放電管径を大きくし、また、ピンチ放電の小径化して、ピンチ放電を壁から離さなければならない。ピンチ放電の小径化には予備電離と比較的長いパルス(300ns程度以上)の放電電流が必要である。図7(b)のHCTは、(a)の放電壁をなくした方式と見なすことができる。放電壁をなくすことにより、高繰り返し化や低デブリ化を目論んでいる。この方式では、ガス圧をパッシェンカーブの左側になるようにして、最初に間隔が長いホロー電極の底面(図のB)と陽極で放電を起こし、その放電がトリガー(予備電離の役割)になり、間隔が短い陰極の上面(図のC)と陽極でピンチ放電が起こしている。図7(c)のDPFは、中心のホロー電極上にピンチプラズマを浮上させる方式である。核融合用などに開発されたDPFにおいては、ピンチプラズマの空間的な位置の不安定性が問題になっていたが、EUV用では、印加電圧の高速立ち上がり化により問題を解決している。図ではホロー電極を陽極にしているが、開発の後半ではホロー電極を陰極に変え、予備電離なしでも安定なDPFが得ている。HCT、DPFとも、高CEが得られるSnの放電が難しいとの理由からか、高出力化、長寿命化が困難と判断され、開発は中断している。
本章の冒頭で紹介した図8のMETに搭載されているのが図9に示すXeを用いたZ-ピンチ方式のDPPである13)。発光点出力35W/2πsr@1kHzで、6枚シェルのコレクタを用いた時の集光点出力は出力3W@IF以上(エタンデュ3.3mm2sr)である。また、DMTにより100Mpulse(100×106)でもコレクタの反射率の劣化が見られないと報告されている。MET用に続き、アルファ機用としてもXeを用いたZ-ピンチ方式DPPが開発されている。発光点出力の繰り返し特性を図10に示す。最大発光点出力は、4.5kHzの繰り返しで、200W/2πs(r 10~20W@IF程度)である13)。
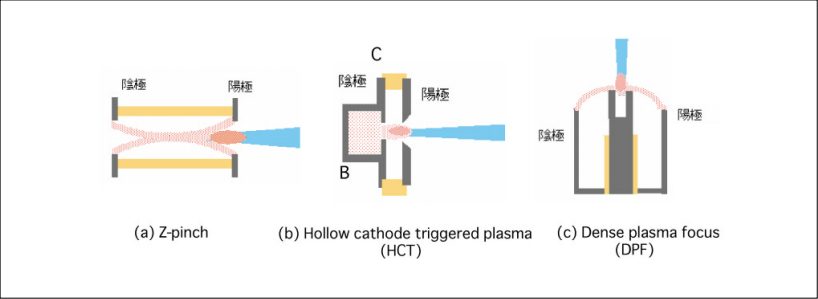
図7 ピンチ放電DPP

図8 Xe Z-ピンチDPPを搭載したMET (Xtreme)13)
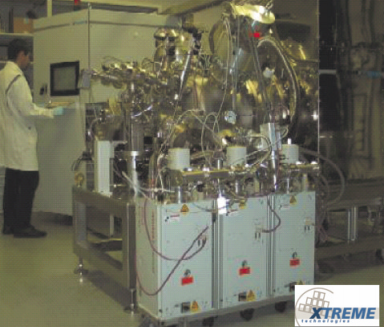
図9 Xe Z-ピンチDPP (コレクタを具備、Xtreme)13)

図10 Xeを用いたZ-ピンチDPPの繰り返し特性(Xtreme)13)
4.DPPの高出力化(Snを用いたDPP)
高出力DPPを実現するには、先ず、高CEを得るためのSnガスの使用が不可欠であり、前述したように、常温で固体あるSnのガス化、すなわちSnガスの放電空間への供給が課題となる。その課題を解決して開発されているのはスタナン(SnH4)ガスを用いたZ-ピンチDPPであり、また、レーザーによるSnの蒸発を用いる回転電極方式DPPである。
4.1 スタナン(SnH4)ガスを用いたZ-ピンチDPP
スタナンと呼ばれる水素化スズ(SnH4)をSnガスの供給のために用いるDPPが提案され14)、スタナンを用いたZ-ピンチDPPの開発が進んでいる15)。スタナンはガスの状態で用いることができることから、Xeと同様に流量計を用いて流量の制御ができ、従って、CEが最大になるような流量(ガス圧)に制御ができる。この点がスタナンの用いることの利点である。既に、Xeの2~3倍のCE、kHzレベルの安定高繰り返し動作の可能性を実証し、発光点パワー645W/2πsr@5kHz(集光点54W(エタンデュ3.3mm2sr)に相当)を実現している。
図11はスタナンを用いたZ-ピンチ方式の放電ヘッドの構造で、図2に示したような半導体スィッチングと多段のMPCを用いた電源回路に取り付けている。最終段MPCと放電ヘッド部を含む放電回路のインダクタンスの低減、放電ヘッド部の絶縁性能の改善、除熱能力の向上、また、スタナンの放電領域への供給法の改善を行うことにより、高繰り返し動作においても安定したSnの放電の生成が可能となった。この結果、得られた発光点出力は上記の645W/2πsrで、CE=1.7%/2π、繰り返し周波数5kHz、強度安定性16.7%(pulse-to-pulse、1σ)を実現している。このCEは、2節で述べたように、放電に費やされるエネルギーから計算された値と出力エネルギーから計算した値である。放電入力エネルギーからは3%程度の発光効率であると推測される。図12にスタナンを用いた場合のSnの発光スペクトルをX e の場合と比較して示す。先にも述べたが、13.5nm±2%バンド幅での利用効率はXeの4倍に近い。発光点出力の繰り返し周波数特性は、図13に示すように、5kHzまでほぼ直線的に増加している。図14には、ピンホールカメラを用いて実測したプラズマ形状を示す。プラズマサイズは、2節で述べたように、コレクタの集光効率を決める重要な特性である。このプラズマサイズ、などから算出した集光点出力と発光点出力の比を図15に示す。エタンデュ3.3mm2srにおいては約54W@IFである。このとき、コレクタの集光効率にDMTの透過率を加算した値は9.3%で、ガス透過率は90%とした。
スタナンを用いたZ-ピンチDPPにおいては、Xeの2~3倍程度の出力が得られ、5kHz以上の高繰り返し動作で、50W@IFが可能であることが判った。また、さらなる電極構造と放電回路パラメータの改善および電源の高繰り返し化により、総合性能(発光点出力、プラズマサイズ(→集光効率)、強度安定性および寿命)に優れるDPPの実現の可能性は大きい。問題は電極の寿命である。必要とする出力が得られる放電入力で、どれだけの電極寿命が得られるかを見極めなければならない。しかし、次に紹介するレーザーを必要とする回転電極方式DPPに比べ、シンプルな構造のZ-ピンチDPPであり、コストや信頼性の面で期待される。
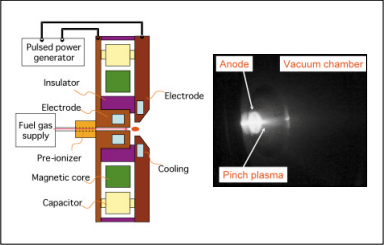
図11 スタナンを用いたZ-ピンチ方式の放電ヘッドの構造とプラズマ(EUVA)15)

図12 SnH4を用いたZ-ピンチの発光スペクトル-Xeとの比較- (EUVA)15)
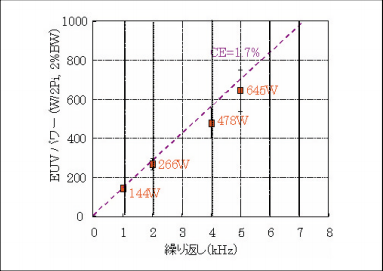
図13 発光点出力の繰り返し特性(EUVA)15)
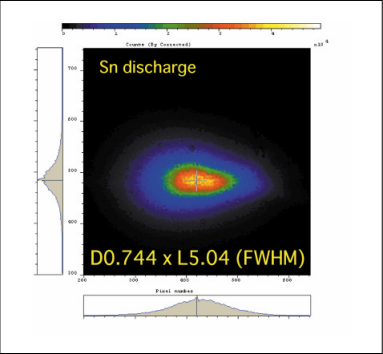
図14 ピンホールカメラで実測したプラズマ形状(EUVA)15)

図15 集光点出力と発光点出力の比(EUVA)
4.2 回転電極方式DPP
高CE化のためのSnの放電と電極の長寿命化を目的に回転電極方式DPPが提案され16)、図16(a)13)および(b)3)に示す2方式の回転電極方式DPPが開発されている。回転電極方式DPPとはレーザーをトリガーあるいはアシストとして用いた真空スパーク放電(Vacuum spark discharge)によるDPPである。回転電極に塗布したSnにレーザー(波長1.06μmのYAGレーザー)を照射し、蒸発させ、そのSnガスの放電によって真空スパーク放電を生起させることで、SnからのEUV光を得ている。回転電極で電極の長寿命化が期待できる理由は、電極面積が広いため熱拡散が大きく、単位面積あたりの熱負荷を低減できるからである。もう一つの理由は、電極を回転させることで電極表面へのSnの連続的な塗布が可能となり、そのため、放電により劣化した電極面を修復、再生できることにある。
回転電極方式DPPには、入力を大きくするとCEが減少するというスケーラビリティに関する問題がある。この問題は、以下の考察から、真空スパーク放電を用いていることに起因すると思われる17)。真空スパーク放電とは主に陰極点から供給される金属蒸気がプラズマ化される放電であるから、真空スパーク放電を用いる回転電極方式DPPでは、EUV発光に寄与するSnは陰極点から供給される。この場合、放電入力(放電電流)を大きくしていくと、陰極点からのSn蒸気の供給が不足していき、陽極点が形成され、陽極からもSn蒸気が供給される。しかし、100ns程度の短パルスでの陽極点が充分に形成されるかは不明である。もし、Snの供給のほとんどが陰極点からなされるものと仮定すると、放電電流を大きくするに従い、Snの供給が不足していく。その場合は、高い価数のSnイオンが増加し、逆に、EUV発光に寄与するSnのイオンが減っていき、CEが減少すると考察される。また、陽極点を形成するためにはエネルギーが必要で、そこで、たとえ、陽極点からのSnの供給がなされたとしても大電流化に伴い、CEは減量していくと考えらえる。なお、真空スパーク放電ではSnが電極から供給されるから、レーザーは真空スパーク放電を得るためのトリガーあるいはアシストで、レーザーのエネルギーの大きさは重要ではないと思われる。ただし、レーザーエネルギーが余りに低すぎると、初期の放電を維持できず、陰極点が持続しないことが考えられる。
図16(a)の回転電極方式はRDE(RotatingDiskElectrode)と呼ばれている。図17は入出力特性と入力のよるCE特性である。入力2.2JまではCE=2.5%を維持し、ほぼ直線的に出力は増えている。図18はピンホールカメラ用い計測したプラズマサイズである。電極間方向に長く、横方向には短いが、充分に小さく、エタンデュマッチングによる損失はない。図示はしていないが、入力が2.2Jを超えると急激にCEが減少していると報告されている。この高入力にした場合のCEの低下は、先に述べたように、真空スパークを利用していること起因すると思われる。入力2.2Jで発光点55mJ/2πsr/pulseの出力を得たとして、ジョイントスペックの115W@IF(JointSpec)を得るためには、集光効率15%でほぼ14kHzの高繰り返し動作が必要となる。180W@IF(JointSpec)の場合は22kHzの高繰り返し動作が必要となる。従って、現状のRDEでは、量産時に必要とされる出力115W@IFはまだしも、180W@IFを実現することは非常に困難である。そこで、RDEにプラスする新しいコンセプトの創出による170mJ/2πsr以上の発光点出力(繰り返し7kHz)の実現が必要としている。
図16(b)はもう一つの回転電極DPPの概念図である。図19は発光点での入出力特性で、200W/2πsrが得られている。この発光点出力の10~15%の20W~30W@IFを集光点出力と見積もっている。図20はプラズマサイズで、やはり、エタンヂュマッチングでの損失はない。また、電極は»2blin(109)shotの動作でダメージがないと報告されている。このDPPは、図21に示すように、現在、α露光機搭載用(実用機)として開発されており、プラズマ位置安定性、ドーズ量の制御と安定性、日レベルの長時間運転性、デブリの発生制御とクリーニングによるコレクタの長寿命化、など考察が進んでいる。
06年6月のEUV sourceworkshopにおいて、回転電極方式では、115W@IF実現の可能性はあるが、180W@IFは困難であると強調された。このように出力に限界があるのは、上述したように、真空スパーク放電に起因すると考えられ、そこで、新しいコンセプトの創出とさらなる開発リソースが必要となる。
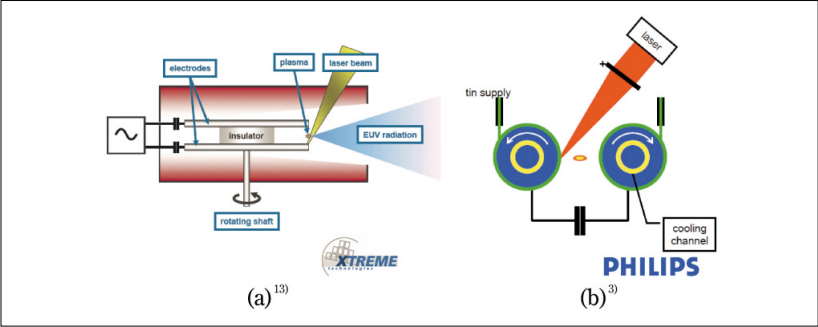
図16 回転電極方式DPP
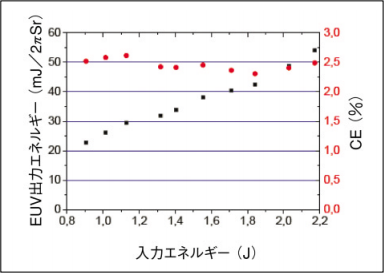
図17 回転電極方式DPP(a)の入出力特性とCE(Xtreme)13)

図18 回転電極方式DPP(a)のプラズマサイズ(Xtreme)13)

図19 回転電極方式DPP(b)の入出力特性(Philips)3)

図20 回転電極方式DPP(b)のプラズマサイズ(Philips)3)

図21 回転電極方式DPP(b) (Philips)3)
5.DPPの開発のまとめ
発光ガスとしてXeを用いる3方式のピンチ放電 DPP、Z-ピンチ方式、Hollow cathode triggered plasma(HCT)方式およびDense plasma focus(DPF)方式DPPが開発された。この中で、HCTとDFPの2方式の開発は中断されたが、Z-ピンチDPPがMET用として既に製品化され、また、α機用として開発されている。現状での信頼できる実用機レベルの出力は10W@IFである。
量産時に必要とされる115W@IFの実現には発光ガスとして高CEが得られるSnガスの使用が必然となり、現状で、スタナン(SnH4)を用いるZ-ピンチDPPと回転電極DPPが開発されている。しかし、前者では電極の寿命が問題になり、後者には高入力の場合CEが減少するという問題がある。本章の冒頭で紹介したように、露光機メーカーが提示する最新のジョイントスペックでは、量産機対応の光源の出力はこれまでの115W@IFから180W@IFと跳ね上がった。このような状況では、DPPの開発に新しいコンセプト(ブレークスルー)の創出が必要となる。また、CoOの点で、デブリの防禦とクリーニングによるコレクタの長寿命化も重大な課題である。さらに、それら課題の解決の後には、露光用光源としてのLSIの製造ラインに導入可能な信頼性、ユーティリテ(用力)、フォットプリント、使い勝手、そして、導入コスト、CoO(Cost of Ownership)、などの仕様を実現するための開発が控えている。
露光用エキシマレーザーの開発を振り返ってみると、LSI製造ラインからの厳しい要求仕様を次々と実現してきたことが判る。露光用エキシマレーザーの開発当初の1997年頃では想像できなかったほどの出力、繰り返し、スペクトル線幅、などを実現している。現状で、EUV露光機のLSI量産ラインへの導入は2013年頃と考えられているので、露光用エキシマレーザーと比べ、DPPの開発時間はいかにも短い。しかし、EUV露光の実現の向けEUV光源メーカー、露光機メーカーそしてLSIメーカーが一体になることにより、DPPの量産時に必要とする仕様を実現していくことと確信している。
謝辞
本章の中には新エネルギー・産業技術総合開発機構(NEDO)からの委託を受け、技術研究組合EUVAにおいて実施されたDPPの研究結果が含まれる。また、本章をまとめるにあたり、EUVA御殿場分室の研究員の協力を得ました。さらに、東京工業大学総合理工創造エネルギー専攻の堀田栄喜教授にご教示いただきました。皆様方に感謝いたします。



![ライトエッジ No.30 [特集号] EUV光源](./content_file/file/lightedge_30.png?_size=1)