光技術情報誌「ライトエッジ」No.35(2011年8月発行)
2011マイクロマシン/MEMS技術大全(電子ジャーナル)
(2011年5月)
ウシオの露光装置
田中秀尭
1. はじめに
MEMSは、携帯機器、自動車、医療、環境などのアプリケーションに幅広く拡大している。それに伴い、露光装置へのニーズも多様化している。マイクロマシン・MEMSと一口に言っても多種多様なデバイス構造がある。また、生産数量の幅は、開発・少量試作から、月産数万枚規模の量産まで多様化している。それらに対して、当社は最適な選択肢を提供すべくラインナップを拡充してきた。特に3次元加工、両面加工に適しており、且つ量産性を重視してマスクとワークが非接触である一括投影露光装置を中核として、各種センサ、プリンタヘッド加工、水晶振動子などの量産、および開発・MEMSファウンドリー向けにそれぞれに最適にカスタマイズした装置を多数納入している。
本稿では、MEMSに求められる露光性能・機能を整理するとともに、当社の露光装置のラインナップと特長を紹介する。
2. 露光方式について
各種露光方式を(図1)に示す。①コンタクト・プロキシミティ ②一括投影露光 ③分割投影露光 の3種類に大別される。露光装置の性能(解像性能・重ね合わせ性能)や生産性(処理能力・装置コスト)は、露光方式によって大きく左右される。
①コンタクト・プロキシミティ
装置構成がシンプルなため低イニシャルコストであることがメリットである。露光性能は、コンタクト露光で解像力1µm、アライメント(表面)精度±1.0µmを達成する。但し問題は、マスク・ワークが接触或いは近接するため、量産向には、マスクへの異物付着、連続欠損防止などへの考慮が必須である。
②一括投影露光
深い焦点深度を持ったレンズ光学系設計を採用した場合、段差露光、高アスペクト露光が可能となる。焦点深度サンプルを(図2)に示す。解像力は、露光面積や露光波長などによって異なるが、Φ8インチを全面一括露光する場合おおよそL/S=3µmである。またマスク・ワーク非接触のため、マスクダメージが発生せず、高い歩留まり、生産性を得られる。
③分割投影露光
高い解像力、アライメント精度を有した縮小投影ステッパに代表される。但し、露光面積は小さく、焦点深度も浅い。
上の3方式の性能比較を(表1)に示す。
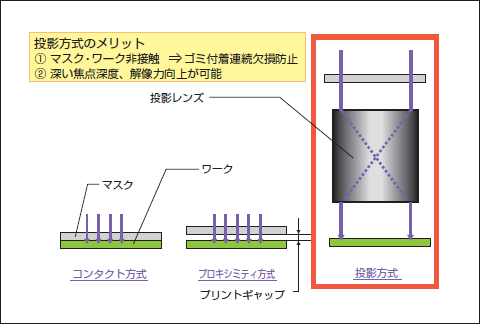
図1.露光方式比較図
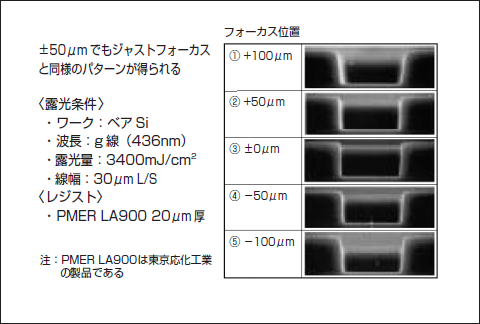
図2.焦点深度サンプル

表1:露光方式による仕様・コスト概略比較表
3. MEMSに求められる露光性能・機能
MEMSデバイスの中には、3次元加工、両面加工、高精度の表裏パターンの重ね合わせ、ワーク基材のそり・伸縮・特殊材質など、通常の薄膜Siデバイスとは異なる要求が多い。それぞれについて露光装置としての対応について述べる。
3.1 3次元加工
代表的には、段差露光および高アスペクト露光がある。200µmの段差パターンを(図3)に示す。パターンの上面・下面にパターン形成するためには、深い焦点深度を持った投影光学系が必要である。従来のプロキシミティ露光の場合との比較を(図4)に示す。プロキシミティ露光方式には焦点深度がないため段差露光には適さない。

図3. 3次元加工(200µm段差パターンへの解像例)
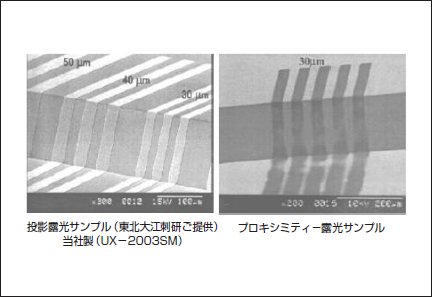
図4. 段差露光(プロキシミティ VS 投影露光方式)
3.2 両面加工
デバイスの両面に加工を行う場合、両面同時露光方式が量産に最適である。
デバイス表裏面に露光するパターン(上下マスク)同士をあらかじめ位置合わせし、基板両面を同時に露光する。両面を一括で露光するため、表面・裏面を各々露光する場合に比べ、工程が半減し生産性が向上する。さらに、表面・裏面マスク同士を予めアライメントし合わせるため、重ね合わせ精度が向上するメリットもある。
3.3 重ね合わせ精度の向上
総合重ね合わせ精度には以下の3点が関係する。
- ① アライメント(パターンマッチング)精度
- ② 露光ステージの精度
- ③ 投影光学レンズの歪
上記それぞれの精度向上により、総合重ね合わせ精度±1µm以下を一括投影露光装置でも対応できるようになった。
4. 当社の露光装置ラインナップと特長
求められる性能(解像力、重ね合わせ精度、生産性)及びコスト要求に応じて最適な露光方式を提供している。
4.1 コンタクト・プロキシミティ露光装置(UX-1及びUX-3シリーズ)
- ① ハードコンタクトモードで、解像力1µm(ポジ1µm厚レジスト)を達成
- ② 線幅安定性は、L/S=5µm寸法に対して、±3%(±0.15µm)を達成(真空コンタクト、ポジ型液状レジスト1µmt、面内20点測定)
- ③ 処理能力 毎時120枚(2ndアライメント)を達成
- ④ 開発・少量試作用のマニュアルアライメント・搬送系のUX-1シリーズ
- ⑤ 量産向けオートアライメント、オート搬送系のUX-3シリーズ
4.2 一括投影露光装置(UX-2及びUX-4シリーズ)
- ① 深い焦点深度(DOF±50µm)設計
- ② 大面積一括露光 (最大Φ8インチ一括露光)
- ③ 総合重ね合わせ精度±1µm(Φ8インチ全面一括)
- ④ 高スループット 120枚/時以上(2ndアライメントにて)
4.3 分割投影露光装置(UX-7シリーズ)
- ① 総合重ね合わせ精度 ±0.5µm一括投影露光装置(UX-4)よりも更なる位置合わせ精度向上ニーズに対応
- ② 最大ウェハ径 Φ12インチに対応WL-CSPなどのパッケージに対応可能
- ③ 一般の1/5縮小投影ステッパの4倍のショットエリア(□44x44mm)を確保
- ④ フットプリントは、一般的なコンタクト露光装置と同等を達成(2.2m2 Φ8仕様)
- ⑤ 一般的なステッパでは対応困難な裏面アライメントが可能
5. その他露光周辺技術
歩留まり向上、生産性向上オプションに以下を有する。
5.1 マスクライブラリ・オートチェンジャ
フォトマスク交換を自動化し交換時間削減、コンタミ低減
5.2 フォトマスクの半永久的使用、ペリクル付マスクを使用可能
5.3 超高圧水銀ランプ
当社は露光用ランプの最大手メーカとして供給している。露光量の大きい厚膜レジストに対して、露光タクトを維持向上するため、4.3kWの高出力ランプの選択が可能である。
以 上



