光技術情報誌「ライトエッジ」No.36〈特集ウシオの新しい取組み第一回〉
次世代半導体のEUV光源を用いたリソグラフィ法
(2012年3月)
(2012年3月)
EUV露光用LDP光源技術
笠間 邦彦
1. はじめに
EUV露光(Extreme Ultraviolet Lithography: 極端紫外線露光)は13.5nm軟X線を露光光とするリソグラフィ技術で、32nmhp以降の微細パターニング手法として期待されている。図1に32nm以降のリソグラフィ技術とデバイス開発ロードマップを示す。この世代のリソグラフィ技術の候補として、ArF液浸ダブルパターニング(DPT)とEUV露光が挙げられる。EUV露光はシングル露光であり、実現できれば工程数、プロセス信頼性およびコストの点で有利である。2010年末から順次、6台のβ露光装置(ASML製)がデバイスメーカへ導入されており、デバイス試作検討が行われている。現状では、デバイス生産適用開始が2013年、本格量産適用は2015年ごろと想定されている。しかしながらEUV光源高出力化、EUVマスクインフラ準備およびEUVレジストのRLS(Resolution、Linewidth-Roughness、Sensitivity)トレードオフなどの課題がある。そのため、ArF液浸DPTの検討も並行して進められている。しかしDPTにも多くの課題がある。Pitch-Splitting-DPTでは特に分割パターンの位置精度確保が厳しく、いまだデバイス適用例は無い。一方、Spacer-DPTはレジスト側壁膜を用いる手法で、NANDフラッシュに実際に使用されている。しかしパターン制限が厳しく(基本的にL&Sのみ)、工程数、マスク枚数(不要パターン除去のためのトリミングマスク、周辺回路用マスクなどが追加)が増大する。いずれのDPT手法も、長TAT(Turn Around Time)でコスト増を招く。EUV露光の開発進捗に比べ、NANDフラッシュは微細化が早く、当面はSpacer-DPTが適用されると見られているが、DRAMやロジックデバイスでは複雑な2次元パターンから、解像性が高くシングル露光であるEUV露光の実現を期待する声が高い。1,2)
ウシオ電機(株)では、その子会社である独XTREME Technologies GmbHとともに、EUV露光の最も重大な課題の1つであるEUV露光用光源の開発を行っている。現在、光源として、2つの光源方式が開発中であるが、ウシオ電機が検討しているのはLDP(Laser assisted Discharge Plasma)光源方式と呼ばれる。3) 本稿では、LDP光源の開発状況を、別方式であるLPP(Laser Produced Plasma)光源方式と比較し紹介する。4)
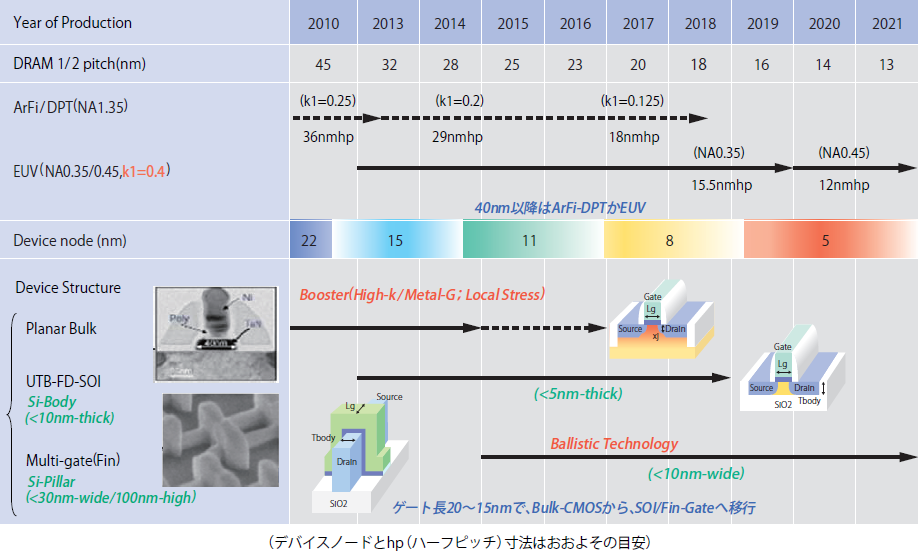
図1. デバイス微細化とリソグラフィ技術
2.EUV露光システムの構成
図2にEUV露光装置の構成を示す。13.5nmは空気中で吸収されるため、露光光学系は真空に保つ必要があり、真空中での高精度ステージ動作が求められる。EUV光源はプラズマ発生部とそのプラズマから13.5nm光を集光するコレクタからなる。プラズマを発生する方式には、前述のようにLDP光源とLPP光源の2方式がある。露光光学系は13.5nm光に透明な光学材料が無いため屈折系は採用できず、MoSi多層膜ミラーからなる反射投影光学系になり、また波面収差に対する非球面平坦性に対する要求も厳しい。マスクも同様に、MoSi多層膜基板を用いた反射マスクとなる。更にレジストの感光機構は従来の光露光と異なり、ベース樹脂による“吸収”→“2次電子発生”→“2次電子拡散と酸発生剤と反応”による酸生成がメインとなる。従って、ベース樹脂の透明性の問題は無いが、EUV露光に適したレジスト材料設計が必要になる。
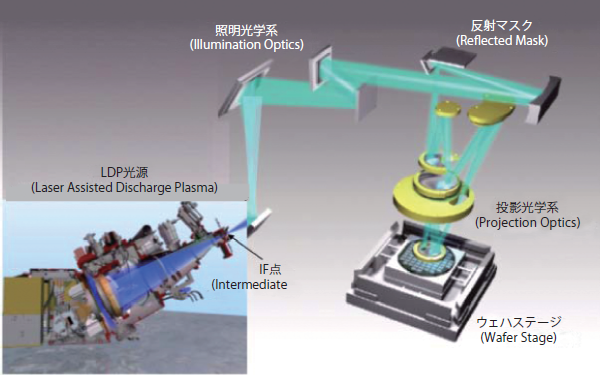
図2.EUV露光装置の構成
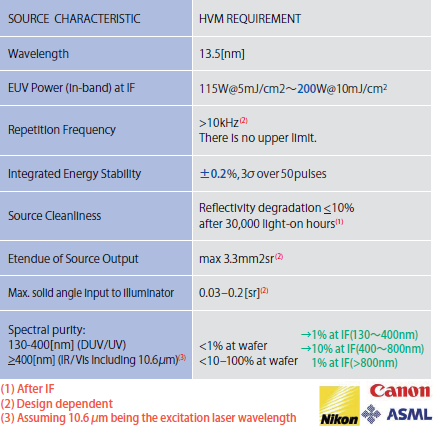
表1.EUV光源の要求性能(露光装置メーカからのJoint Requirements)
3.EUV光源の要求性能とLPPおよび LDP光源の特徴
表3.1に、露光装置メーカから要求されている光源仕様を示す。5)ここで中間集光点(IF:Intermediate Focus)はプラズマから生じたEUV光が一旦、集光される位置である。IF点から先は露光光学系であり、光源の強度等の諸性能はIF点で評価される。露光スループット、100ウェ ハ/時間を達成するには、IF点出力>200Wが必要とされる(レジスト感度10mJ/cm2)。積算ドーズ安定性は+/-0.2%、光源が及ぼす露光光 学系への汚染・損傷の問題が無いこと(30,000時間の積算露光で、10%以下のマスク・ミラー反射率低下。通常の稼働では、10年程度の光学装置寿命に相当)、また、Out-ofBand(13.5nm光以外の光)もレジ スト感光、熱発生の影響を考慮して、表の様に規定されている。ここで、露光光学系のMo/Si多層膜ミラーの反射率を考慮して、IF点におけるOoB強度も表に追加した。更に表には無いが、等速スキャン露光時には、EUVパルスの 連続照射が求められる。EUV強度の増加とともに、必要な照射時間は減少するが、100W@IFでは約400msのパルス発光持続時間(Burst時間)が必要である(レジスト感度10mJ/cm2)。光源としては、必要Burst時間はレジ スト感度にも依存するので、Duty cycle(DC:Burstオンとオフの時間比)が100%であることが望ましい。
図3.1(a)にLPP光源、(b)にLDP光源の概念図と基本構成、および長所と課題を示した。LPP光源は高繰り返し(50~100kHz)CO2ドライバレーザをSnドロプレット(直径30µmΦ程度)に照射し、そこで得られたプラズマからのEUV光を大口径Mo/Si多層膜コレクタでIF点に集光する。LPP光源の高出力化はCO2レーザの高出力化とプリパルス・プロセスによって進められている。ここでプリパルス・プロセスとは、ファイバレーザなどのレーザ照射によりSnドロプレットを細かなSn粒子に破砕してから、メインのCO2レーザを照射する手法である。6) 微細Sn粒子にすることで、CO2レーザの吸収効率が向上し、またプラズマが比較的低密度になりEUV光の 再吸収が低 減 するため、EUV発生効率(CE;Conversion Efficiency)の向上やデブリ発生の低減を図ることができる。
LPP光源の長所は、プラズマ発生領域に電極などが無いため空間制限が少なく、集光効率が高いこと、プラズマサイズが小さくエタンジュ制限が小さいことである。一方、主な課題を以下に示す。
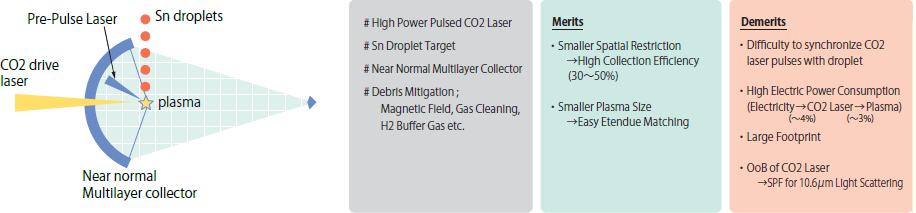
図3.1(a) LPP(Laser Produced Plasma)光源の概念図と特徴
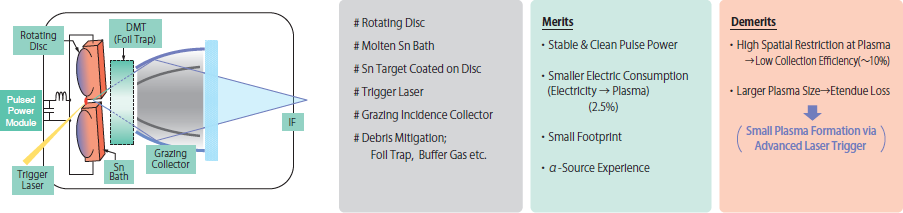
図3.1(b) LDP(Laser Assisted Discharge Plasma)光源の概念図と特徴
(1)CO2ーザ照射と小径Snドロプレットの同期精度確保;
50~100kHzで長時間に亘り、同期精度を維持することはEUVパルス安定出力に必須であるが、その難度は高い。出力ばらつきが大きいと、ドーズ制御が難しくなり、出力ロスが生じる。
(2)小径Snドロプレットのオンデマンド安定吐出;
直径20~30µmΦのSnドロプレット吐出のため、微細開口ノズルの閉塞防止や吐出圧力の安定稼働が肝要である。
(3)CO2レーザの高出力化と連続発振の両立;
100W@IF出力には>20kWのCO2レーザ出力が必要であり、更にスキャン露光には連続発振(DC 100%化)が求められる。従ってCO2レーザのレンズ・ミラー熱対策、光品位向上(M2<2)が求められる。
(4)大口径直入射コレクタのデブリ対策;
MoSi多層膜の反射率劣化防止のため高速Snイオンによるスパッタ、Sn原子やカーボンなどの堆積を防止する必要がある。しかしスパッタ、堆積ともに起こらないプラズマ状態の実現することは難しい。また実現したとしても、EUV出力にとって最適であるとは限らない。スパッタか堆積の何れかが優勢となるプラズマ条件を選択せざるを得ず、スパッタ優位の時はコーティングによるMoSi多層膜保護、堆積優位のときは堆積膜除去クリーニングが必要になる。スパッタ防止用コーティングは厚膜にすると反射率低下を招く。
(5)大電力消費;
CO2レーザを用いるため、電力消費量が高く、また設置面積も非常に大きい。100W@IFに必要なCO2レーザ出力を20kW、またCO2レーザの電力効率を4%とすると、500kWの電力消費となる。
(6)CO2レーザ散乱光の低減;
CO2レーザの10.6µm光は、13.5nmインバンド光に比較し格段に強く、またMoSi多層膜の反射率もほぼ100%と高いため、ウエハの発熱が懸念される。そのため、LPP光源ではCO2レーザの散乱による10.6µm波長のOoB光を低減するためSPF(Spectral Purity Filter)をIF点前後に設置される。Cymer社は、SPF設置により35%、ドーズコントロールにより20%、トータルでは48%のEUV光が減衰すると報告している。7)SPF設置無しでの出力をRaw出力、またSPFを設置して露光可能な状況でのEUV出力をExposure出力と区別している。尚、LDP光源ではIF用SPFは不要で、またドーズコントロールによる出力低下はみられない。
一方、LDP光源は回転ディスクをSn熱浴に浸してSn薄膜をディスク上に形成し、それにトリガーレーザを照射してプラズマ放電(ピンチ放電)を発生させ(10~30kHz)、そこで生じたEUV光を多数枚シェルからなる斜入射コレクタで集光する方法である。回転ディスク上のSn膜のみが、電極としてプラズマ生成に関与するため、従来の固定電極DPP方式で起こった電極磨耗の問題は解消される。またレーザをプラズマトリガとするため特別なパルス発生電源回路も必要ない。LDP光源の高出力化は、後述のように主に繰り返し周波数の増大とトリガーレーザの最適化によって行われている。
LDP光源の長所は、回転ディスク上にSnが均一に塗布されるため、EUV出力が安定であること、放電で直接プラズマを発生させるため電力消費が少ないことである(100W@IF出力に対して、EUV変換効率を2.0~2.5%とすると、消費電力は75~80kW)。また図3.2に放電プラズマ領域でのEUVインバンド光とDUV光の発生箇所を示した。両者の発生位置が異なるため、IF点でのエタンジュ・マッチングによりDUV光は遮光されるためSPFは不要となる。8) 更に図3.3に示すように斜入射コレクタの複数の位置にWitnessミラー(表面Ru膜、斜入射のためコレクタ表面は単層Ru膜となっている)を配置し、汚染量を調べた。その結果、表面Ru膜は0.2nm/Gshotsの速度でスパッタされることが判った(15W@IF出力相当、Sn堆積量は常に<0.1nm(一定)であった)。下図よりRu膜厚に関わらず反射率は一定であることから、Ru膜厚1µmとするとコレクタ寿命は500Gshotsと見積もられる。これは周波数20kHzで、6.9X103時間(290日)の連続発光に相当する。図3.4はIF以降、EUV露光光学系へ流入する汚染を評価した結果である。IF直後にWitnessミラー(MoSi多層膜)を設置し、XPS分析を行った。Sn成分は観測されず、IF点からのSn汚染が無いことが確認された。9)
LDP光源の課題としては、プラズマ付近に回転ディスクがあるため、①空間制限があり集光効率が低いこと、②回転ディスク発熱に対する冷却の強化が必要であることが挙げられる。また、③高出力化に伴い放電プラズマが広がり、エタンデュ制限によるEUV出力ロスが生じやすいとの指摘もされている。しかし、トリガーレーザの最適化(後述のアドバンストレーザトリガ照射など10))により、CE向上と共にプラズマ広がりも軽減できると考えている。
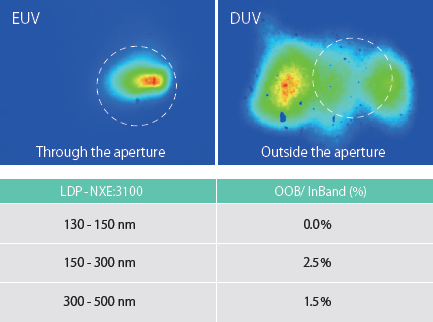
図3.2.LDP光源のOoB評価
(DUV光はアパーチャ外にあるため、IF点で遮光される)

図3.3.LDP光源の斜入射コレクタ寿命評価
(コレクタ寿命はRu膜のスパッタで決まり、Ru膜厚1µmにすると寿命>1年)
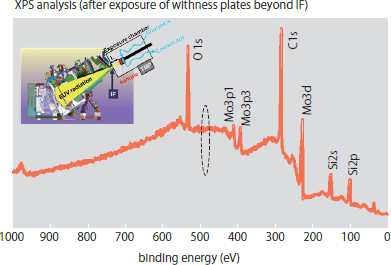
図3.4. IF点から流入する不純物のXPS評価
(Sn汚染はXPSで観測されない)
4. LDP光源の開発状況
LDP光源は、ASML社製ADT(α-Demo-Tool)露光装置に搭載されており、低出力(170W/2π/sr~数W@IF相当)ではあるが、実際のプロセス開発、デバイス試作に使用されている。また、図4.1に示すβ光源が欧州研究機関のIMECに導入されている(出力6~7W@IF、DC100%で稼働)。11)
図4.2にLDP光源ヘットの模式図を示す。ここで回転ディスクの塗付されるSn膜は、プラズマ燃料となるだけでなく、放電電極、回転ディスクの保護膜、導電体、そして冷却媒体と複数の役割を担っ ている(図4.3)。
図4.4にCE向上の有力な手法として開発したアドバンストレーザトリガ(2回レーザ照射)手法の実験結果を示した。10) 第2のレーザ照射を、第1のトリガーレーザ照射後に行うことにより、電流カーブの見られる深いディップが緩和される(図4.4(a))。このディップはピンチ放電に伴うプラズマ圧縮によりインピーダンスの急激な変動が生じたためで、これが高速Snイオンの増大をもたらしていると考えられる。図4.4(b)には高速Snイオン(10~250eV)発生量とEUV変換効率CEのレーザ照射間隔依存性を 示した。最適間隔のとき第2のレーザ照射により、高速イオンの発生は大幅に抑えられていることがわかる(X1/5)。更に、ダブルレーザにすることによりEUV発光強度も増加した(X1.6)。第2のレーザ照射はピンチ放電(高密度プラズマ)開始直後に、Sn原子を供給することによって、Snの多イオン化(EUV発光)促進と最適プラズマ密度分布をもたらすと考えられる。
図4.5にLDP光源の20W@IF出力時のIF後方EUV強度分布とドーズ安定性を示した。9時間の積算稼働を行い(DC 100%)、出力変動は<+/-0.2%に制御されている。ここでは安定出力に向けてフォイルトラップFTの改善を行っている。図4.6に改善前後のFTを示した。ブレード板の曲がりや間隔変動が、大幅に改善されている。図4.7にEUV強度の入力パワー依存性を示す。FTの改善によって、EUV出力は入力パワー増加に伴いリニアに増大するのがわかる(入力パワー増大によるFTの 熱歪み変形が無い)。図4.8に高出力化検討の結果を示した。現在のところ30W@IF(DC 100%)、37W@IF(DC50%)を実測している。8)
更なる高出力化を目指して光源ヘッド部分の高入力試験を実施した(図4-9)。48kW入力(DC 100%、IF点出力48Wに相当)、そして90kW入力(DC 20%、Burst時間200ms、IF点出力85Wに相当)の可能性を確認している。
本格量産時には、光源出力200~250W@IFが求められている。12) 250W@IF出力には300kW程度の入力電力(パルス強度7~10J、周波数30~40kHz)が必要である。高出力化は、パルス強度はあまり強くせず、主に繰 り返し周波数を増大(~40kHz)させることによって進める方針である。この高出力化に向けて、①回転ディスクへの均一Sn薄膜塗布、②Sn熱浴の恒温制御(冷却強化)、③アドバンストトリガーレーザ最適化、④コレクタ捕集効率向上および⑤デブリ対策(フォイルトラップのデブリ除去能とプラズマ耐熱性の両立)を検討中である。図4-10にEUVパルス強度の入力依存性(低周波数)、図4-11は40kHz動作試験(発光点出力、20mJ/2π)の結果を示した。13,14) EUVパルス発光強度は入力に対してリニアに増加し、プラズマ広がりもほぼ一定であった(入力~6.3J)。また、出力は低いものの40kHz動作でもプラズマ残留物の蓄積が無く、安定な出力を維持できることがわかった。今後、入力電力増大に対応した電源、冷却機構の改善を行い、高パルスパワーでの高周波動作の実証を行う予定である。その際、アドバンストトリガー条件を高出力プラズマ状態を最適化することにより、CE向上を図ることが重要と考えられる。
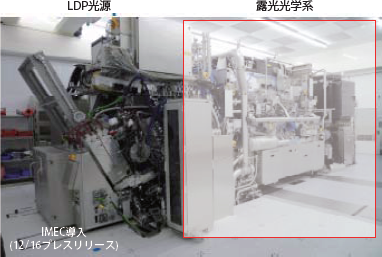
図4.1. ASML;NXE3100に接続されたLDP光源
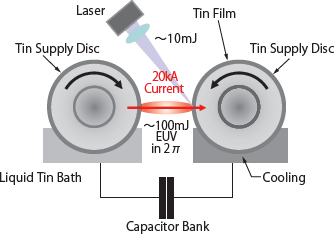
図4.2. LDP光源ヘッド部の模式図
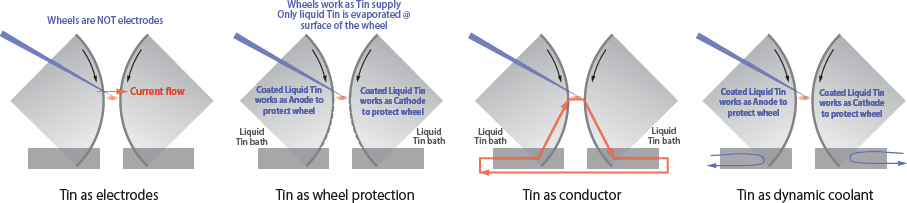
図4.3. LDP光源における液体Snの役割

図4.4. アドバンストレーザトリガーによるSn高速イオンの低減とCEの向上

図4.5. 20W@IF出力時のIF後方EUV強度分布とドーズ安定性(実際の露光を模擬)

図4.6. 製造プロセス改善前後のFT

図4.7. IF点EUVパワーの入力電力依存性 IF製造プロセス改善前後の比較

図4.8.LDP光源の高出力化の変遷と今後の計画(30W@IF、DC100%の達成)

図4.9.48kW入力、Duty-Cycle100%のプラズマ発光の検証(48W@IF相当)
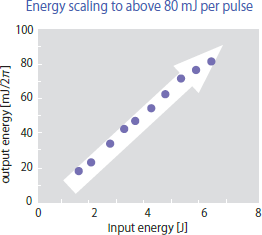
図4.10. EUVパルス強度の入力電力パルス依存性

図4.11. 40kHz動作試験
5. 光源ベンチマーク
2011年10月のEUVLシンポジウム(マイアミ)において報告されたEUV光源特性を表5.1にまとめた。CymerLPP光源は社内で達成した平均出力8W@IF(DC 60%)をチップメーカに展開中と報告している。15)但し、短時間(1ms前後)の周期で、Burst-オン/オフを繰り返す露光である。低EUV強度で遅いスキャン速度の場合は、多数のBurst照射で平均化できるので寸法精度が確保されるが、EUV強度が向上してスキャン速度が速くなると寸法制御が厳しくなると考えられる。DC100%稼動の 実現が必要であろう。また詳細条件は不明であるが、EUV発光強度、35W@IF(DC 80%), >100W@IF(DC3%)を示し、今後、DCの向上、CO2レーザ高パワー化(10kWから20kW)、そしてプリパルス手法の採用で100W@IF(DC 100%)の達成を図るとしている。またギガフォトン/コマツはプロトLPP光源においてファーストライトが得られたと発表している。16) 一方、XTREME/ウシオ電機のLDP光源はIMECにおいて7W@IF稼働中であり、早期にこれまで得られた30W @IF(DC 100%)を展開する予定である。また50~100W@IF出力相当のプラズマ発光点出力が得られている。
2011年EUVシンポジウム委員会において、今後、注力すべき技術項目ランキングが更新された(表5.2)。17)
EUV光源の高出力化が最大の注力すべき事項となっている。従来計画に対して、ほぼ1年の遅延と指摘されており、早期に100W@IF出力を達成して、EUV露光実用化に対する懸念を払拭する必要がある。
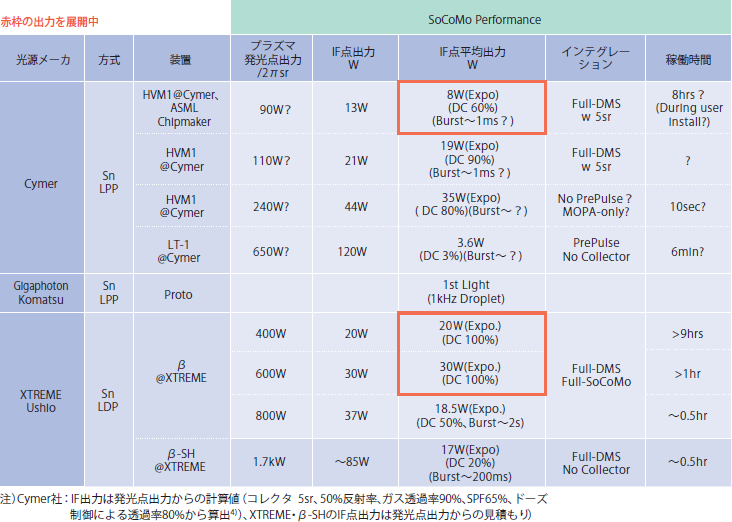
表5.1. EUV光源ベンチマーキング(2011 EUV Symposium, Miami)
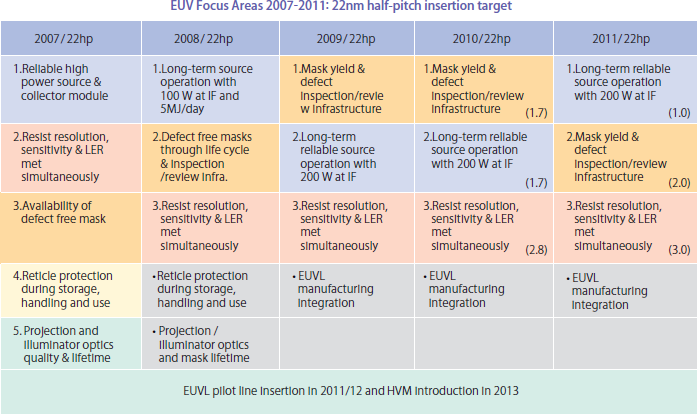
表5.2. EUV露光のFocus Area(Critical Issues) (2011年は全員一致でEUV光源が最大の課題と結論)
6. まとめ
EUV露光の実現の鍵を握るEUV光源の開発状況について概観した。XTREME/ウシオ電機が開発しているLDP光源は出力安定性、連続発光、FTと斜入射コレクタによるデブリ低減手法採用、低消費電力などの優れた特徴がある。これまで、30W@IF(Duty cycle 100%)を達成し、100W@IFレベルまでのプラズマ発光点出力を確認している。現在、連続IF出力100W化の早期達成と、HVM露光装置に向けた250W@IF出力の基本検討を進めているところである。
本研究の一部はNEDO継続研究により実施されており、経産省、NEDOからのご支援に深謝いたします。



